材料热膨胀系数差异导致的光耦失效案例分析
李浦铭 石谨宁 温育明 王春修
【关键词】热膨胀系数;导电银胶;光耦;失效分析
光耦是常见的使用导电银胶材料的电子元器件。导电银胶的基体树脂是一种胶黏剂,可以在适宜的固化温度下进行粘接,远低于普通铅锡焊接200℃以上的焊接温度,这就避免了焊接高温可能导致的材料变形、热损伤和内应力的形成。由于电子元件的小型化、微型化及印刷电路板的高密度化和高度集成化的迅速发展,铅锡焊接0.65mm的最小节距远远满足不了导电连接的实际需求,而导电银胶可以制成浆料,实现很高的线分辨率。且导电银胶工艺简单,易于操作,可提高生产效率,避免铅锡焊料中重金属铅引起的环境污染。所以导电银胶是替代铅锡焊接,实现导电连接的理想选择。在光耦的失效案例中,发现导电银胶在与载板结合时,各材料之间的热膨胀系数匹配对光耦的电性能有较大影响。
(一)案例背景
失效样品为台式电脑的开关电源产品,在客户端生产组装后进行整机老化测试一段时间后。整机系统出现掉电重启现象。经过初步分析定位,失效器件为控制线路上光耦IC3,局部原理图见图1所示。在高温环境下,光耦IC3A Pin和K Pin发生开路,线性稳压线路Q500截止,VCC电压跌落至10V以下(正常电压为12V),导致初级侧MCU无法工作,最终使得电源异常进入保护状态。
(二)电气参数测量
将异常和良好的样品编号为NG#1、NG#2、OK#1,在不同温度条件下分别测量其参数。常温下所有样品均表现为性能良好,在高温条件下,样品NG#1和样品NG#2在电性能方面均表现出开路失效:在125℃条件下,不良样品NG#1光耦输入端I-V曲线表现出开路状态;在135℃条件下,不良样品NG#2光耦输入端I-V曲线表现出开路状态。良好的样品OK#1电气参数未表现出异常。表明不良现象在高温条件下表现为开路失效。
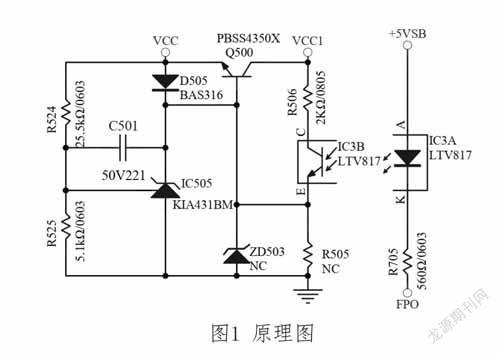
(一)外观检查
光耦的封装材料为环氧树脂,封装表面所标注的产品和引脚起始位信息清晰可见,观察塑封外壳未发现污染、腐蚀或机械损伤痕迹。铜镀镍引脚分别从封装外壳引出,观察引脚未发现污染、腐蚀或机械损伤痕迹。表明光耦未存在明显的外观污染或机械损伤。
(二)X-ray检查
×射线能够穿透非金属材料,广泛应用于观察元器件的内部结构。X-ray观察样品能够看到光耦在结构上主要由三部分组成,第一部分为载板,载板作为承接LED芯片以及光敏三极管芯片作用,延伸至塑封外壳外部起电气连接作用。第二部分为输入端LED芯片,LED芯片一端通过键合丝与载板焊接相连,另外一端通过导电银胶与载板相连。第三部分为输出端光敏三极管芯片,光敏三极管芯片同样通过键合丝与载板焊接相连,另外一端通过导电银胶与载板相连。
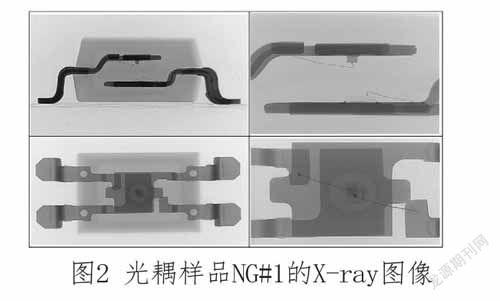
通過X-ray对失效样品NG#1与良品OK#1对比,未发现失效样品内部存在明显缺陷。
(三)切片分析
对NG#1、OK#1进行切片研磨,发现NG#1的LED芯片底部粘接银胶与载板存在缝隙,而样品OK#1则未发现存在缝隙。
通过扫描电镜观察,发现样品OK#1载板上镀层薄且均匀。而样品NG#1载板上镀层较厚且表面高低起伏不平。
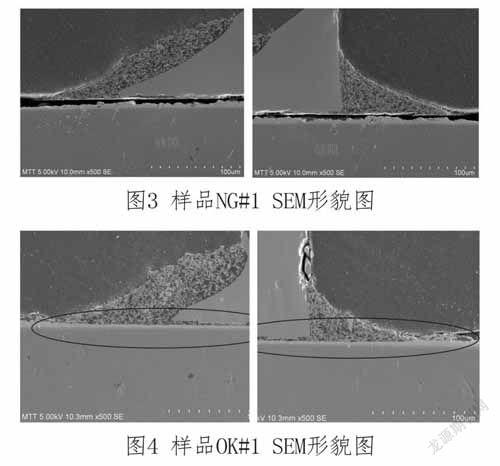
(四)开封分析
对样品NG#1机械开封取出LED芯片部分,然后采用化学开封方法去除LED芯片包封的透明树脂。化学开封后,样品NG#1 LED芯片的晶圆与载板自行分开,晶圆底部导电银胶有部分缺失,载板上有少量物质残留。
说明样品NG#1导电银胶的结合力较差,因此导致LED芯片晶圆与载板比较容易脱落。
(五)EDS成分分析
对样品NG#1的晶圆底部与载板并进行EDS成分分析。在LED晶圆底部焊盘位置附近,主要为Ni、Au元素,晶圆底部其他区域EDS成分分析未发现异常元素。

(六)分析小结
通过对样品NG#1与样品OK#1分析对比,样品NG#1芯片底部与载板间存在缝隙,开封分析和EDS成分分析发现样品NG#1 LED芯片晶圆与载板脱落,晶圆底部导电银胶有部分缺失,载板上有少量物质残留,说明样品NG#1导电银胶的结合力较差,高温下内部形成分层而导致内部发光二极管发光异常。
为分析导电银胶结合力较差的原因,分别将原材料银胶制样固化(150℃/2h)和原材料透明树脂制样固化(150℃/1h)后进行差示扫描量热法测试玻璃化转变温度Tg点和热机械分析测试热膨胀系数。
从原材料导电银胶DSC曲线可以看出,导电银胶第一次温升Tg点和第二次温升Tg点分别是41.8℃和45.300。从原材料导电银胶和透明树脂的TMA曲线图可以看出,原材料导电银胶在20℃-150℃的热膨胀系数为357.6618×10-6/℃,而原材料透明树脂旨在20℃-150℃的热膨胀系数为31 8.2266×10-6/℃,两者热膨胀系数存在约为10%的差异。

根据热膨胀差异分析,在高温环境下,光耦内部的导电银胶与树脂材料间热膨胀系数存在较大差异,材料之间产生的膨胀形成内应力,导致LED芯片晶圆与载板间出现了分层。
针对材料热膨胀系数差异所导致光耦失效的分析方法,一般从无损检查到破坏性分析的顺序进行逐一分析排查。首先,进行外观检查,为了确保异常样品NG#1未受到污染、腐蚀或机械损伤等物理破坏。其次,进行X-ray检查,进一步观察异常样品NG#1内部载板、LED芯片、光敏三极管芯片等结构件所在位置以及键合丝连接状况是否存在工艺缺陷。然后,在进行切片后,通过扫描电镜观察内部形貌,确认异常样品NG#1与良好样品OK#1在工艺结构上的差异。最后,通过对光耦进行开封和EDS成分分析,样品NG#1 LED芯片晶圆与载板脱落,晶圆底部导电银胶有部分缺失,载板上有少量物质残留,进一步说明了样品NG#1导电银胶的结合力较差。失效分析流程图如图9所示。

分析发现光耦中发光二极管芯片与载板之间出现的缝隙,与导电银胶和载板间的结合力相关。这种失效与光耦内部的导电银胶与透明树脂因热膨胀系数差异有关,具有恢复性。失效与温度变化强相关,表现为高温环境下容易发生,在温度降低时消失,甚至极端情况下失效无法恢复。

