一种新型无电压折回现象的超结逆导型IGBT
吴 毅,夏 云,刘 超,陈万军
(电子科技大学电子薄膜与集成器件国家重点实验室,成都 610054)
1 引言
绝缘栅双极型晶体管(IGBT)是20 世纪80 年代发展起来的一种电压控制双极型复合器件,广泛应用于中大功率电力变换领域[1-2]。在大部分应用IGBT 的电路中,需要给IGBT 反向并联一个续流二极管来实现反向导通。未并联续流二极管的IGBT 在反向工作模式下等效于开基区PNP 晶体管,没有反向导通能力[3]。
为使IGBT 具有反向导通能力,逆导型IGBT(RC-IGBT)被提出,其通过在IGBT 背面的P+集电极区引入部分N+区,在IGBT 体内集成续流二极管。RC-IGBT 不仅实现了逆导能力,而且可以减少引线带来的寄生电感并减小系统体积,因此被广泛应用[4-5]。但是传统的逆导型IGBT 在正向导通时往往存在电压折回现象。这是由于RC-IGBT 引入的集电极N+区会使器件在集电极电压低时工作在单极型导通模式,随着集电极电压的增大,器件才进入双极型导通模式。从单极型导通向双极型导通模式转换时,由于电阻的下降,电压发生折回现象[6],这不仅影响器件导通功耗,也不利于器件串并联应用。因此抑制折回现象在RC-IGBT 的设计中尤为重要[7-8],增加漂移区浓度,增大集电极P+区域与集电极N+区域长度比例可以改善折回现象[9]。
传统超结RC-IGBT(Conv-SJ-RC-IGBT)在传统RC-IGBT 的漂移区内引入了交替的P/N 柱超结结构[9],与传统RC-IGBT 结构相比,超结RC-IGBT 的漂移区浓度极大地提高了,因此器件的折回现象得到了明显改善[8]。但是集电极P+区域与集电极N+区域的长度比例对器件折回现象的影响依旧存在。虽然增大集电极P+区域与集电极N+区域长度比例可以改善折回现象,但是反向电流分布会愈加不均匀。
为了消除折回现象,改善导通电流分布,本文提出了一种新型超结RC-IGBT(Prop-SJ-RC-IGBT)结构,其利用超结的P 柱将集电极P+区域与集电极N+区域隔开,在器件正向导通时,P 柱可以阻挡电子,从而使电子不被集电极N+抽取,器件导通时直接进入IGBT 双极型导通模式,因此折回现象被完全消除,并且导通压降与关断损耗的折中关系也得到改善。
2 结构与原理
图1(a)(b)为Conv-SJ-RC-IGBT 和本文提出的Prop-SJ-RC-IGBT 半元胞区结构。与Conv-SJ-RCIGBT 相比,Prop-SJ-RC-IGBT 利用超结的P 柱将N+区域与N-FS 层及集电极P+区域隔开。此外,为保证器件耐压,Prop-SJ-RC-IGBT 通过氧化层隔离集电极金属与P 柱,氧化层厚度小于集电极金属厚度。

图1 器件结构及正向进入双极型导通的电子路径
对于Conv-SJ-RC-IGBT,在正向导通时,栅极电压使器件沟道开启后,电子由N+发射极经过电子沟道再到N-CS 层、N 漂移区、N-FS 层,最后到N+集电极,该过程仅电子一种载流子参与导电,为单极型导电模式。图1(c)中电流流经N-FS 层,会在N-FS 层的寄生电阻上产生横向压降,当横向压降大于集电极P+/集电极N+结内建电势(300 K 时约为0.7 V)时,P+集电极与N-FS 层形成的PN 结开启,空穴由P+集电极注入N-FS 层,经漂移区再到N-CS 层,最后通过P-body流入发射极,器件进入双极型导电模式。由于大量空穴的注入产生的电导调制,会使得器件的导通电阻减小[10],如果不进行合理优化,导通电阻下降过快,RC-IGBT 的I-V 曲线可能出现折回现象。增大集电极P+与N+长度比例可以改善折回现象,但是反向电流分布会愈加不均匀。而本文提出的Prop-SJ-RC-IGBT在正向导通时,由于P 柱将集电极N+区与N-FS 层隔开,电子会在N-FS 层积累,不会经集电极N+区流走。因此当器件导通时,电子由N+发射极经过电子沟道再到N-CS 层、漂移区,在FS 层积累;随着集电极与发射极之间的偏压VCE的增加,N-FS 层积累的电子使集电极P+区与N-FS 层形成的PN 结开启,器件直接进入双极型导电模式。因此,Prop-SJ-RC-IGBT 完全消除了常规RC-IGBT 正向导通时存在的折回现象。此外,新结构可以通过优化集电极P+区域与集电极N+区域长度比例来进一步改善器件的性能。
3 结果与讨论
通过仿真参数对2 种器件的电学特性进行比较,器件关键参数如表1 所示。
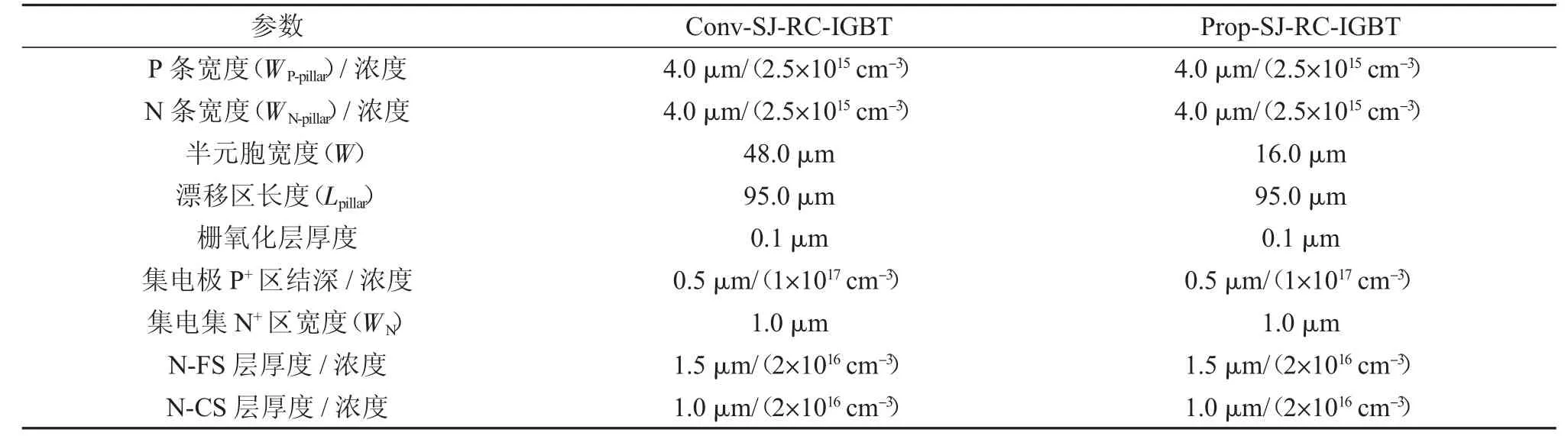
表1 器件关键仿真参数
半元胞宽度为W,集电极N+区宽度WN为1 μm,为方便后续讨论,定义参数η=WN∶W。
根据表1 的仿真参数,传统结构耐压为1530 V,新结构的耐压为1500 V。
3.1 正向导通特性
图2 为2 种结构的器件正向导通情况。从图2(a)可见,对于Conv-SJ-RC-IGBT,η 对其性能影响十分明显,当η 较大,正向导通时,I-V 曲线存在明显的折回现象。随着η 的减小,折回现象逐渐缓解,当η=1∶48时,Conv-SJ-RC-IGBT 的折回现象基本消失。而对于Prop-SJ-RC-IGBT,I-V 曲线不存在折回现象。在电流密度ICE=100 A/cm2时,Conv-SJ-RC-IGBT 的正向导通压 降 VF为 1.87 V,Prop-SJ-RC-IGBT 与 Conv-SJRC-IGBT(η=1∶48)相比VF降低了20.9%,仅为1.48 V。
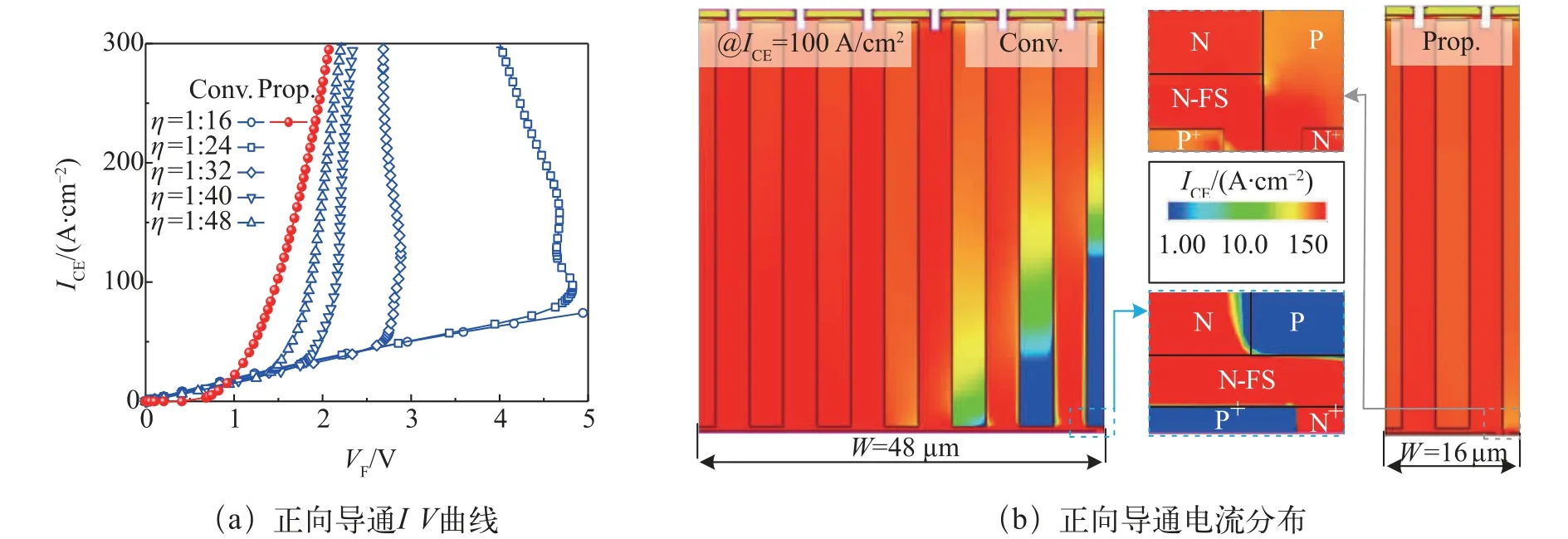
图2 Conv-SJ-RC-IGBT 与Prop-SJ-RC-IGBT 正向导通情况
图2(b)为2 种器件正向导通时的电流分布,Prop-SJ-RC-IGBT 导通时电流分布更为均匀。可以看到,Conv-SJ-RC-IGBT 在靠近集电极N+区附近的电流密度很小,这是由于集电极P+区上方的横向电流一定时,需要流经足够长的区域,产生的横向压降才能使集电极P+与N-FS 层形成的PN 结开启。而Prop-SJ-RC-IGBT 的开启机理与常规IGBT 相同,集电极P+与N-FS 层形成的PN 结各个区域都是同时开启的,电流分布更均匀。
3.2 反向导通特性
图3 为Conv-SJ-RC-IGBT 与Prop-SJ-RC-IGBT的反向导通情况。对于Conv-SJ-RC-IGBT,为了消除正向I-V曲线的折回现象,需要减小η。而Prop-SJ-RC-IGBT 即使在元胞宽度小的情况下也不会有折回现象。因此在相同的芯片面积下,新结构的集电极N+区面积更大,具有更小的导通电阻。图3(a)中,在电流密度ICE=-100 A/cm2时,Con-SJ-RC-IGBT的反向导通压降VR为1.4 V(绝对值),而Prop-SJ-RCIGBT 的反向导通压降为1.11 V(绝对值)。本文提出的结构与传统结构相比,反向导通压降下降了20.7%,具有更强的反向导通能力。图3(b)是导通电流密度为-100 A/cm2时的电流分布,对于Conv-SJ-RC-IGBT,由于集电极N+区域占元胞宽度比例小,导致集电极侧的电流分布不均匀,容易出现局部热积累。相比之下,Prop-SJ-RC-IGBT 的电流分布更均匀。
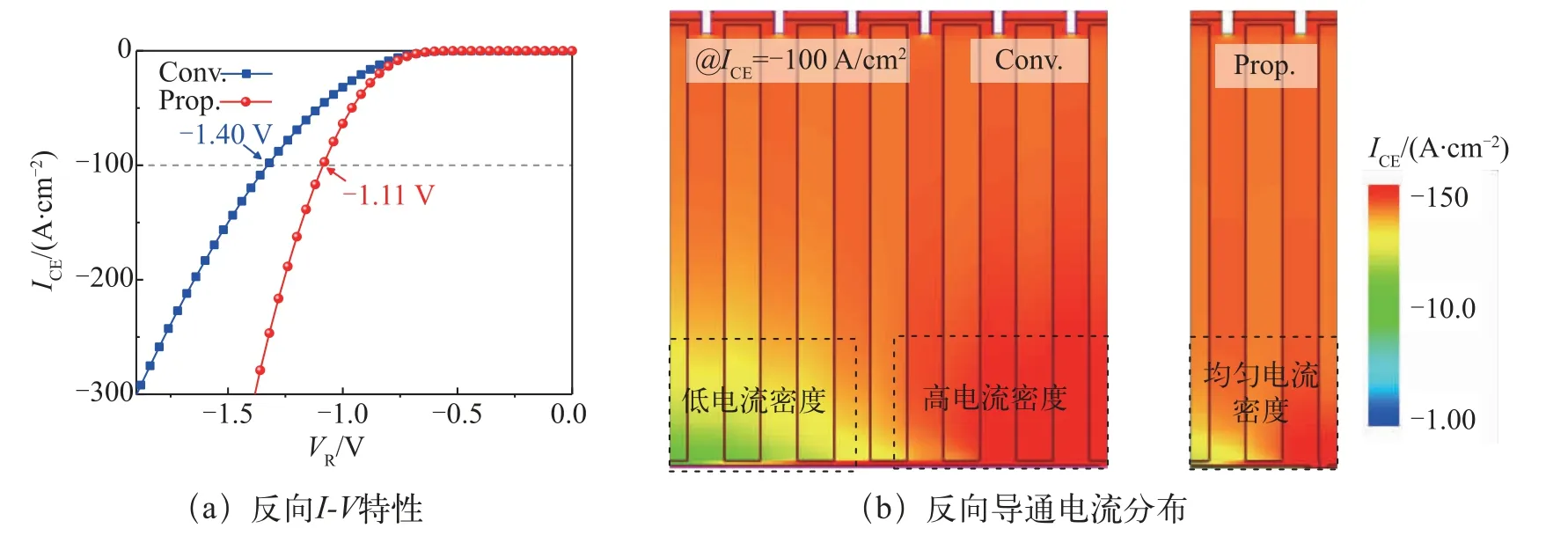
图3 Conv-SJ-RC-IGBT 与Prop-SJ-RC-IGBT 反向导通情况
3.3 关断特性
在相同正向导通压降(VF=1.55 V)下关断器件,得到如图4(a)所示的电流电压变化波形及如图4(b)所示的关断过程中内部空穴载流子的分布变化情况。图4(a)中Prop-SJ-RC-IGBT 的关断速度更快,对关断开始至结束时间段内电流和电压的乘积进行积分可得到器件的关断损耗,Conv-SJ-RC-IGBT 的关断损耗为0.487 mJ/cm2,Prop-SJ-RC-IGBT关断损耗仅为0.390 mJ/cm2,相比于传统结构降低了19.9%。图4(b)中t0时刻,Prop-SJ-RC-IGBT 的空穴较Conv-SJ-RCIGBT 的分布更均匀,且在发射极一侧的浓度更高,这有利于在关断过程中空穴被发射极抽取。从t0时刻到t4时刻空穴分布的变化可以看出,Prop-SJ-RC-IGBT 的空穴抽取速度更快,因此其关断速度更快,关断损耗更小。

图4 Conv-SJ-RC-IGBT 与Prop-SJ-RC-IGBT 关断过程
3.4 正向导通压降与关断损耗及反向导通压降的折中关系
图5 所示为新结构与传统结构的正向导通压降VF与关断损耗Eoff及反向导通压降VR的折中关系。Prop-SJ-RC-IGBT 的折中关系明显优于Conv-SJRC-IGBT 的折中关系。在正向导通压降为1.87 V 时,Prop-SJ-RC-IGBT 的关断损耗为0.28 mJ/cm2,相比Conv-SJ-RC-IGBT 的0.36 mJ/cm2降低了22.2%。关断损耗均为0.36 mJ/cm2时,Prop-SJ-RC-IGBT 的正向导通压降为1.57 V,相比Conv-SJ-RC-IGBT 的1.87 V 减小了16.0%。增大η 可以有效改善VF-Eoff折中关系,但是过大的η 会使反向导通时电流分布不均匀,影响器件的可靠性。

图5 Conv-SJ-RC-IGBT 与Prop-SJ-RC-IGBT 折中关系比较
η 的变化会影响器件的VF和Eoff以及VF和VR之间存在的折中关系,Prop-SJ-RC-IGBT 的折中关系明显优于Conv-SJ-RC-IGBT。这是由于新结构利用P 柱隔离了集电极P+和N+,因此η 的变化对器件正向导通特性的影响减弱。从图5 可以看出,由于新结构正向导通时工作在双极型导通模式,因此η 的增加对VF影响较小。而传统结构正向导通时需要从单极型导通模式向双极型导通模式切换,η 的变化极大地影响了模式切换时的电压,从而影响器件正向导通压降。
4 结论
本文提出通过超结漂移区的P 柱结构隔离集电极的超结逆导IGBT,与传统的超结逆导IGBT 相比,新结构消除了正向导通时的折回现象,正向导通压降减小了20.9%,反向导通压降减小了20.7%,相同正向导通压降下关断损耗降低了19.9%。此外,新结构具有更好的正向导通压降-关断损耗及正向导通压降-反向导通压降的折中关系。

