原子层淀积Si掺杂ZnO薄膜的光电性能研究
张 远,张永兴,张金锋,牟福生
(1.淮北师范大学 物理与电子信息学院,安徽 淮北 235000;2.复旦大学 微电子学院,专用集成电路与系统国家重点实验室,上海 200433)
0 引言
ZnO 是一种重要的直接带隙宽禁带半导体,室温下它的禁带宽度为3.37 eV,激子束缚能高达60 meV,在紫外发光和探测器件方面有着广泛应用[1]. 另外,ZnO 在可见光波段的透射率超过80%,纯ZnO薄膜的电阻率在~10-1Ωcm量级,而且价格便宜无污染,在进行镓(Ga)、铝(Al)、铟(In)和硅(Si)等单质掺杂后,电阻率还能继续降低2~3个数量级,是一种很合适的替代铟掺杂氧化锡(ITO)的透明导电氧化物(TCO)薄膜材料[2-5]. ZnO 天然易失氧,严重影响其光电性能,通过掺杂铝Al 和Si等元素还能提高ZnO薄膜的稳定性,可以改善其光学和电学性能[3,6]. 目前常用的III族掺杂元素是Ga、Al等,IV族元素主要是In和Si等,其中Si与Zn的原子半径大小相似,Si作为掺杂物对ZnO的晶格结构破坏较小,在半导体工艺中,掺杂Si还有一个很大的优势就是不会对器件造成可能的金属污染[7-10]. 目前研究人员分别用射频磁控溅射、脉冲激光沉积、溶胶凝胶法等生长不同浓度Si 掺杂的ZnO(SZO)薄膜,并研究其结构与光电性能[11-13]. 结果表明,SZO的最小电阻率在10-4Ωcm数量级,可见光的透射率也在80%以上,有巨大的应用价值. 作为一种低温CVD生长工艺,原子层淀积(ALD)是一种自限制反应的镀膜技术,对膜厚的控制精度可以达到原子量级,也可以对掺杂元素浓度进行精确控制[14-15]. 同时薄膜生长的均匀性好、表面平整度和致密度高,ALD技术的反应温度比较低,对真空度要求不高,可以与半导体工艺兼容. 目前,使用ALD技术生长SZO 薄膜的相关报道还比较少[16]. 本文使用ALD 生长ZnO 和SiO2叠层的方法得到不同掺杂比例的SZO薄膜,并对其结构与光电性能进行研究.
1 制备工艺与测量方法
在Si(100)和石英基片上生长样品,使用标注清洗工艺对Si 片进行清洗,在使用前使用体积分数为5% HF溶液对Si片浸泡1 min,用去离子水漂洗干净后,使用高纯氮气吹干. 对于石英片,首先使用丙酮溶剂清洗 3 min,然后使用去离子水漂洗干净,吹干待用.
使用BENEQ公司的TFS-200型ALD设备在Si片和石英片上进行SZO薄膜的生长,生长温度200 ℃.使用二乙基锌(DEZ)和去离子水(H2O)作为ZnO薄膜生长的Zn和O源,使用三(二甲氨基)硅烷(TDMAS)和氧气等离子体作为SiO2薄膜生长的Si和O源. 在生长ZnO薄膜时,DEZ和H2O的源温都设为20oC. 一个标准的ALD生长ZnO薄膜的循环是:将DEZ通入反应腔,脉冲时间0.2 s;氩气吹扫2 s去除反应残余物和气态副产物;通入去离子水,脉冲时间0.2 s;氩气吹扫2 s. 生长SiO2薄膜时,TDMAS的源温设为20 ℃,使用等离子体发生装置产生氧等离子体,其中氧等离子射频激发功率设为150 W. 一个标准的SiO2生长循环是:TDMAS 脉冲时间3 s,氩气吹扫2 s,氧等离子体脉冲时间2 s,氩气吹扫2 s.ZnO和SiO2薄膜通过叠层的方式进行生长,生长n循环的ZnO再生长1循环的SiO2,其中n取5、9、19、29和39,总生长层数都是240循环. 例如,在n=5时,总共生长40个叠层,即40×(5+1)=240循环;当n=39时,总共生长6个叠层,即6×(39+1)=240循环. 也就是说生长的SZO薄膜的Si掺杂比分别为2.5%、3.3%、5.0%、10.0%和16.8%. 作为对比,还生长240循环的纯ZnO薄膜.
使用带有SOPRA GES-5E系统的椭圆偏振光谱仪测量SZO薄膜的厚度;使用德国Bruker公司的D8 Advance 型号的X 射线衍射仪(XRD)测量SZO 薄膜的结构特性;采用Veeco-Dimension 3100 原子力显微镜(AFM)研究SZO 薄膜的表面形貌;利用van der Pauw 霍尔效应测量系统测量SZO 薄膜的载流子浓度、霍尔迁移率和电阻率等电学性质;使用紫外-可见分光光度计测量SZO薄膜的透射率;使用波长325 nm的He-Cd激光器作(光子能量~3.8 eV)激发光源测量不同掺杂浓度SZO薄膜的光致发光(PL)特性.
2 结果与讨论
使用椭圆偏振光谱仪测量Si片上生长的SZO和ZnO薄膜厚度,其中ZnO薄膜的厚度是48.3 nm,Si掺杂比为2.5%、3.3%、5.0%、10.0%、16.8%的ZnO薄膜的厚度分别为47.9、47.4、46.8、45.7和44.1 nm,根据文献报道,200 ℃时ALD 生长ZnO 和SiO2的速率分别为0.2和0.1 nm/cycle[4,17-18],这与本文测量的结果一致. 图1所示为Si(100)晶片上不同Si掺杂浓度SZO薄膜的XRD谱,按照Si掺杂浓度不断增加的顺序从下到上排列. 图中角度33°位置的衍射峰对应Si(200)晶向[4],所有样品中,这个衍射峰的位置都没有变,也证明本文测量结果的稳定和可靠性. 对于未掺杂的ZnO薄膜,出现在31.8°和34.3°位置的衍射峰分别对应于ZnO(100)和(002)晶向[19],其中ZnO(002)衍射峰强度较大,但也不是完全占主导地位,这说明SZO薄膜为多晶结构. 除这2个衍射峰,并没有其它Si,Zn,SiO2和ZnSiO3等物质的特征衍射峰出现,也说明Si真正掺杂扩散进了ZnO. 随着Si掺杂浓度的提高,ZnO(002)的衍射峰强度先增大后减小,这说明ZnO的晶粒尺寸先增大后减小[8]. 同时,ZnO(002)衍射峰的位置先往小角度偏移,最后又往大角度偏移,这也与SZO薄膜Si掺杂浓度增加导致的晶格畸变有关[8,20-21]. 另外杂质浓度增大造成的缺陷增多也导致ZnO衍射峰的展宽.

图1 不同Si掺杂浓度SZO薄膜的XRD谱图
图2所示是AFM测得的Si片上生长SZO薄膜的表面粗糙度结果,扫描面积是2×2 um2,其中未掺杂的ZnO薄膜的均方根粗糙度(RMS)值为2.17 nm,随着Si的掺杂,RMS值迅速下降,图2d所示是RMS值随Si掺杂浓度变化图,可以看出,在掺杂浓度为3%时达到最小为0.75 nm,随着掺杂浓度的继续提高,RMS有所增大,但是都小于未掺杂的ZnO薄膜. 这可能是因为SiO2生长过程中O等离子体温度很高,输运到薄膜表面时让不稳定的表面原子获取足够的能量扩散到格点以降低表面能,使表面变得更均匀,从而RMS降低. 当然,等离子体表面退火效应只是一种可能的猜测,具体原因需要继续深入研究.

图2 ZnO薄膜AFM测量结果
为研究SZO薄膜的电学性能,测量石英片上生长样品的霍尔效应. 图3所示为SZO薄膜的载流子浓度、迁移率和电阻率随掺杂浓度的变化曲线图. 由图3 可知,未掺杂的ZnO 薄膜是典型的n 型本征半导体,它的载流子密度、迁移率和电阻率分别为4.93×1019cm-3、19.1 cm2V-1s-1和6.65×10-2Ωcm. 这么高的本征载流子密度是由ZnO薄膜的中的Zn间隙和O空位等施主型缺陷造成的. Si掺杂后的SZO薄膜还是n型半导体,在Si掺杂浓度为2.5%时,样品的载流子浓度提高到7.62×1019cm-3,而随着掺杂量提高,载流子密度不断下降,但还都在1019cm-3数量级,整体变化不大. 导致这种现象的原因是,在低浓度Si掺杂时,主要是Si3+取代Zn2+离子,Si原子相比Zn原子可以多提供一个电子,从而使得载流子密度增加;而随着Si掺杂浓度提高,Si 更倾向于和O 结合形成各种SiOx键,并导致更多的晶界偏析增长,从而使载流子密度减小[20]. 从图3 中可以看出迁移率随掺杂浓度的增加不断减小,在Si 掺杂浓度为16.8%时,下降到1.46 cm2V-1s-1,这是因为Si杂质和晶界增加引起的散射效应会导致迁移率的减小. 而SZO的电阻率的大小与载流子密度和迁移率成反比,整体来说,随着Si掺杂浓度的提高,SZO的电阻率是不断增大的,文献报道中,SZO的电阻率随Si掺杂剂量的增大有一个先减小后增大的过程[11,20],本文没有观察到这个变化过程,可能与实验中Si掺杂浓度变化较大有关.

图3 SZO薄膜的载流子浓度、迁移率和电阻率随Si掺杂浓度的变化曲线
图4是石英片上生长SZO薄膜的紫外-可见光透射光谱图,可以看出,在可见光波段,所有样品的光透射率都在85%以上,Si掺杂浓度3.3%、5.0%和10.0%的样品可见光透射率甚至在90%以上,这是因为相对高频溅射镀膜和激光脉冲沉积等镀膜方法,ALD生长的SZO薄膜均匀性更好,薄膜的表面粗糙度低,这会让薄膜对光的的漫反射减少,更利于光的透射. 因此ALD生长的SZO薄膜在透明导电半导体薄膜应用方面显然更有优势[2].
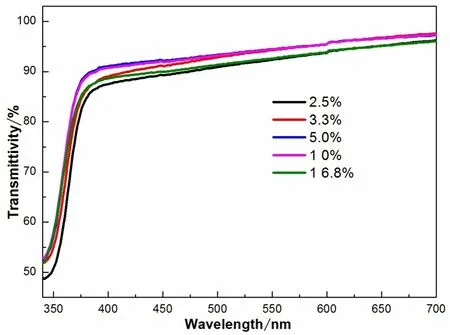
图4 不同Si掺杂浓度SZO薄膜的紫外-看见光透射率变化曲线
图5是Si片上生长SZO薄膜的常温光致发光(PL)光谱,可以看出,所有SZO样品都只有一个位于紫外波段的发光峰,其中未掺杂ZnO薄膜的发光中心位于378 nm,对应着ZnO的本征发光峰[1],未掺杂ZnO薄膜的发光强度最大,随着掺杂浓度的提高,发光强度减小,发光峰不断蓝移. 发光强度减小是因为随着掺杂浓度增加,非辐射复合中心增多,导致ZnO紫外发光强度减小. 而随着掺杂浓度的提高,样品的紫外发光峰不断蓝移,说明ZnO的禁带宽度不断增加,这与SZO材料内部的晶格畸变有关[8]. 值得注意的是,所有样品在可见光区的发光基本不可见,因为ZnO 的可见光发射源于杂质和缺陷能级相关的深能级发射,这说明使用ALD生长的SZO薄膜杂质和缺陷很少,材料性能的可控和稳定性好.

图5 不同Si掺杂浓度SZO薄膜的PL光谱
3 结论
本文使用原子层淀积ZnO和SiO2叠层的方法得到不同Si掺杂浓度的SZO薄膜,XRD测量结果表明,SZO薄膜为多晶结构. AFM测量结果表明,Si掺杂的ZnO薄膜的表面粗糙度变小,这是氧等离子体的表面退火作用导致的. SZO薄膜为n型半导体,随着Si掺杂浓度的提高,SZO薄膜的载流子浓度先增大后减小,迁移率不断减小,电阻率不断增加. SZO薄膜的可见光透射率都在85%之上,这与ALD生长SZO薄膜的良好均匀性和较低的表面粗糙度有关. 常温PL谱表明,SZO薄膜以紫外发光为主,可见光发光几乎不可见,随着Si掺杂浓度提高,紫外发光强度变低,发光峰不断蓝移. 总之,ALD生长的Si掺杂ZnO薄膜均匀性好,性能稳定,通过Si浓度的变化,可以对其光电性能进行精确的调控,在透明导电薄膜、薄膜晶体管和紫外发光与探测器件方面有巨大的应用潜力.

