降低半绝缘GaAs单晶片亮点缺陷的热处理工艺研究
杨 艺,周春锋,兰天平
(中国电子科技集团公司第四十六研究所 天津300220)
基础研究
降低半绝缘GaAs单晶片亮点缺陷的热处理工艺研究
杨 艺,周春锋,兰天平
(中国电子科技集团公司第四十六研究所 天津300220)
GaAs单晶材料已成为一种重要的微电子和光电子基础材料,应用广泛。为了降低半绝缘砷化镓单晶片表面的亮点缺陷,对砷化镓晶片在不同温度和不同砷蒸汽压条件下进行了热处理,研究了热处理对砷化镓中砷的存在形式转换的影响及其机理。
GaAs单晶片 热处理 亮点缺陷 EL2
0 引 言
近年来,移动通讯、网络技术以及电子产业的迅速发展带动了砷化镓(GaAs)产业的发展。目前,GaAs单晶材料已成为一种重要的微电子和光电子基础材料,已广泛用于微波大功率器件、低噪声器件、微波毫米波单片集成电路、超高速数字电路等电子器件的制造。但 GaAs生产工艺复杂,在高温生长过程中存在化学配比偏离的问题,这会产生亮点缺陷,以及电学参数不满足要求等问题。由于亮点缺陷会影响器件参数,因此对亮点缺陷密度的研究显得尤其重要。[1]本文利用 VGF法生长 C掺杂的半绝缘 GaAs单晶片,研究了热处理对GaAs单晶片亮点缺陷和电学参数尤其是 EL2的影响,同时对其机理进行了讨论。
1 实验过程
本文采用的样品为 VGF法生长的 C掺杂10.15,cm半绝缘GaAs单晶片:预先合成7,N纯度的GaAs多晶料,生长<100>方向的 GaAs单晶锭,单晶锭经滚圆、切片、倒角、化抛、清洗后,进行晶片闭管热处理。单晶切片的厚度为740±15,µm。
将GaAs单晶片做闭管热处理,装入热处理温度下产生工艺要求蒸汽压的保护砷,计算保护砷的量。
保护砷量计算公式:
W=PVMAs/RT;
V=Πr2,L-MGaAs/ρ。
式中,W为保护砷的质量,g;MAs为 As4分子摩尔量300,g/mol;T为热处理绝对温度 K;P为石英内砷的蒸汽压 atm;V为密封石英管内的净容积;R为常数0.082,atm L/(K mol);r为石英管内半径;L为封管实际长度;MGaAs为晶片质量;ρ为 GaAs密度5.32,g/cm3。
装入保护砷后,抽真空,当真空度达10-4,Pa数量级时,封管、装炉,装炉要保证放置晶片位置处在炉体恒温区中。准备工序完成后,开始退火。退火工艺参数包括:4±0.1,h从室温升至实际退火温度,恒温12±0.1,h后降温,6±0.1,h降至室温。
退火后的 GaAs晶片经过抛光、清洗,到规定厚度 625±20,µm 时,测试晶片的 EL2浓度及亮点缺陷。
实验的具体工艺参数如表 1所示,实验1、2、3、4分别对应样品1、2、3、4。

表1 工艺参数Tab.1 Technological parameters
2 结果与讨论
GaAs中的固液同组分点不在理想配比处,而是偏向富As区,当GaAs固相区扩展到一定范围后,向理想配比处回缩。因此,用 GaAs熔体生长富 As的GaAs单晶,在生长完成后的冷却过程中,As的溶解度逐渐降低,出现过饱和。此时的 As原子主要有两种存在方式:①当过饱和的 As达到 As沉淀成核的临界值,且达到该值时的温度高于过量 As的冻结温度时,开始产生As沉淀;②过饱和的As以本征点缺陷的形式扩散到 GaAs晶体中,这种本征点缺陷是As间隙原子。As沉淀宏观表现既为亮点缺陷,会对后续的器件加工产生不利的影响,希望能减少亮点缺陷;As间隙原子在高温后的冷却过程中,会与VGa结合生成AsGa,并俘获VGa,生成EL2,因此As间隙原子的存在有利于EL2的形成。EL2是半绝缘GaAs晶体中的施主杂质,与残留受主的补偿作用可形成半绝缘特性,其浓度的变化也会影响GaAs晶体的电学特性。而EL2浓度强烈依赖于GaAs晶体中As的原子百分比,因此,EL2的浓度与热处理过程中砷蒸汽压的大小和热处理温度有关。
将样品在不同退火条件下进行热处理,测试样品原生态和退火后的 EL2浓度及亮点缺陷,EL2浓度测试结果见表2。

表2 EL2浓度的测试结果Tab.2 Test result of EL2concentrations
样品1在真空条件下,经950,℃退火12,h得到。由表 1可看出,经热处理后的晶片 EL2浓度略微增加,但是热处理后的亮点缺陷与原生态相比不仅没有减少,反而略微增多。理论上,在高温低压条件下,晶片表面的 As原子蒸发,由于浓度梯度使晶片内部的As原子向晶片表面扩散,从而减少了砷沉淀的存在。实际上,虽然晶片表面的砷蒸发造成晶片表面离解,但根据文献[2]所述,在 950,℃热处理时会促进本征点缺陷(主要是As间隙原子)转化为EL2和As沉淀,而此温度又不足以使原有的 EL2分解,所以退火后晶片的 EL2和 As沉淀都略微增加,As间隙原子减少。
样品 2是在砷蒸汽压 1.0,atm 的条件下,经1,070,℃退火12,h得到。退火后样品的EL2浓度有较大增加,但同样,亮点缺陷也没有减少。由于过高的退火温度(1,100,℃以上)容易使 EL2分解,会造成半绝缘砷化镓由 N型半绝缘转变为 P型半导体,所以退火温度需在 1,100,℃以下。在高温(本实验所用温度为1,070,℃)高砷压(本实验所用砷压为1.0,atm)条件下,GaAs晶体与环境气象 As相互作用使样品发生了 As间隙原子从晶片表面向内部扩散,化学配比向富As方向移动,As间隙原子大量增加。高温过程后的冷却过程中,一部分As间隙原子生成EL2;另一部分As间隙原子在冷却过程中随溶解度的降低逐渐析出,转化为砷沉淀;其余 As间隙原子依然以本征点缺陷的形式存在于晶体中。[3]所以此时的 EL2浓度有较大的增加,砷沉淀并没有减少,主要是因为砷的环境蒸汽压过大。
样品 3是在砷压 0.8,atm条件下,经 1,070,℃退火12,h得到。退火后样品的EL2浓度增加,此时亮点缺陷有所减少。在高温退火条件下,1,070,℃有利于砷沉淀的溶解,溶解的砷沉淀转化为砷间隙原子。此时的环境砷蒸汽压略小,晶片表面的 As原子蒸发,由于浓度梯度的存在使表面产生 VAs并从表面向内部扩散,与外扩散的As间隙原子相遇,消耗了一部分As间隙原子,另一部分As间隙原子转化为EL2,剩下的 As间隙原子在退火后的降温过程中转化为砷沉淀。砷沉淀虽然有所减少,但还是可以观察到。
样品 4是在砷蒸汽压 0.6,atm 的条件下,经1,070,℃退火12,h得到。退火后样品的EL2浓度略微增加,此时亮点缺陷消失。其原因是进一步降低了砷蒸汽压,使晶片表面更多的As原子蒸发产生VAs,由于浓度梯度的存在,使 As间隙原子向晶片表面扩散。剩下较少的As间隙原子生成EL2。As间隙原子的减少,促进了砷沉淀继续转化为 As间隙原子,As间隙原子的消耗使晶片中的过量砷减少,在冷却过程中不足以达到砷沉淀成核的临界值,因此不会形成砷沉淀,或者说所形成的砷沉淀较小以至于无法观察到。
图1 为不同热处理条件下,样品在Yamada灯下的砷沉淀图。从图1中可看出,a、b、c、d分别对应热处理后样品1、样品2、样品3、样品4。可明显看出,样品 1在 950,℃热处理后,亮点缺陷密度最大。在1,070,℃热处理后,随砷蒸汽压的减小,亮点缺陷密度逐渐减小,直至消失,达到较好的效果。
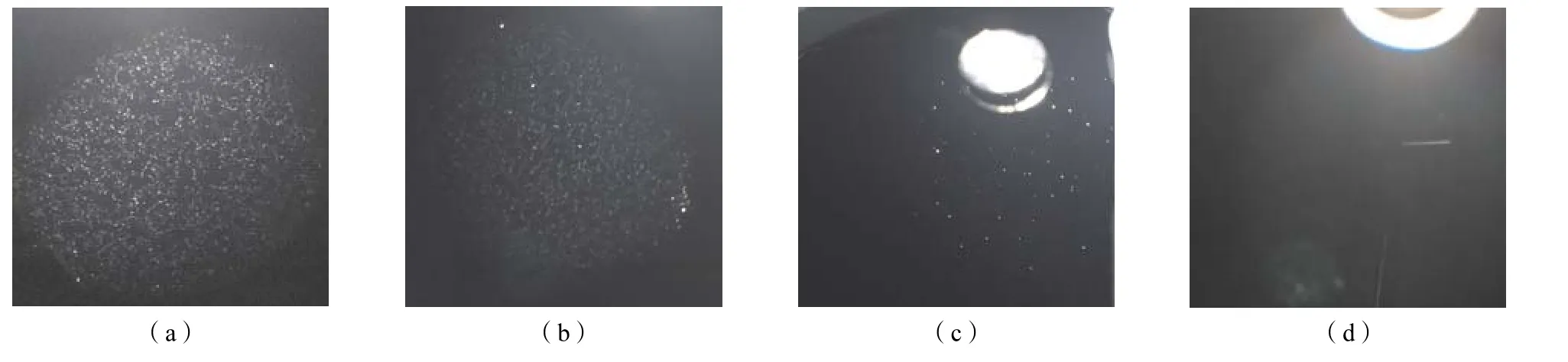
图1 样品在热处理后砷的亮点缺陷图Fig.1 Light point defect figure of samples after thermal treatment
3 结 论
对半绝缘 GaAs晶片进行了不同条件的热处理研究。当热处理温度为 950,℃,真空条件时,虽然环境砷蒸汽压很低,但有利于 As间隙原子向 As沉淀和 EL2的转化;当热处理温度为 1,070,℃时,随环境砷蒸汽压的增加,晶片内的As间隙原子增加,EL2浓度增加,在冷却的过程中,砷沉淀也会增加。即半绝缘 GaAs热处理后,在高温冷却的过程中,过量砷主要有 3种存在形式:砷沉淀、砷间隙原子和 EL2,经过适当温度、适当砷蒸汽压热处理时,砷的 3种存在形式会相互转换。为减少砷沉淀,又不会造成晶片表面的离解,因此在热处理温度下,保持适量的砷蒸汽压可大量减少砷沉淀,同时保持EL2浓度不降低。■
[1] 刘红艳,孙卫忠,王娜,等. 半绝缘砷化镓中本征缺陷的光学显微研究[J]. 现代仪器,2008(3):38-40.
[2] 杨瑞霞. 热处理改善未掺杂LEC GaAs中EL2分布均匀性机理的研究[J]. 固体电子学研究与进展,1994,14(1):85-90.
[3] 刘力锋,杨瑞霞,郭惠. 热处理和淬火影响 GaAs中EL2浓度机理的研究[J]. 红外技术,2002,24(1):30-33.
On Thermal Treatment for Reducing Light Point Defect of GaAs Monocrystal Wafer
YANG Yi,ZHOU Chunfeng,LAN Tianping
(No.46 Research Institute of China Electronic Technology Group Corporation,Tianjin 300220,China)
GaAs monocrystal material has already become one of the important fundamental materials in microelectronics and optics-electronics and has been widely applied in these fields. Thermal treatment was carried out under different temperatures and different arsenic vapor pressures for GaAs monocrystal wafers in order to reduce the light point defect. Meanwhile, the existence form of As in GaAs and its mechanism during the thermal treatment were studied in detail.
GaAs monocrystal wafer;thermal treatment;light point defect;EL2
G312
A
1006-8945(2016)02-0019-03
2016-01-11

