质子辐照对场板AlGaN/GaN HEMT器件电特性的影响
谷文萍,张 林,杨 鑫,全 思,徐小波,杨丽媛,刘盼芝
(1.长安大学电子与控制工程学院,陕西西安 710064; 2.西安电子科技大学微电子学院,陕西西安 710071;3.西安理工大学材料科学与工程学院,陕西西安 710048)
质子辐照对场板AlGaN/GaN HEMT器件电特性的影响
谷文萍1,2,张林1,杨鑫3,全思1,徐小波1,2,杨丽媛1,刘盼芝1
(1.长安大学电子与控制工程学院,陕西西安 710064; 2.西安电子科技大学微电子学院,陕西西安 710071;3.西安理工大学材料科学与工程学院,陕西西安 710048)
分别采用3MeV和10MeV的质子对GaN基HEMT(High Electron Mobility Transistor)器件进行辐照.实验发现:低注量辐照引起了体材料载流子浓度增加,高注量辐照引起了HEMT器件漏电流下降,跨导减小,阈值电压显著退化的结果.通过分析发现辐射感生受主缺陷引起的2DEG浓度降低是上述器件退化的主要原因.此外基于实验结果,采用辐射感生受主缺陷退化模型仿真并计算了HEMT器件主要参数随受主浓度的退化规律,仿真结果与实验结果有较好的一致性.本文实验结果也表明场板结构和SiN钝化层有效地阻止了电子陷落在表面态中,屏蔽了绝大部分的辐照损伤,是很有效的辐射加固手段.
AlGaN/GaN HEMT;质子辐照;辐射感生受主缺陷;辐射加固
1 引言
由于出色的综合性能优势,GaN基HEMT器件在航天、核工业、军事等特殊空间应用领域具有广泛的应用前景[1,2].而空间环境除了有各种宇宙射线,电磁辐射外,在地磁俘获带还存在大量高能带电粒子,主要为质子和电子,它们构成了半导体器件在空间辐射环境中主要的辐射源,所以研究质子和重核子对GaN基HEMT器件的辐射效应倍受关注[3~6].
高能质子是空间辐射环境中最主要的组分,它和电子一样,与物质通过库仑作用反应.Luo[3]等人发现40MeV,5×1010cm-2质子辐射后,GaN HEMT器件漏源电流下降了15%到20%,非本征跨导下降了约30%,质子辐射同时还引起器件的最高振荡频率fmax下降了20%.Hu[4]等人发现不同能量质子辐射对GaN基HEMT器件的影响不同,在能量1.8MeV注量1012cm-2质子辐射下器件饱和电流下降了10.6%,最大跨导下降了6.1%,而在注量1013cm-2能量为15MeV、40MeV和105MeV质子辐射下器件退化却很小.Lv[7]等人仿真得到了不同能量质子在AlGaN/GaN异质结中的辐射损伤区,认为空位缺陷可能是HEMT器件电学特性退化的主要原因.国外目前已对GaN基HEMT器件的辐照损伤研究加大了力度,但是国内有关HEMT器件质子辐照效应的研究还相对较少,而作为一种很好的抗辐射器件应用,我们很有必要研究它的辐照效应,特别是需要对其辐射退化和损伤机制进行深入研究.
本文利用自主研制的AlGaN/GaN HEMT器件开展了质子辐照效应研究,讨论了质子辐射下GaN基器件主要参数的退化规律,并对辐照后室温下的退火效应加以分析,讨论了质子辐射退化的物理机理.此外基于实验结果,采用辐射感生受主缺陷退化模型仿真并计算了HEMT器件主要参数随受主浓度的退化规律.
2 器件制造和辐射实验
实验选用的HEMT器件有1000nm的SiN钝化层,都做过场板结构.本文分别采用了3MeV和10MeV的质子能量,其中1,2,3样品用10MeV质子辐射,注量分别对应1010cm-2,1011cm-2,1012cm-2;4到9号样品用3MeV质子辐射,注量分别对应1011cm-2,1012cm-2,1013cm-2,1014cm-2,5×1014cm-2,1015cm-2;GaN体材料样品XDB267,XDB268分别用3MeV 1013cm-2,1014cm-2质子进行辐射.
3 实验结果及分析
图1为两种能量质子辐射下HEMT器件欧姆接触参数的退化,左上角为退化曲线.可以看出,在1014cm-2注量之前,欧姆接触参数的退化几乎可以忽略,但是随着注量进一步增加,方块电阻Rsh却明显增加,同时欧姆接触电阻RC稍有减小.总之,质子辐射下,Rsh随着辐射注量的增加先减小后增加,而RC变化与之相反,不过总体上后者的退化较小,对整个器件特性影响不明显.此外低能量质子的退化比高能量的要明显,这是因为质子辐射时,主要通过非电离能量损失即NIEL产生损伤,而NIEL与质子能量成反比.
表1列举了质子辐照前后GaN体材料特征参数的退化,这与图1中低注量质子辐射后Rsh减小的变化基本一致.这是因为在GaN体材料的生长过程中Ⅲ-Ⅴ族比较高,材料中形成了很多镓空位VGa,质子虽然是辐射粒子,但是它同时也是一种正离子,如果辐射注量较小的话,那么此时入射质子一方面作为正离子[8]可以吸引电子,一方面还可以与VGa等受主缺陷结合,从而减少了带电缺陷和散射中心,所以辐照后载流子浓度和迁移率都略有增加.这也说明如果适当地控制辐射能量和注量,那么也有可能改善材料的性能.但是,随着辐照注量增加,质子主要通过NIEL的位移效应在异质材料中产生辐射感生受主缺陷,而这些辐射感生受主缺陷通过去载流子效应可以耗尽一部分2DEG,从而使得材料的方块电阻增加.

表1 Hall参数在质子辐照前后的退化比较

图2、图3分别为不同注量质子辐射前后,HEMT器件正反向栅特性的退化.可以看出,低注量(注量不高于1014cm-2)质子辐射后器件的栅电流基本不变.而3MeV 1015cm-2注量后,器件的正反向栅电流都明显减小.因为此时质子注量较高,通过位移损伤在异质结材料中感生了不少辐照缺陷,而且与其他辐射粒子相比,质子辐射淀积的能量较高,所以在材料内更易形成深陷阱,这些深陷阱一旦俘获电子,电子就不容易退陷,所以此时的陷阱作用机制主要是深陷阱的载流子去除效应.另一方面,这些电子的陷落对后续电子的运动也有一定的阻挠,从而减少了栅电子/沟道电子的注入,降低了正反向栅泄漏电流.
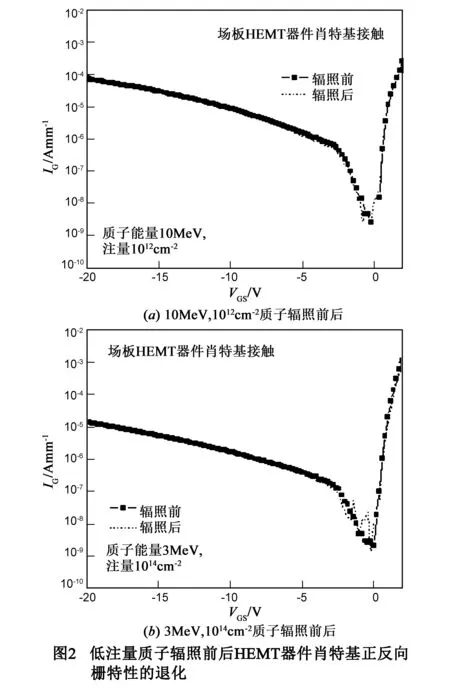
跟肖特基特性影响类似,当注量不高于1014cm-2,HEMT器件转移特性也几乎没有退化.此结果也说明质子辐射过程中,场板和SiN钝化层有效地阻止了电子陷落在表面态中,屏蔽了绝大部分的辐照损伤,是很有效的抗辐射加固手段.
图4(a)和(b)分别给出了3MeV,1015cm-2质子辐射前后器件转移曲线和关态泄漏电流的退化.可以看出,此注量下器件的饱和漏电流和跨导峰值分别下降了26%和7%,转移曲线斜率稍有下降,而阈值电压正漂了39%,其中阈值电压退化最为显著.


质子辐射在异质结材料中可以通过辐射感生受主缺陷的去载流子效应耗尽一部分2DEG,也可能通过感生界面应力弛豫而使2DEG浓度下降[9],合并迁移率的降低会引起器件串联电阻的增加,从而使得漏电流和跨导减小,阈值电压正漂.而如同在MOS晶体管中,转移特性曲线斜率减少主要与界面态电荷的增加有关,同样,对于HEMT器件,主要也是界面态电荷增加引起转移特性曲线斜率降低的.而且器件饱和区跨导主要受迁移率影响,而迁移率则主要受辐射感生界面态影响;不过阈值电压则主要受沟道中2DEG浓度影响,与迁移率关系不大.本文最大质子注量下跨导也只下降了7%,远小于阈值电压39%的退化,而且转移曲线斜率变化很小,所以迁移率的退化不大,即辐射感生的界面态不多,而且辐照感生界面应力弛豫是通过断裂应力键形成界面态的时候引起的,所以分析认为上述器件的退化主要还是由于辐射感生受主缺陷引起的2DEG浓度降低造成的.
辐照后,我们研究了HEMT器件的室温退火特性,图5为HEMT器件的退火特性.室温退火后可以观察到明显的退火恢复现象,这说明质子辐照产生的损伤可以部分退火恢复.

4 辐射感生受主缺陷退化模型研究
研究发现质子辐照在AlGaN/GaN材料和结构中主要以空位等受主型缺陷为主[7].结合上面的实验结果,下面使用辐射感生受主缺陷退化模型分析了HEMT器件主要的辐射损伤.
对HEMT电学特性而言,辐射感生受主缺陷会引起两个基本辐射效应,它们使异质结构各层材料中的有效掺杂浓度变化(由载流子去除引起)和迁移率的下降(由附加缺陷散射中心引起),并由此造成器件参数退化.而以上实验中辐照主要通过引起2DEG浓度的变化退化其他参数,所以在此模型中,主要以影响阈值电压漂移为根本的损伤效应,并通过漂移器件阈值电压进一步导致漏电流和跨导的退化.
下面我们基于Fan建立的HEMT器件阈值电压的漂移模型[10],以受主缺陷在HEMT结构不同层中引入后对器件电参数的影响为研究对象,建立了辐射感生受主缺陷的退化模型.

图6是HEMT不同层引入受主对阈值电压漂移的影响以及实验结果和计算结果的对比.结果显示阈值电压随受主浓度Na增大而正向漂移,这与之前大注量辐照后阈值电压变化的实验结果相一致,表明我们采用的模型是合理的.结果还显示,在1016cm-3受主浓度以前,阈值电压的绝对漂移很小,之后漂移速度随着受主浓度而加快.同时还可以看出GaN层引入的受主对阈值电压变化的贡献占主导地位,AlGaN层中引入的受主只是在相当高的浓度下才对阈值电压漂移起明显的作用.这一结果与B.Jun和R.J.Krantz等对同结构的AlGaAs/GaAs HEMT的辐照效应实验得到的结论完全一致.为了建立辐射剂量跟辐照感生受主缺陷之间的关系,我们把上面的计算结果和我们之前的实验结果进行了比较如图6(b),这里我们主要进行了异质结构阈值电压漂移的比较,计算中认为AlGaN/GaN各层均匀引入受主缺陷,可以看出随着辐射剂量的增加,引入的受主缺陷增多,阈值电压退化增强.
图7是计算得到的辐射感生受主对器件转移特性和跨导的影响.很明显,随受主浓度的增加,转移曲线正向移动,其斜率基本没变,最大跨导也基本没变.仿真结果说明跨导主要受迁移率影响,而与阈值电压关系不大.上述实验中I-V特性的变化显然主要是受阈值电压变化(2DEG浓度)影响的.

本文质子辐照后转移特性主要表现为曲线平移而其斜率变化很小,并且跨导也下降不大.因此我们认为辐射感生受主缺陷造成的阈值电压漂移(2DEG浓度的降低)才是器件退化的主要原因.
5 结论
以上实验结果表明,低注量质子辐照后GaN体材料的载流子浓度和迁移率略有增加,进而使得材料的串联电阻略有降低.对于HEMT器件辐照后发现只有在最高注量1015cm-2下,器件饱和漏电流,最大跨导和阈值电压等参数才发生退化,而且阈值电压变化最为显著.通过漏电流,跨导和阈值电压的退化比较,我们认为上述器件的退化主要是由于辐射感生受主缺陷引起的2DEG浓度的降低造成的,主要体现为阈值电压的漂移退化.而且辐照后由于质子在异质结材料中感生的缺陷使得器件正反向栅电流明显降低,关态泄漏电流减小.此外实验中发现了明显的器件退火恢复,这说明场板和SiN钝化层有效地阻止了电子陷落在表面态中,屏蔽了绝大部分的辐照损伤.
另外本文从实验结果出发,基于辐射感生受主缺陷影响模型进行计算.计算结果表明,随着引入的受主缺陷浓度增加,阈值电压发生正向漂移,并且随着辐照注量的增加,引入的受主缺陷增加,阈值电压漂移更加明显.在沟道GaN层中引入的类受主陷阱是造成HEMT阈值电压增加的主要原因.分析结果表明,辐射感生受主缺陷主要通过引起阈值电压增加(2DEG浓度的降低)的机制,使得器件饱和漏电流退化,但对器件饱和区跨导影响不大.因此辐射感生受主的影响模型能够全面反映本文辐射对器件的作用机制,在联合辐射感生界面态等对迁移率的退化作用后,可以对器件进行有效的辐射效应模拟和分析.
[1]Jain S C,et al.Ⅲ-nitrides:Growth,characterization,and properties[J].Journal of Applied Physics,2000,87(3):965-969.
[2]Khan M A,et al.AlGaN/GaN metal oxide semiconductor heterostructure field effect transistor[J].IEEE Electron Device Lett,2000,21(1):63-65.
[3]Luo B,et al.High-energy proton irradiation effects on AlGaN/GaN high-electron mobility transistors[J].Journal of Electronic Materials,2002,31(5):437-441.
[4]Hu X,et al.The energy dependence of proton-induced degradation in AlGaN/GaN high electron mobility transistors[J].IEEE Transactions on Nuclear Science,2004,51(2):293-297.
[5]Mc Clory J W.The Effect of Radiation on the Electrical Properties of Aluminum Gallium Nitride/Gallium Nitride Heterostructures[D].Ohio:Technology Air University,2008.
[6]Gu W P,et al.The Effect of neutron irradiation on the electrical properties of AlGaN/GaN high electron mobility transistors[J].Acta Physica Sinica,2014,63(4):047202-1-6.
[7]Lv L,et al.Study of proton irradiation effects on AlGaN/GaN high electron mobility transistors[J].Microelectronics Reliability,2011,51(12):2168-2172.
[8]Heon K,et al.Increase of breakdown voltage on AlGaN/GaN HEMTs by employing proton implantation[J].IEEE Transactions on Electron Devices,2009,56(3):365-369.
[9]Fan L,et al.The effect of radiation induced strain relaxation on electric performance of AlmGa1-mN/GaN HEMT[J].Acta Physica Sinica,2007,56(6):3393-3399.
[10]范隆.氮化镓基薄膜缺陷及高电子迁移率晶体管辐射损伤的研究[D].西安:西安电子科技大学,2003.
Fang Long.The Study on Defects in GaN-Based Films and Radiation Damage of High Electron Mobility Transistors[D].Xi′an:Xidian University,2003.(in Chinese)

谷文萍女,1982年11月出生,陕西宝鸡人,博士,2010年毕业于西安电子科技大学微电子学院,其后进入长安大学任教,讲师,从事GaN基材料和器件的研究工作.
E-mail:wpgu@chd.edu.cn
The Effect of Proton Irradiation on the Electrical Properties of FP-AlGaN/GaN High Electron Mobility Transistors
GU Wen-ping1,2,ZHANG Lin1,YANG Xin3,QUAN Si1,XU Xiao-bo1,YANG Li-yuan1,LIU Pan-zhi1
(1.SchoolofElectronicandControlEngineering,Chang’anUniversity,Xi’an,Shaanxi710064,China;2.SchoolofMicroelectronics,XidianUniversity,Xi’an,Shaanxi710071,China;3.SchoolofMaterialsScinceandEngineering,Xi’anUniversityofTechnology,Xi’an,Shaanxi710048China)
The radiation effect of FP-GaN HEMT was investigated by using proton radiation source.After low irradiation fluence,the phenomena of an increase in carrier density of GaN material was found.The device showed negligible degradation at low proton fluences.At high fluences,the decreased drain current and transconductance as well as the obviously shifted threshold voltage of HEMT were observed.And the ohmic contact was so relative robustness to proton,but the Schottky characteristics degraded obviously.Utilizing the depletion approximation theory and the introduction of acceptor defects to express radiation induced defects in AlGaN/GaN heterostructures,we developed irradiation induced acceptor defects damage model for AlGaN/GaN HEMT.The simulations indicated that the acceptor defects induced in both channel and buffer layer dominate the radiation damage in AlGaN/GaN HEMT.A good agreement between calculations and experiments presents the validity of this model.The annealing results proved that the damage induced by proton may be partially recovered.SiN-passivated FP-AlGaN/GaN HEMTs appear to be attractive candidates for space and terrestrial applications,and the HEMTs are resistant to displacement damage.
AlGaN/GaN HEMT;proton-irradiation;irradiation induced acceptor defects;radiation hardness
2015-03-17;修回日期:2015-06-23;责任编辑:梅志强
国家自然科学基金(No.61504011,No.51504191);中国博士后基金(No.2013M540732,No.2013M542307);陕西省自然科学基金(No.2014JM6229,No.2014JQ8344,No.2015JM6357);中央高校基本科研业务费项目(No.310832161002);西安市科技计划项目(No.CXY1441(9),No.CXY1438(5));大学生创新创业训练项目(No.201510710037)
TN323+.4
A
0372-2112 (2016)06-1445-05

