SiC高温高能离子注入机的离子源热场研究
彭立波,张 赛,易文杰,罗才旺,孙雪平
(中国电子科技集团公司第四十八研究所,湖南 长沙 410111)
SiC高温高能离子注入机的离子源热场研究
彭立波,张 赛,易文杰,罗才旺,孙雪平
(中国电子科技集团公司第四十八研究所,湖南 长沙 410111)
高温高能离子注入机是宽禁带半导体SiC产业的关键设备,离子源直接影响整机的性能指标。为保证离子源的长寿命和大束流,针对SiC高温高能离子注入机中的离子源热场问题,采用仿真软件对灯丝、阴极帽和AlX罩的热场、热变形进行了研究,提出了离子源运用过程中的注意事项及改进设计。
碳化硅(SiC);离子注入机;离子源
SiC(碳化硅)作为一种宽禁带半导体材料,由于具有击穿电场强度高、热稳定性好、载流子饱和飘移速度高、热导率高等特点[1],已被用于制造各种耐高温高频大功率器件。SiC材料的p型掺杂一般通过注入铝离子来实现,由于SiC密度较大,如果离子要达到较深的注入区域,需要高能注入[2]。而高能量的离子注入会在注入区域的材料表面和内部都造成损伤,为了解决离子注入的激活问题并减少因注入造成的损伤[3-5],SiC需要在500℃的高温条件下进行注入[6-9]。离子注入作为SiC器件制造中的关键技术主要体现在以下3点:(1)需要注入铝离子;(2)注入的离子能量较高,一般在500 keV左右;(3)离子注入过程中SiC晶片要加热至500℃。
高温高能离子注入机是宽禁带半导体SiC产业的关键设备,离子源直接影响整机的性能指标。产生足够的铝离子是SiC离子注入机的关键[10,11],其中的离子源采用阴极溅射AlX固体材料的方式形成含铝离子的等离子体,通过电场将离子引出,然后通过分析、加速、聚焦、扫描等一系列部件,最终形成在SiC晶片注入的高能铝离子束。
离子源通过灯丝加热发射热电子,热电子在电场作用下,轰击阴极帽使阴极帽升温;高温的阴极帽发射热电子,使离子源腔内的气体电离,电离后的离子溅射AlX罩,溅射出铝原子并使其电离,形成铝离子。离子源中存在一系列的热场问题,包括电磁热、热辐射、固体传热、热变形等,采用先进的多物理场仿真软件对离子源的热场及热变形进行深入研究[12,13],有利于对离子源的正确运用和改进设计,进一步提升离子源的综合性能。
1 建立模型
此模型共涉及3个物理场,分别是电流、固体传热和固体力学,以及三者之间的相互耦合。电流物理场作用在灯丝上,而灯丝、阴极帽、AlX罩和三者之间的气体都受固体传热和固体力学物理场作用。
电流物理场由公式(1)、(2)、(3)计算:

其中:J为电流密度,Je为外电流密度,E为电场强度,D为电位移场,V为电势。
固体传热物理场由公式(4)计算:

其中:ρ为材料的密度,Cp为常压热容,T为温度,t为时间,u为流体的速度场,k为导热系数,Q为热源产生的热量。
固体力学物理场由公式(5)计算:

三个物理场之间的关系:电磁热源为电流,目标端为固体传热;温度耦合的源项为固体传热,目标端为电流和固体力学。
2 计算结果
2.1 离子源中灯丝的热场及热变形
灯丝依靠通过的电流进行加热,产生的热量由焦耳定律得到。其结构如图1所示,其中蓝色的区域是灯丝的两个端面,与电极连接,加2.5 V电压。灯丝的材料为纯钨,材料电导率使用温度(T)的线性电导率公式为:

其中:参考电阻率ρ0为5.5E-8 Ω·m,电阻温度系数α为0.00482,参考温度Tref为20℃,T为材料的温度。温度场与电场加热通过温度线性电导率公式(6)耦合。

图1 灯丝的电极连接端面
100 s之后,灯丝的温度分布如图2所示。灯丝前端的温度为2 255℃,达到发射热电子的工作温度,灯丝的发热功率为313 W降至260 W,灯丝功率随时间的关系如图3所示,可以发现热场在100 s时基本稳定。灯丝施加电压的两个端面与夹具连接,在模型中的这两个端面处施加固定约束,此时灯丝的热变形量如图4所示,最大变形量是0.26 mm。
钨的熔点为3 410℃,灯丝在工作时有时会出现熔断的现象,说明灯丝温度有可能达到3 000℃以上。当灯丝温度继续上升到3 001℃时,变形量为0.39 mm(如图5所示)。而灯丝与阴极帽之间的最小距离为0.6 mm,灯丝温度继续升高,产生的热变形量更大,安装过程中稍微偏离,灯丝与阴极帽就会短路,造成离子源故障。

图2 灯丝的温度分布图

图3 灯丝功率随时间的关系

图4 灯丝的热变形量
2.2 离子源中阴极帽的热场及热变形
离子源中灯丝和阴极帽的相对位置如图6所示。图7所示蓝色部分是离子源灯丝的热电子发射平面。图8是离子源中的阴极帽,图中蓝色部分是接收灯丝发射电子的平面,即阴极帽的加热平面。与灯丝的热电子发射平面对应,阴极帽加热面上的加热区域如图9中蓝色部分,阴极帽的加热功率在此区域。

图5 灯丝的温度和变形量
正常情况下,灯丝的电子发射面与阴极帽的加热面平行,阴极帽加热面的加热区域如图9蓝色部分所示,该区域的总面积为38.13 mm2。加热功率为750 W时,阴极帽发射面的温度如图10所示,最高温度为2 245℃,达到发射热电子所需的温度,整个阴极帽的温度最高温度为2 311℃。可以发现,阴极帽的高温区域在发射面,且整个发射面的温度分布不均匀,温差达到138℃,造成发射面发射电子的能力不均匀。

图6 灯丝与阴极帽的相对位置

图7 灯丝的热电子发射面

图8 阴极帽

图9 加热区域
当阴极帽的加热面积急剧减少,相同的功率750 W加在1 mm2的面积上时,阴极帽的温度分布如图11所示,表面的最高温度2 537℃,最低温度2 047℃,温差较大,造成热电子发射能力出现波动,最终影响离子源内的等离子状态的稳定。阴极帽加热区域的温度为3 505℃,已经超过材料的熔点,持续一段时间会造成离子源短路和阴极帽烧穿等故障。
当阴极帽加热至发射电子温度后,灯丝维持原电压2.5 V不变时,功率为233 W,灯丝温度达2 562℃,远超正常工作温度,有熔断的危险。为保证灯丝的正常使用,可把灯丝电压降低至1.8 V,灯丝的总功率降为190 W,此时灯丝和阴极帽的温度分布如图12所示,分别为2 274℃和2 282℃,能保证正常的热电子发射。
此时仍是灯丝的变形量最大,为0.29 mm(如图13左所示);而阴极帽的最大变形量为0.22 mm(如图13右所示)。
2.3 离子源中AlX罩的热场及热变形
AlX罩的主结构为一个圆筒,圆筒的内面套在阴极帽上,AlX罩与阴极帽的相对位置如图14所示。
加上AlX罩之后,相同功率下,阴极帽的温度略有上升,最高温度由2 274℃升为2 322℃。AlX罩的温度在1 458℃至1 561℃之间,温度最高的位置在内圆筒面,此位置与阴极帽最近,而AlX罩的外圆筒面温度也达到1 500℃以上(如图15所示)。
改进后的AlX罩结构如图16a所示,在圆筒内面开了一个槽。此时AlX罩的温度场如图16b所示,最高温度1 522℃,且只出现在局部位置。大部分区域的温度在1 500℃以下,外圆筒面温度不超过1 480℃。同时对AlX罩的热变形进行了仿真计算,热变形的最大值是0.24 mm。

图10 阴极帽的温度场

图11 功率750 W加在1 mm2面积上时阴极帽的温场

图12 灯丝功率降低之后的温场

图13 灯丝功率降低后的变形量

图14 AlX罩的结构及AlX罩与阴极帽的相对位置

图15 加上AlX罩之后的温度场
3 分析与讨论
离子源中的灯丝在通电流100 s之后,热场基本稳定,加热功率从313 W降至260 W,灯丝前端的温度达到最大2 255℃时,达到发射热电子的工作温度,此时灯丝的最大热变形量是0.26 mm。当灯丝温度继续上升到3 001℃时,变形量为0.39 mm。随着温度的继续升高,灯丝的热变形量增加。而灯丝与阴极帽之间的最小距离仅0.6 mm,灯丝变形量过大会造成灯丝与阴极帽短路,在离
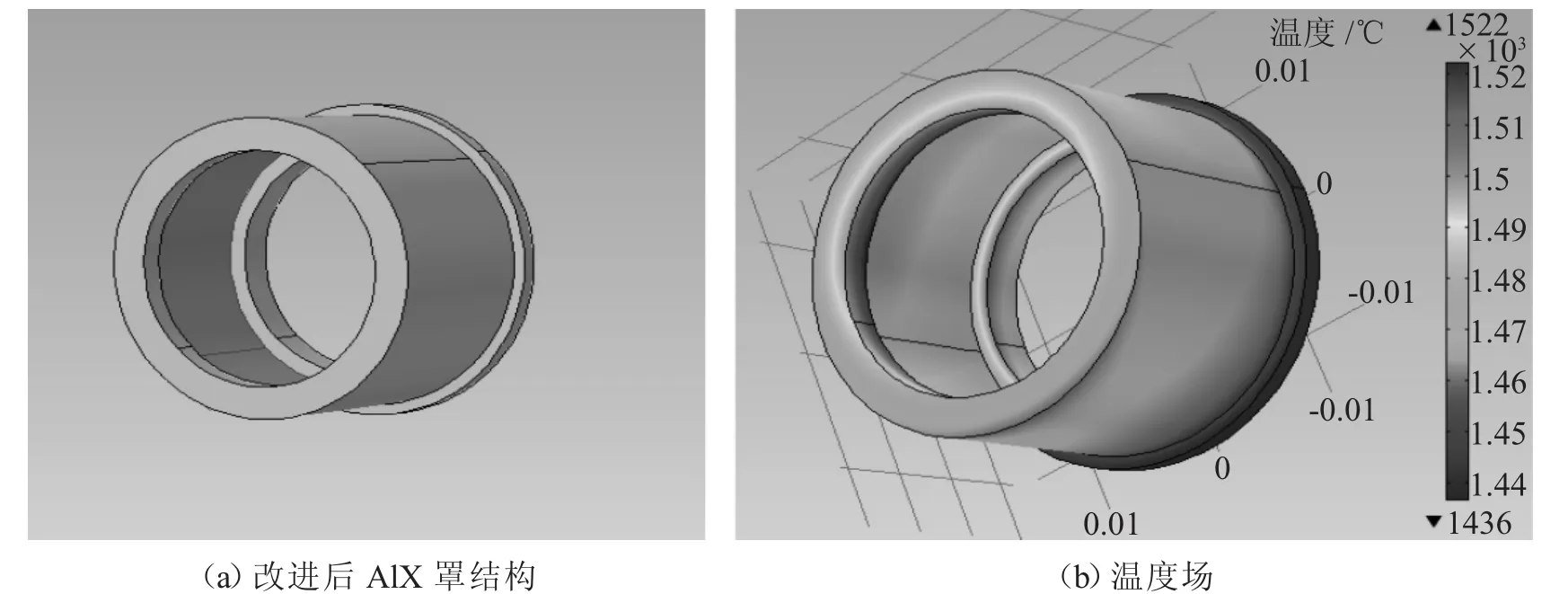
图16 改进后AlX罩结构及其温度场
子源使用时应避免灯丝温度过高。
离子源中的阴极帽加热功率为750 W时,阴极帽发射面的最高温度为2 245℃,可以发射热电子,但整个面的温度分布不均匀,这主要是灯丝形状导致的加热面造成的,为提高阴极帽发射面的热场均匀性,可对灯丝的形状改进设计。电子轰击阴极帽区域的减少会使阴极帽的温差加大,这不仅会影响热电子发射造成离子源腔内等离子体状态不稳定,而且可能使阴极帽的局部熔化,造成阴极帽烧穿或短路等故障。
阴极帽的温度升高会对灯丝起到一定的保温作用,灯丝维持源加热功率不变会使灯丝温度升高,影响使用寿命。实际使用中,在阴极帽温度上升后,需要及时减小灯丝的加热功率。
AlX罩结构的改变比较明显地降低了其温度,有利于保持AlX材料的性质稳定,减少了AlX罩的击穿几率。通过热场分析发现,AlX罩的温度与内圆筒的面积呈正相关,之后的改进设计可进一步减少前端的内圆筒面积。同时在离子源使用时,应避免阴极帽的温度过高,进而导致AlX材料的性质改变。
[1] MATSUNAMI H,KIMOTO T.Step-controlled epitaxial growth of SiC:high quality homoepitaxy[J].Materials Science and Engineering:R,1997,20(3):125-166.
[2] TAKASHI T,AKIMASA K,NORIYUKI I,et al.Experimental demonstration of 1200 V SiC-SBDs with lower forward voltage drop at high temperature[J].Materials Science Forum,2012,(717/720):917-920.
[3] PETRIK P,SHAABAAN ER,LOHNER T,et al.Ion implantation-caused damage in SiC measured by spectroscopic ellipsometry[J].Thin Solid Films,2004,(455/ 456):239-243.
[4] CHRISTEL L A,GIBBONS J F,Stoichiometric disturbances in ion implanted compound semiconductors[J]. Journal of Applied Physics,1981,(52):5050-5055.
[5] HALLEN A,HENRY A,PELLEGRINO P,et al.Ion implantation induced defects in epitaxial 4H-SiC[J].Materials Science and Engineering,1999,(61/62):378-381.
[6] GHEZZO M,BROWN D M,DOWNEY E,et al.Nitrogen-implanted SiC diodes using high-temperature implantation[J].IEEE Electron Device Letters,1992,(13):636-641.
[7] ZHANG Y,WEBE J,JIANG W,et al.Effects of implantation temperature on damage accumulation in Al-implantated 4H-SiC[J].Journal of Applied Physics,2004,(95):4012-4018.
[8] SAKS N S,SUVOROV A V,CAPELL D C.High tempera-ture high-dose implantation of aluminum in 4HSiC [J].Applied Physics Letters.2004,(84):5195-5197.
[9] BOHN H G,WILLIAMS J M,MCHARGUE C J,et al. Recrystallization of ion-implanted α-SiC[J].Journal of Materials Research,1987,(2):107-116.
[10]北京市辐射中心.离子注入机原理与技术[M].北京:北京出版社,1982.
[11]郭建辉,唐景庭,彭立波,等.大角度离子注入机质量分析器设计[C].长沙:第十三届全国三束学术年会,2005.
[12]曾攀.有限元分析与应用[M].北京:清华大学出版社,2004.
[13]张赛.离子注入机质量分析器线包温度场研究[J].电子工业专用设备,2014,(6):12-15.
Researched on The Thermal Field of The Ion Source of The High-temperature&High-power Ion Implanter
PENG Libo,ZHANG Sai,YIi Wenjie,LUO Caiwang,SUN Xueping
(The 48thResearch Institute of CETC,Changsha 410111,China)
High-temperature&high-power ion implanter is one of the most important equipment in the SiC industry.To make a ion planter with good performance,an good ion source is the key.Aiming at long lifetime of ion source and big ion beam current coming out of the ion source,the authors have researched on the thermal field issues of the ion source of the high-temperature&high-power ion implanter.To be specific,the thermal field and the thermal deformation of the filament,cathode cap and AlX cap is researched by using simulation software.Finally,the improvement and users instruction of the high-temperature&high-power ion implanter is proposed.
SiC;Ion implant;Ion source
TN305.3
A
1004-4507(2017)03-0039-07
2017-03-27
湖南省自然科学基金资助项目(14JJ2142)
彭立波:男,1972年,高级工程师,主要从事半导体工艺设备开发。

