ε-Ga2O3/4H-SiC异质结的能带排列分析
甘明丰
(北京邮电大学理学院 北京 100876)
1 引言
随着半导体材料科学的发展,现代电子器件在近几十年如雨后春笋般涌现,高性能器件逐渐形成了复杂化的结构。随着器件变得复杂化和微缩化,界面问题因其在数据存储和处理、电子器件、光伏器件、节能器件等方面的决定性作用而日益受到重视[1]。通过对界面现象的研究,人们发现并研究了一系列具有高实用潜力和有趣物理特性的半导体器件。众所周知,能带偏移是半导体异质结中最重要的电子参数之一,因为它会影响界面上载流子的迁移特性,并最终决定整个器件的性能[2]。因此,在设计和制造异质结器件之前,研究其能带排列,以挖掘其潜在的应用价值是很有必要的。
氧化镓(Ga2O3)是一种新兴的高速发展中的宽禁带半导体,在场效应晶体管(FET)、光电探测器和电阻式随机存储器(RRAM)等领域,由于它具有适当的吸收峰和截止峰,相比现有商用半导体材料具有更宽的带隙(4.9 eV)、更低的生长成本、更高的击穿电压(8 MV/cm),超高的光电响应率和响应速度,具有巨大潜力[3]。
在已报道的晶相中,单斜晶系Ga2O3(β-Ga2O3)由于具有较高的热力学稳定性和高质量的结晶性,是研究最多的晶相。最近Ga2O3的亚稳态相,如α相和ε相,由于超宽的带隙和一些独特的材料特性,也开始引起人们的兴趣。其中,ε-Ga2O3被发现是一种在外部电场作用下具有可翻转自发极化性的铁电材料。根据密度泛函理论(DFT)计算和重合位置点阵模型(CSL)预测,在合适的外延条件下,ε-Ga2O3可以在与α相和β相的竞争中稳定存在[4]。通过选择具有较大导带偏移的外延匹配衬底,异质结界面理论上还能形成高密度的二维电子气(2DEG),而且不需要借助掺杂工艺。此外,ε-Ga2O3由于具有可翻转自发极化的铁电性质,能够通过极化翻转更剧烈地改变二维电子气密度。Leone等[5]最近报道了在ε-Ga2O3/GaN异质结界面下的面电荷密度为6.4×1012cm-2。然而,获得高质量的异质结构以提供更优的电子输运特性仍然是一个挑战。
在本文中,我们通过X射线光电子能谱(XPS)研究了ε-Ga2O3/4H-SiC异质结的能带排列。样品的生长方式均为金属有机气相沉积法(MOCVD)。因为ε-Ga2O3和4H-SiC同属立方晶系与相同空间群P63 mc,晶格失配度较低,4H-SiC可以作为理想的外延衬底使用。利用紫外-可见吸收光谱(UV-vis)获得了其光学带隙,结合XPS测定的材料光电子能谱,计算出了其价带偏移量与导带偏移量。
2 实验方法
为了计算Ga2O3/SiC异质结的能带排列,我们需要准备3个样品进行测试。其中,样品1为SiC衬底样品;样品2是薄Ga2O3样品(5nm),用于同时测试样品Ga2O3/SiC界面的Ga,Si结合能信息;样品3是厚Ga2O3样品(70 nm)。Ga2O3样品由MOCVD在商用SiC衬底上进行外延生长。生长温度为420 ℃,反应气压为25 torr。能带的偏移会随着不同的材料生长参数而发生变化,但在本文中,我们只在统一生长环境下研究能带的偏移量。
为了确定样品的化学价态,我们使用ESCALAB 250Xi仪器(ThermoFisher Scientific)进行了XPS光谱分析。为了校正电荷偏移,在测量过程中利用了表面附着物测定的C 1s(284.9 eV)核能级(core level,CL)。此外,利用日立U-3900紫外-可见分光光度计分别对SiC衬底和Ga2O3薄膜的光学带隙Eg进行了测量。
根据光电子能谱测量的计算方法[2], Ga2O3/SiC的价带偏移量(ΔEv)和导带偏移量(ΔEc)可以由下面的公式得出:

和

其中,[E_core^Ga2O3(b)-E_VBM^Ga2O3(b)]与[E_core^SiC (b)-E_VBM^SiC (b)]分别是Ga2O3与SiC材料内的价带顶部(VBM)与CL之差,[E_core^Ga2O3(i)-E_core^SiC(i)]是Ga2O3/SiC界面处的两元素CL差值,E_g^Ga2O3(b)和E_g^SiC(b)分别是Ga2O3与SiC的光学带隙。
3 结果与分析
如图1所示,通过测量SiC和Ga2O3薄膜的紫外-可见吸收光谱,分别拟合[(αhv)2-hv]的线性区域可以得到,SiC和Ga2O3的光学带隙分别为3.29 eV与4.80 eV。其中,根据Biedermann[6]的研究,n型4H-SiC中2.70 eV处的吸收峰可归因于布里渊区M点的导带跃迁。将SiC和Ga2O3测定的光学带隙值与其他文献进行比较[7-8],可以发现Ga2O3和SiC的测量值与文献中的光学带隙相近。
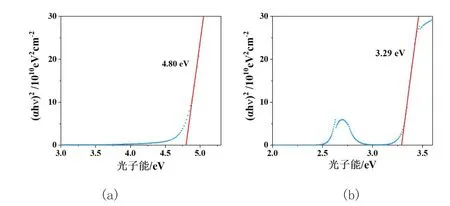
图1 通过图(a)ε-Ga2O3和图(b) SiC薄膜的紫外-可见吸收光谱数据拟合出的图谱[(αhv)2-hv]的线性区域分别得到的光学带隙
图2展示了样品1、2、3在-10到1350 eV范围内的XPS全谱图。所得的图谱峰值与过去报道的相同材料的XPS数据均一致。在Ga2O3/SiC异质结的界面处(样品2),测得Si与Ga的CL分别为101.12 eV和1118.8 eV。样品1和3中,VBM的值由样品XPS价带谱的线性拟合的横截距导出。SiC的VBM和CL分别为2.29 eV和100.92 eV,Ga2O3的VBM和CL分别为3 eV和1118.7 eV。因此由公式(1)计算,SiC/Ga2O3异质结的价带偏移ΔE_v=0.61 eV。导带偏移量也由公式(2)计算得出ΔE_c=0.9 eV。基于以上结果,得到Ga2O3/SiC异质结的能带示意图3。Ga2O3/SiC异质结的能带结构是Ⅰ型能带排列(嵌套型),这表明界面上的价带和能带的不连续性将会控制载流子的注入和输运特性。这一性质有望产生类似肖特基二极管或p-n结的器件整流特性,减小漏电,并有机会用于设计非p-n结的光电器件。

图2 SiC(样品1)、薄的Ga2O3(样品2)和厚的Ga2O3(样品3)的XPS光谱图及对应的原子能级位置

图3 Ga2O3/SiC的能带排列示意图
4 总结
在本文中,我们通过XPS对Ga2O3/SiC异质结进行了能带排列的研究,用Kraut的计算方法得到价带偏移量为0.61 eV,导带偏移量为0.9 eV,表现为嵌套式的Ⅰ型能带排列。这表明该异质结可用于设计具有整流特性的元件,为相关Ga2O3器件的设计应用提供了一定基础。

