IGBT 模块栅氧老化机理分析与表征方法研究
魏伟伟,张 杨,徐国卿
(1.上海大学机电工程与自动化学院,上海 200444;2.国网浙江省温州市供电公司,温州 325002)
根据工业调查显示,电力电子器件被认为是电力电子系统中最易受过载影响和热应力影响的元件[1]。其中,绝缘栅双极型晶体管IGBT(insulated gate bipolar transistor)具有驱动电路简单、导通压降低、功率等级高、输入阻抗高等优点,被广泛地应用于大功率场合。由于大功率变换装置的运行工况复杂、故障影响大、运维成本高[2],因此,如何提升IG-BT 的运行可靠性,受到了国内外学术界和工业界的高度重视。
随着IGBT 功率的不断增大,受器件材料和制造工艺的限制,IGBT 的失效问题日益突出。因此,IGBT 模块的故障诊断变得越来越重要。为了提高IGBT 运行的可靠性,通常采用新材料、新结构、新工艺等设计优化和工艺改进方法。然而,现有的技术不能完全避免故障的发生,故障受到空间、效率和成本的限制。在实际运行中,IGBT 承受过电压、过电流、过热等应力,会导致IGBT 失效。目前,大多数文献集中在与封装相关的故障状态监测以及结温预测上。文献[3-4]从多物理场耦合角度分析了IGBT 模块封装主要薄弱点,通过归纳整理可得IGBT 模块封装失效机理主要为键合线失效、焊料层失效及其他原因引起的失效;Brown 等[5]研究了IGBT 闩锁故障前的影响,对IGBT 的主要失效模式进行了识别和建模,将关断时间toff作为诊断IGBT闩锁失效的故障特征变量;Patil 等[6]将阈值电压的增加作为栅氧化层退化的指标,并通过准静态电容电压QSCV(quasistatic capacitance voltage)测量验证了栅氧化层陷阱电荷的性质,但8 组实验中有6 组的阈值电压在栅氧老化前后变化极小,甚至没有变化;文献[7]对IGBT 进行了栅极加速老化实验,并提出了IGBT 开通过程中米勒平台的持续时间tgp作为判断IGBT 栅氧老化的特征量;文献[8]指出,栅氧层老化会在电介质中形成导电通路,从而引起IGBT 泄漏电流的增加;文献[9]中提出了一种基于FPGA 的先进栅极驱动器用,通过测量通态栅极电压、栅极开通电荷等物理量,实现栅氧层老化故障的诊断。由于现有技术均需要对变流器的栅极驱动进行重新设计与调整,可能会增加系统的复杂性与成本。
为深入理解IGBT 的栅氧层老化故障,本文开展了相关研究。首先对IGBT 栅氧层老化的机理进行讨论;然后,分析了IGBT 栅氧层老化故障对IG-BT 关断过程的影响,提出以关断延迟时间td(off)作为预测IGBT 栅氧老化故障的特征参数,并在Saber软件中建立IGBT 栅氧老化模型;最后,通过实验验证关断延迟时间td(off)作为IGBT 栅氧层老化特征参数的有效性。本文工作可为研发IGBT 栅氧层老化故障预诊断技术提供一定参考。
1 IGBT 芯片栅氧老化机理及表征参数分析
图1 是IGBT 功率模块内部封装结构。由图1中可以看出,IGBT 功率模块是以半导体芯片作为内核,并遵照特定结构封装起来的器件。模块主要包括铜母线、键合引线、IGBT 芯片、反并联二极管芯片、芯片下焊料层、DBC 上铜层、DBC 陶瓷基板、DBC 下铜层、DBC 下焊料层以及铜底板等部分。

图1 IGBT 模块内部封装结构Fig.1 Internal package structure of IGBT module
根据失效表现形式的差异,IGBT 功率模块的失效模式包括封装类故障和芯片类故障,二者对IGBT 模块的正常运行都非常重要。IGBT 功率模块的失效因素组成如图2 所示。IGBT 栅氧老化故障属于IGBT 芯片类故障,主要由经时击穿TDDB(time dependent dielectric breakdown)造成。
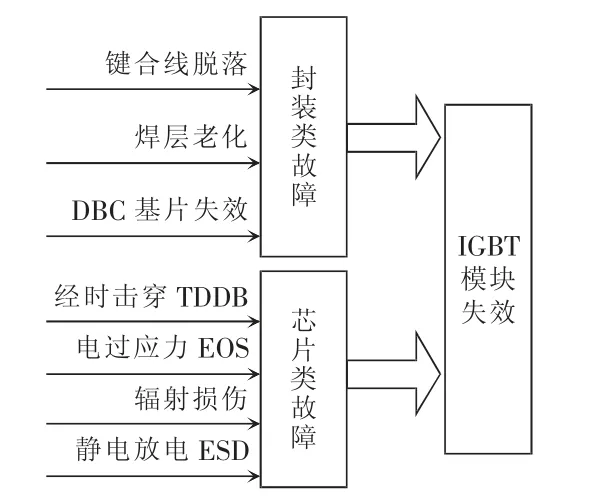
图2 IGBT 模块的失效因素组成Fig.2 Failure factors of IGBT module
1.1 IGBT 芯片栅氧老化机理分析
对于IGBT,与栅氧层失效相关的机制主要包括2 种类型:单粒子栅极击穿SEGR(single-event gate rupture)和TDDB。SEGR 很容易发生在辐照环境中,当重离子从栅极区域进入器件时,它会在栅极氧化物中产生大量的电子-空穴对,并产生栅极氧化物缺陷。这些缺陷最终会导致栅极的失效。与SEGR相比,TDDB 更为常见,是威胁器件和系统的寿命和长期工作可靠性的主要失效机制。
若栅氧化层上的电场强度大于本征击穿场强,栅氧化层立即会被击穿,这种情况称为瞬时击穿。而当加在栅氧化层上的电场强度小于本征击穿场强时,栅氧化层不会立即被击穿,而在不久后才会被击穿,这种情况称作经时击穿,即TDDB。当恒定电压施加在IGBT 内部栅氧化层,氧化物的持续老化会在其内部产生导电通路,从而使得器件失去控制并击穿短路,这一过程可以分为2 个阶段。
TDDB 是高栅压偏置应力随时间引起栅氧化层劣化的结果。栅氧化层退化是由于缺陷电荷在栅极氧化层中积累导致的。这些缺陷电荷分为固定电荷Qf、可动离子电荷Qm、界面陷阱电荷Qit和氧化层陷阱电荷Qot。Qf和Qm主要在器件制造过程中产生,随着制造工艺的改进,它们在数量上得到控制,对设备的影响可忽略不计。对于Qit和Qot,这些陷阱在栅极应力下随机产生,最近邻的陷阱形成导电集团,如图3 所示。过剩的低能级电流会流过这些导电集团,并且在陷阱密度较高的区域有较大的电流流过。当局部区域的陷阱密度达到一个临界值时,导电集团使栅极和衬底发生导通,进而形成通路,引发电容能量的破坏性放电,造成局部电介质击穿[13]。经过高强度的电流,介质会被融化或烧焦,多晶硅栅也会被热损毁,并且这些变化是不可逆的。
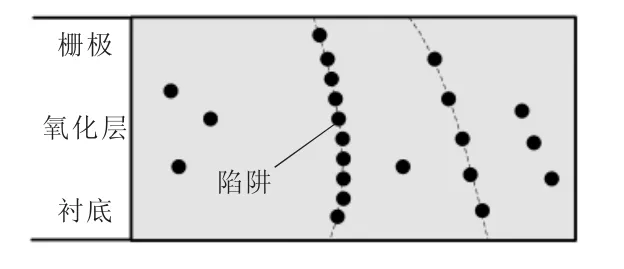
图3 近邻陷阱形成导电集团Fig.3 Conductive clusters formed by nearby traps
1.2 栅氧老化对关断延迟时间的影响
IGBT 关断过程可以分为4 个阶段,分别为栅极电压下降阶段、关断米勒平台阶段、电流下降阶段以及拖尾电流阶段,如图4 所示。

图4 感性负载时的IGBT 关断过程Fig.4 IGBT turn-off process under inductive load
关断过程中IGBT 状态分别如下。
(1)栅极电压下降阶段(t1<t<t2):在t1时刻之前,IGBT 仍保持开通状态。IGBT 关断过程起始于栅极电压UGE下降之时,该阶段栅极-发射极电容Cge和栅极-集电极电容Cgc对外放电,栅极电流Ig从栅极向栅极驱动电路反向流动,此时栅极-发射极电压UGE满足

式中:Rin为栅极回路等效输入电阻;UGH和UGL分别为驱动电压的正值和负值;Cin等效输入电容,Cin=(Cge+Cgc)。在UGE下降至米勒平台电压Ugp,off期间,集电极电流IC基本保持不变。
(2)关断米勒平台阶段(t2<t<t3):关断米勒平台阶段起始于t2时刻。该阶段仅有米勒电容Cgc对外放电,使得集电极-发射极电压UCE逐渐增加。在UGE保持在Ugp,off期间,IC仍然保持为负载电流,并逐渐临界饱和。
(3)电流下降阶段(t3<t<t4):电流下降阶段起始于t3时刻。此时UCE增长到直流母线电压UDC,续流二极管转变为导通状态。该阶段IC迅速减小,dIC/dt在母线杂散电感的作用下感生出电动势,使得UCE产生高于UDC的电压尖峰。从t3时刻开始,UGE从关断米勒平台电压Ugp,off逐渐减小。当UGE减小到栅极阈值电压UGE(th)时,MOS 沟道消失。
(4)拖尾电流阶段(t4<t<t5):拖尾电流阶段起始于t4时刻。此时UCE保持UDC不变,IGBT 完全关断。该阶段N-漂移区的过剩空穴需要依靠复合作用来缓慢消除,因此IC缓慢衰减到0。
在关断米勒平台阶段,Ig几乎完全从Cgc流过,因此UGE保持平台电压Ugp,off不变。米勒电容Cgc在此阶段内假设为一个平均值Cgc,av,此时持续时间(t3-t2)可被定义为

式中:gm为跨导;IL为负载电流。
由式(2)可知,平台持续时间tgp,off主要受到Cgc,av的影响。由于栅氧老化效应的缘故,TDDB 导致缺陷电荷Qit和Qot在栅极氧化层累积,累积的电荷增加了氧化层电容Coxd和米勒电容Cgc,进一步使得Cgc,av增大[14]。相比较于健康IGBT,该阶段内栅氧劣化的IGBT 的持续时间tgp,off更长。考虑到关断延迟时间td(off)定义为从UGE下降至其幅值的90%到IC下降至其幅值的90%的这段时间,td(off)≈tgp,off。因此该阶段内栅氧劣化的IGBT 的关断延迟时间td(off)更长。
米勒电容的大小和UCE有关,UCE越大,米勒电容越小。在关断延迟阶段UCE处于导通压降,而在开通延迟阶段UCE则处于母线电压,所以关断延迟阶段的米勒电容远大于开通延迟阶段的米勒电容,关断延迟时间也对栅氧老化更加敏感。
2 基于Saber 的栅氧老化失效仿真
2.1 栅氧老化仿真模型的建立
本文使用的IGBT 功率模块是半导体厂商In-fineon 的FF50R12RT4。该IGBT 的数据手册上只有输出特性和转移特性,但是没有给出C-V 特性曲线。因此要想得到该IGBT 精确的仿真模型,就需要利用半导体参数分析仪来详细测量FF50R12RT4模块的极间电容。
本文采用半导体参数分析仪测量FF50R12RT4的极间电容,测试平台如图5 所示,包括精密LCR测量计安捷伦E4980A、高压源表吉时利2410、高压直流电源、上位机以及探针台。测试机台型号为国产设备XR342,测试电压范围为0~1 000 V,测试频率为0.01 Hz~1 MHz,信号幅度为0.1~5 V,测试电容范围为1 pF~1 000 nF。由于IGBT 功率模块的寄生电容的数值非常小,因此在测试前首先要对测试仪器实施短路校正和断路校正。校正完成后在操作界面设置参数开始测量。测量条件如下:交流频率为1 MHz,最低偏置电压为0.1 V,最高偏置电压为600 V,交流电平为100 mV。
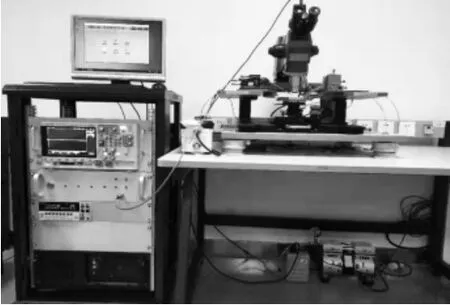
图5 半导体参数测试平台Fig.5 Semiconductor parameter test platform
实际测试过程中,测试电路可以等效为RLC串联电路。当电路达到稳态时,电压和电流满足

由于测试电路中杂散电感的数值为nH 级别,杂散电容的数值为nF 级别,故当测试频率选择MHz 级别时,式(4)中的1/ωC 约为ωL 的1 000 倍,测试结果仅着重于C。另外,考虑到Saber 软件在IGBT 实际建模中使用的并不是极间电容Cge、Cgc及Cce,而是输入电容Cies、输出电容Coes以及反向传输电容Cres[11],这3 个电容的定义表达式为

由式(5)~式(7)可知,实际测试Cies、Coes及Cres中某一个电容时,需要屏蔽一个或多个极间电容的影响。选择的测试对象不同,相应测试电路的配置与接线也有所差异。
图6 为测试Cies、Coes及Cres的连线原理。当测试输入电容Cies时,为了排除极间电容Cce的干扰,需要在C、E 端加载1 μF 的大电容,如图6(a)所示。这样1 μF 的电容与nF 级别的Cce并联的电容数值仍为1 μF 左右。之后再与nF 级别的Cgc串联,其串联结果约等于Cgc。最终测试电容即为Cgc与Cge之和。在图6(b)中,当测试输出电容Coes时,为了排除极间电容Cgc的干扰,需要在G、E 端加载1 μF 的大电容。这样1 μF 的电容与nF 级别的Cge的并联电容仍为1 μF 左右。之后再与nF 级别的Cgc串联,其串联结果约等于Cgc。最终测试电容即为Cgc与Cce之和。在图6(c)中,当测试反向传输电容Cres时,为了排除极间电容Cge和Cce的干扰,需要在G 端和交流电源负端加载1 μF 的大电容。这样1 μF 的电容与nF 级别的Cgc的串联结果约等于Cgc。最终测试电容即可视作Cgc。
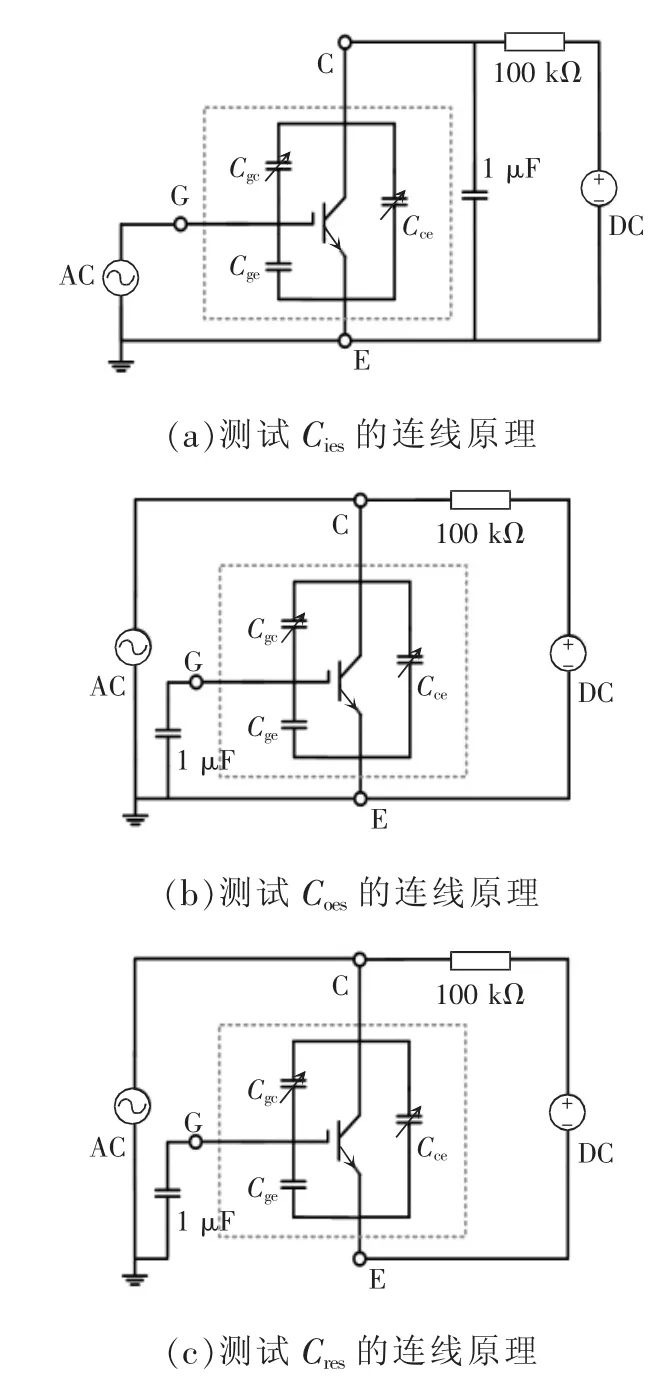
图6 测试电路连线原理Fig.6 Schematic of wiring in test circuits
本文以拟合转移特性为例来对IGBT 进行建模分析,将FF50R12RT4 的转移特性曲线、输出特性曲线、极间电容曲线以及拖尾电流特性曲线导入到Saber 软件中,完成对特定IGBT 功率模块的建模过程。
建好FF50R12RT4 的行为模型后,需要对模型的可行性进行验证。因此,通过分析模型的开关动态特性并将其与器件数据手册上提供的开关参数进行对比,从而验证模型的可行性。
仿真模型开关参数与数据手册数据对比如表1 所示。从表1 可以看出,尽管模型仿真得到的数据和数据手册上的开关参数存在一定的差别。但Saber 中仿真电路和半导体厂商的实际测试电路存在差异,考虑到仿真结果的数量级,可以认为搭建的模型是可靠的。
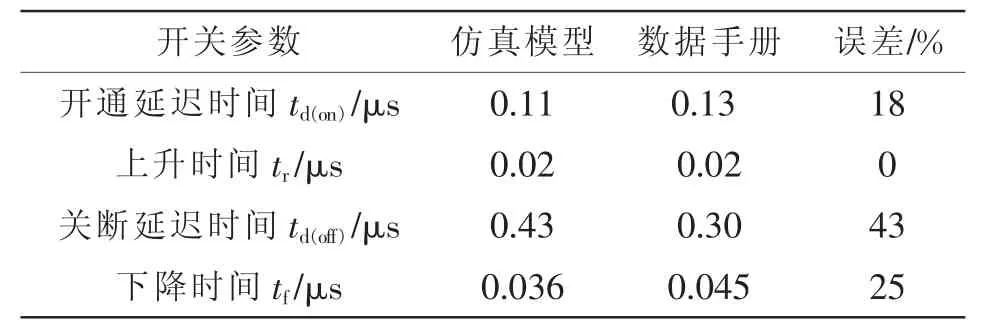
表1 仿真模型开关参数与数据手册数据对比Tab.1 Comparison between switch parameters of simulation model and the corresponding values in datasheet
2.2 关断延迟时间表征栅氧老化失效仿真
本文使用第2.1 节搭建的模型,在Saber Sketch中建立带感性负载的双脉冲测试电路,如图7 所示为Saber 仿真原理,仿真中忽略了电路中的寄生电感等参数。其中,仿真参数设置如下:Vdc=600 V,RG=15 Ω,VGE=±15 V,IC=50 A,L=4 mH。
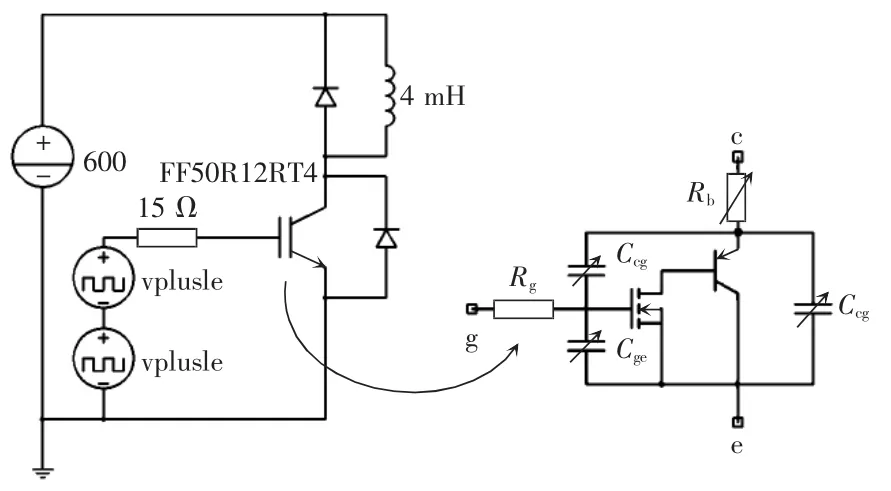
图7 带感性负载的双脉冲测试仿真电路Fig.7 Dual pulse test simulation circuit with inductive load
图8 为健康IGBT 仿真模型以及模拟栅氧老化(经过75 V 高栅压应力作用18 h)后IGBT 仿真模型在关断过程中的暂态波形。从图8(a)可以看出,关断平台持续时间随着栅极氧化层的疲劳老化而延长。另外,在UGE逐渐减小至阈值电压以下时,此时Cge对栅极放电占主导作用。随着栅极氧化层的疲劳老化,Cge逐步减小,栅极电压下降速度反而加快。图8(b)为栅氧老化失效仿真模型的关断暂态集电极电流波形,可以看出,栅氧老化后IGBT 集电极电流仿真波形的下降时刻延迟了,而下降速度几乎没有变化。
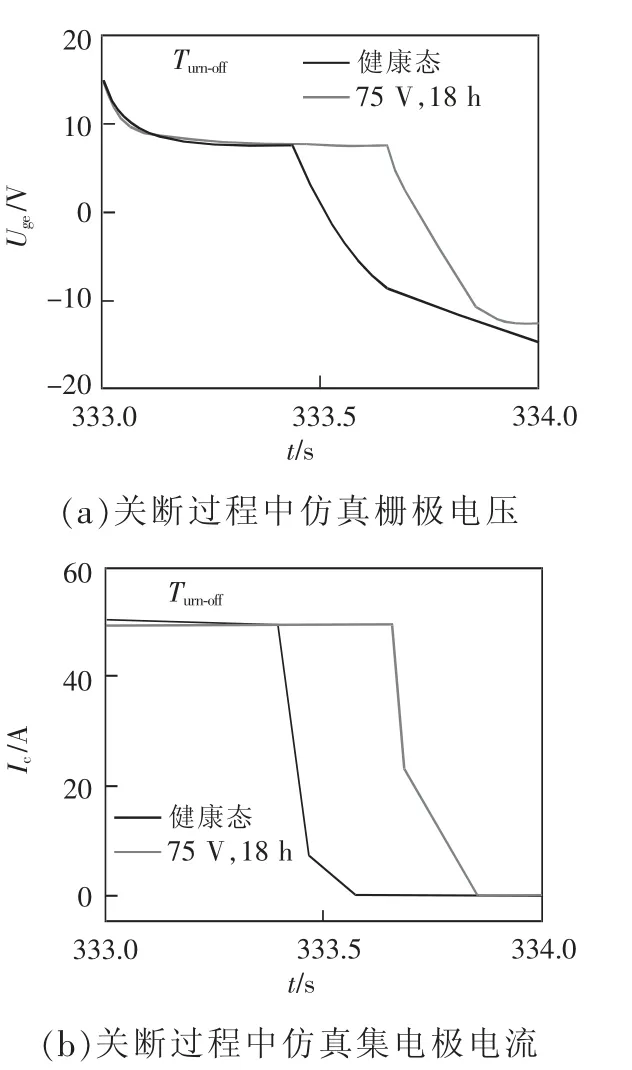
图8 仿真模型的关断过程暂态波形Fig.8 Transient waveforms in turn-off process of simulation model
从仿真结果中分别提取健康状态下以及经过75 V 高栅压应力作用18 h 后的关断延迟时间,并计算特征参数表征栅氧老化失效的灵敏度,健康的IGBT 模块td(off)为0.43 μs 而老化过后的IGBT 模块td(off)为0.56 μs,灵敏度约为30.2%。td(off)在IGBT 栅氧老化前后数值变化显著,因此关断延迟时间td(off)适合用于表征IGBT 栅氧老化失效。
3 栅氧老化失效的特征参量实验验证
3.1 验证实验设计
为了实验验证IGBT 栅氧老化特性,加速老化测试方法[7,12]和双脉冲测试方法应用于单相全桥逆变器中的IGBT 模块。通过施加高栅压偏置应力的方式使IGBT 栅氧化层发生不同程度的老化,再通过双脉冲实验获得IGBT 芯片不同栅氧老化程度的IGBT 模块的开关暂态波形。图9 为检测平台的实物。

图9 检测平台实物Fig.9 Physical picture of detection platform
本文采取加速老化实验,模拟IGBT 芯片栅氧老化。在室温(25 ℃)条件下,将75 V 正电压偏差施加在待测IGBT 的栅极-发射极两端,同时集电极、发射极及衬底接地。加速老化实验持续28 h,其中周期性地停止施加应力,并测量器件特性的变化。在75 V 的电压等级下,每隔1 h 将待测IGBT放到双脉冲测试平台上进行测试。用示波器记录下待测IGBT 运行过程中UGE、UCE和IC的波形。为避免偶然因素造成实验结果干扰,相同条件下对每个IGBT 做3 次双脉冲实验。
3.2 实验结果分析
图10 为在加速老化实验中不同老化阶段关断过程栅极电压和集电极电流波形。在关断过程中,IGBT FF50R12RT4 的米勒平台偏移如图10(a)所示,关断暂态米勒平台的持续时间随着老化程度增大而延长。图10(b)为加速老化实验中不同老化阶段内关断暂态集电极电流波形,在关断过程中,随着老化时间的增长,IGBT FF50R12RT4 的集电极电流下降速度略有加快。实验结果与双脉冲仿真测试结果基本一致。这不仅验证了TDDB 老化对IGBT 功率模块内寄生电容的影响,同时验证了内部寄生电容变化对IGBT 外部开关特性的影响。
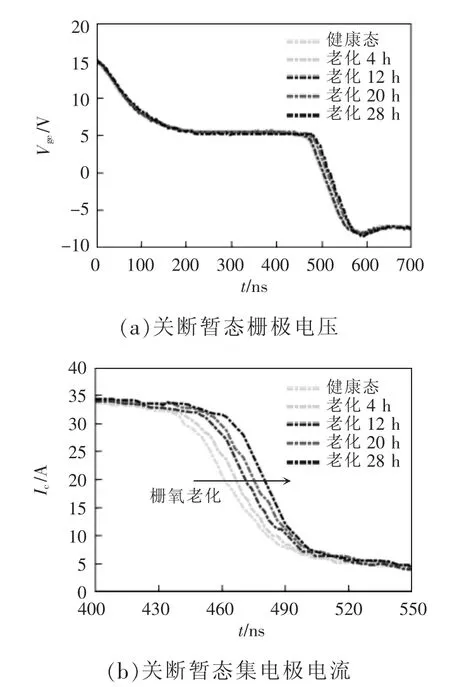
图10 不同老化阶段内关断暂态波形Fig.10 Turn-off transient waveforms at different degradation stages
IGBT 的开关特性参数不仅与栅氧老化有关,还与其工作结温有关,图11 反映了FF50R12RT4 在600 V 集射极电压下,不同老化程度和不同结温对关断延迟时间的影响。其中,集电极电流Ic在双脉冲实验中通过改变第一个脉冲的开通时间来调节。
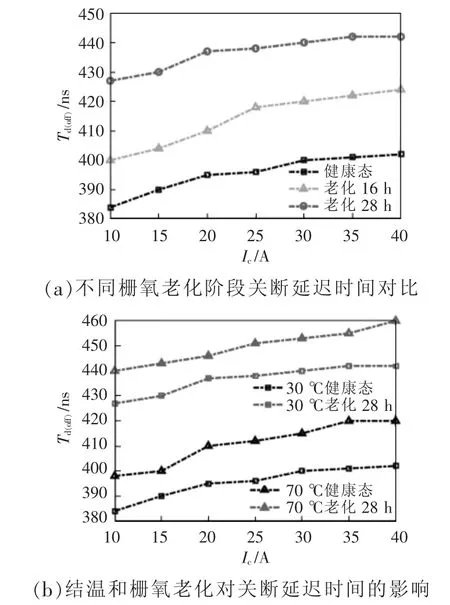
图11 不同老化程度和不同结温的关断延迟时间Fig.11 td (off) with different degradation degrees and different junction temperatures
由图11(a)可以看出,在不同的集电极电流下,td(off)会随着栅氧老化程度的增加而变长。经过16 h栅氧层加速老化的IGBT 模块比健康IGBT 模块关断延迟时间要长20 ns 左右,而经过28 h 栅氧层加速老化的IGBT 模块比健康IGBT 模块关断延迟时间要长40 ns 左右。经过计算,健康状态下td(off)作为栅氧老化程度特征参数的灵敏度达到10.3%,因此,关断延迟时间可以有效地反映IGBT 栅氧老化程度,并且具有易检测、灵敏度高等优点。
由图11(b)可以看出,不同的结温也会对IGBT模块的关断延迟时间造成影响,且和栅氧老化的影响存在重合区域。所以在检测IGBT 栅氧老化时必须同时检测结温,反之在检测结温的同时也必须检测IGBT 栅氧老化的程度,否则便无法准确地判断IGBT 的栅氧老化程度和结温,该结论也同样适用于其他老化特征参数以及热敏参数。
4 结语
近年来,大容量电力电子器件在众多领域得到了快速的发展,针对IGBT 模块的可靠性研究的需求,本文进行了基于关断延迟时间的IGBT 栅氧老化机理分析和状态表征方法研究。本文分析了IGBT栅氧层老化故障的相关机理,当IGBT 发生栅氧老化,其内部的寄生电容也会发生变化,进而引起IG-BT 开关参数的变化,并提出关断延迟时间td(off)作为预测IGBT 栅氧老化故障的特征参数;对指定IGBT模块栅氧老化过后的C-V 特性进行测量,设计了IGBT 栅氧老化的Saber 仿真模型,从仿真验证了使用td(off)作为预测IGBT 栅氧老化故障的特征参数的可行性;通过实验验证了关断延迟时间可以有效地反映IGBT 栅氧老化程度,并且具有易检测、灵敏度高等优点,并验证了结温和栅氧老化对td(off)的影响,提出在线监测的建议。本研究可为进一步研发IGBT 在线栅氧老化故障预诊断以及IGBT 在线可靠性状态监测提供参考。

