等离子体制备纳米氮化钨薄膜的研究现状
何 革
(成都大学机械工程学院 四川 成都 610106)
0 引言
纳米材料,通常是指在纳米尺度(0.1~100 nm)的三维空间中至少有一个维度的材料,或以它们为基本单位组成的材料。它的性能不同于传统材料,其特殊性在许多领域发挥着重要作用[1-3]。
纳米技术是目前国内外表面有效强化的热点之一,常见的表面沉积或涂层纳米技术包括表面沉积技术(物理气相沉积、电解沉积和化学气相沉积)、表面自纳米化技术(机械加工方法和热力学方法)和混合纳米技术(表面涂层技术)。在表面沉积或涂层技术中,纳米层与基体之间存在明显的界面[4]。
等离子体是由带电粒子(正离子、负离子及电子)和各种中性粒子(分子、原子、自由基及活性基团)组成的集合体,其中正负电荷数相同,宏观上呈现电中性,是“物质的第四态”,如图1所示。
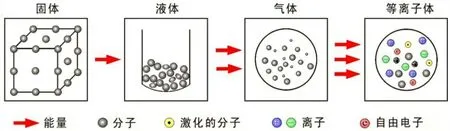
图1 等离子体示意图
由于等离子体中富含电子及离子,因此它实际上是一种导电流体。
等离子体表面处理技术的出现不仅改善了产品性能,提高了生产效率,更重要的是实现了安全环保效果。所以,用等离子体表面处理技术与纳米技术相结合成为近年来研究的热点。
厚度小于1 μm的膜材料,称为薄膜材料。薄膜材料诸多性能如抗腐蚀性、气孔率、成膜厚度的均匀性和附着能力是衡量薄膜好坏的重要指标。过渡金属氮化物(如氮化钨、氮化钼等)因其具有类似于铂族贵金属的催化性能而得到广泛研究。其中氮化钨(WNx)薄膜还具有重要的特性,如高熔点、高导电性、更好的硬度和化学惰性。氮化钨薄膜的这些特性使其成为一种有前途的材料,可用于切削工具上的硬质保护涂层、微电子器件中的扩散屏障。由于氮的掺入,过渡金属氮化物与原始金属相比具有显著改变的化学和物理性质,在过去十年中,人们通过不同方法制备高表面积形式的上述材料。
1 研究现状及发展
传统物理气相沉积(PVD)技术制造的硬涂层,由于附着力较弱和多孔微结构降低了耐腐蚀性,因此薄膜质量较差。而相对发展起来的一些制备技术,如原子层沉积(ALD)、等离子体增强化学气相沉积(PECVD)都相应克服了PVD的一些缺点而逐渐应用于薄膜制备领域。
Nakajima等[5]证明了第一个通过CVD(化学气相沉积)生长氮化钨的案例。这包括400~700 ℃之间WF6、NH3和H2的LPCVD(低压化学气相沉积)反应中立方W2N的增长。与WCl6相比,WF6具有两个明显的优点:(Ⅰ)17.5 ℃的低熔点(即较高的挥发性)和(Ⅱ)较低的还原温度(约300 ℃)。H2的加入对氮化物的形成至关重要,其中WF6和NH3的单独反应产生黄棕色粉末化合物WF6·4NH3,H2的添加也有助于氟的提取。
随着温度升高,薄膜呈现出不同的择优生长。450 ℃时薄膜优先在(200)平面生长。在550 ℃时薄膜优先在(111)平面生长。表面形态也随着温度变为450℃时,薄膜由小而圆的颗粒组成。600 ℃时,颗粒尺寸增大,形状由圆转变为方形。700 ℃时形成了折叠带状结构。薄膜被少量氧化物污染。氮主要以N-3和一些N0的形式滞留在间隙部位。
Nagai 等[6]对的LPCVD(5~13 Pa)反应进行了动力学研究。对具有复杂几何形状(2.2 μm深和1.0~1.9 μm宽)的基板进行涂层,以便评估黏附概率。515 ℃以下膜为非晶态。515 ℃以上,W2N是在(100)面优先生长形成的。790 ℃时在(200)平面上观察到一种优先生长,并在(220)、(311)和(222)平面上有一些附加生长。280 ℃~530 ℃之间这些薄膜显示出金属光泽,530 ℃以上金属光泽消失了。W:N比率始终一致且≈0.6(即W2N1.2)。
Schmid等[7]研究氮在钨中的积累与注入能量、能量密度和温度的关系,氮对钨的溅射与能量关系与注入过程中氮化物相的形成有关,发现注入范围内的氮浓度达到氮化钨的化学计量比(50%氮),钨表面的氮含量迅速饱和。在高温下进行注入表明,WN在约600 K以上变得不稳定。与用氖或氩等惰性气体的注入进行对比,氮的注入对钨侵蚀较低。
Vasile Tiron等[8]发现将获得的涂层暴露于低压氘等离子体射流,在研究氮注入过程中,使用钨作为第一壁材料的聚变装置中可能形成再沉积WNx层的氘保留。并发现与传统的磁控溅射工艺相比,在HiPIMS(高能脉冲磁控溅射)中,反应气体和溅射原子的高电离度和高能量能够精细地控制沉积涂层的化学组成、相组成、微结构和形态。因此,通过改变溅射气体中的氮含量,可以获得具有不同化学和相组成、微结构和形貌的多晶WNx薄膜。
Tulenbergenov等[9]发现钨氮化的方式(即辉光放电),可用于研究等离子体和热影响对钨氮化表面的影响(在氮化钨上形成钨“绒毛”,氮化钨的溅射)。该方法可使钨的氮化深度不小于75 μm:等离子体支持的氮(70%)和氢(30%)的混合气体成分,环境压力4托,离子能量约630 eV,离子流量约1 022 cm-2。
Ikhlaq等[10]研究了氩气浓度对100 Hz脉冲直流辉光放电生长纳米结构氮化物层的影响,证实了纳米结构氮化钼层的生成,并发现当样品在30%氩含量的氮-氩混合等离子体中处理时,表面硬度显著增加(大约两倍)。
Jauberteau等[11]研究了膨胀微波等离子体中钼膜的氮化过程(氮化钼的晶体结构),意外发现β-Mo2N和γ-Mo2N相分别在[204]和[220]结晶方向上强烈取向的形成。
Doerner等[12]使用氦和钨同位素研究了钨和氦原子在钨“绒毛”形成过程中的运动,发现钨原子从钨块样品向“绒毛”表面的混合。
Klaus等[13]展示了在33 Pa时WF6和NH3在325 ℃和525 ℃之间反应产生立方W2N的ALD生长。每个周期的增长率为2.5°A。薄膜非常光滑(RMS=4.8°A),薄膜含氮比例小,W:N比例约为 3:1。薄膜含有少量的碳(≈5 at.%)和氧(≈3.6 at.%)杂质。WF6和NH3反应中观察到WFx*和 NHy*物种之间的转换。
Kim等[14]的氮化钨是在200~350 ℃之间从WF6、NH3和B2H6的ALD(原子层沉积)中生长出来的,B2H6被用作一种额外的还原剂,以制备电阻率在300到410 μΩcm之间的一种取决于生长条件的低电阻率薄膜。在275 ℃以上,生长速率随温度的增加而增加,最高为每周期0.28 nm,温度和B2H6流量的增加导致:(I)W:N比增加,(Ⅱ)膜密度增加,(Ⅲ)杂质减少;所有这些都有助于降低电阻率。增加的钨氮比有利于形成W2N的FCC相。在0.14 μm内获得覆盖率宽的孔,长宽比为16:1。
Sun等[15]在275 ℃时,随NH3流量减少制备出了W:N范围为2.2~2.9的氮化钨。氮含量随温度升高而升高。碳污染的平均水平在275 ℃时≈15%,在450 ℃时减少到≈5%,在大多数情况下,氧气污染水平低于12%并且在较高温度下降低。相反,电阻率从376 ℃开始随着温度的升高而增加,到450 ℃时观察到W2N有序结晶。
2 传统氮化钨薄膜制备方法
2.1 低压化学气相沉积(LPCVD)
LPCVD沉积系统通常在0.1~10托的压力下操作。LPCVD薄膜工艺中使用的反应器配置包括电阻加热管热壁反应器、垂直流间歇反应器和单晶片反应器。由于其晶片处理、有效的粒子和工艺控制以及工艺集成的优点,大量现代制造厂已经转移到使用单晶片集群工具来满足CVD和其他处理要求。
该方法可生产沉积金属膜、非金属膜和多元合金膜。通过调节各种气体原料流量,可以在相应范围内控制产物的成分,因此可以制备梯度薄膜和多层单晶薄膜,并根据成分、膜厚和界面匹配的要求实现多层薄膜的微组装。其工作条件为常压或低真空,因此涂层的衍射性好,可以均匀涂覆形状复杂的工件,比PVD优越得多。
2.2 原子层沉积(ALD)
原子层沉积(ALD)已逐渐成为沉积功能薄膜的重要技术。该技术可以精确地控制纳米尺度上物质的组成和形态,并且可以将沉积的物质以单原子膜的形式逐层地镀在衬底表面。原子层沉积过程是通过连续的自限反应实现。在沉积反应过程中,反应的气相前驱体交替通过并由活性官能团在基底表面形成单层化学吸附,从而完成反应。
经过这种交替循环反应,薄膜将在纳米级上以可控厚度生长。具有沉积大面积均匀薄膜、纳米级可控薄膜厚度生长、低温沉积、可生成极好的三维保形性化学计量薄膜和可适应于不同形状基底等优点。
2.3 等离子体增强化学气相沉积(PECVD)
PECVD通过微波或射频电离目标气体,在局部形成具有强化学活性的等离子体,并利用等离子体活性在较低温度下促进化学反应,从而在衬底上沉积所需的薄膜。这种CVD称为等离子体增强化学气相沉积(PECVD),因为它依赖于等离子体的活性。
PECVD的主要优点是:低沉积温度对基体的结构和物理性能影响不大;成分均匀性和膜厚较好;针孔少,膜结构紧凑;漆膜的附着力强;同时用于制备各种金属、无机和有机膜。
总之,薄膜沉积工艺正在迅速发展,并被广泛应用于不同领域。各种方法被用于形成具有不同应用所需特性的薄膜。在不同的方法中,等离子体辅助方法因其广泛的能量密度和可调控功能而成为有希望的薄膜制备方法。一方面,通过这种方法制备的薄膜具有更高的表面质量,由于其宽的离子能谱,对基材表面具有良好的附着力。另一方面,使用其他技术形成薄膜需要更长的沉积时间和高温环境,这也使得等离子体辅助制备技术成为了更好选择。
3 展望
综上所述,等离子体辅助制备薄膜的方法相较于其他传统制备方法拥有较为明显的优势,但国内外在等离子体制备纳米氮化钨及其制备过程中相关反应的研究还处于厚度、尺寸、氮钨比和结晶方向等初期阶段,仍有很多相关方面有待研究和探索。由于纳米材料与其技术和等离子体制备技术受到越来越多的重视,相应的一些理论研究如反应过程中物种的转变、成形的机理也会对氮化钨薄膜的性能提升起到一定作用,使其有望在一些极端条件下如聚变装置第一壁的涂层材料或军工行业中使用。

