重离子导致的锗硅异质结双极晶体管单粒子效应电荷收集三维数值模拟*
张晋新 郭红霞 郭旗 文林 崔江维席善斌 王信 邓伟
1)(中国科学院新疆理化技术研究所,乌鲁木齐 830011)
2)(新疆电子信息材料与器件重点实验室,乌鲁木齐 830011)
3)(西北核技术研究所,西安710024)
4)(中国科学院大学,北京100049)
(2012年8月17日收到;2012年9月20日收到修改稿)
1 引言
近年来,我国在航天领域发展迅猛,对器件在极端环境中的应用,特别是辐射、低温环境中的应用需求迫切.空间极端环境下,如极低温−180°C至高温+125°C,SiGe器件在卫星、深空探测设备中具有替代目前体硅器件的潜力,可以去掉体硅器件携带的庞大的保温装置,进而降低发射成本,同时扩展卫星的远程功能.卓越的低温特性使SiGe技术在空间极端环境应用方面备受关注[1].
美国国家航空航天局(NASA)早在十年前就开始关注太空中极端环境下电子系统的应用问题[2−6],相关报告指出由于硅基能带工程的材料和器件结构的优势,锗硅异质结双极晶体管(SiGe HBT)具有卓越的低温特性和优异的抗总剂量辐照性能,在太空极端环境领域具有诱人的应用前景[7,8].目前国外针对SiGe HBT的单粒子损伤效应已展开了一定的研究[9−15],研究结果表明,单粒子效应是制约SiGe HBT空间应用的关键因素.SiGe HBT由于工艺和结构等新的特征,对单粒子效应非常敏感,其单粒子效应表现出不同于体硅器件的复杂的电荷收集机制.国内对SiGe HBT的研究起步较晚,关于SiGe HBT单粒子效应研究的相关报道较少.
本文针对国产工艺制造的SiGe HBT器件进行了单粒子效应三维数值仿真模拟,以国产器件的工艺与结构为基础,探讨重离子在不同位置入射器件时不同区域的电流变化,以及感生电荷收集的情况,通过分析器件结构和仿真结果来确定电荷收集的敏感区域,为进一步探讨国产SiGe HBT单粒子效应的加固技术提供支持.
2 器件结构描述
本文选用国产SiGe HBT作为研究对象.仿真模拟的SiGe HBT与传统体硅npn垂直型双极晶体管结构类似[16−22],如图1所示.关键是基区,由组分渐变的SiGe构成,基区中Ge的引入在发射极/基极结(E/B结)和基极/集电极结(B/C结)处形成了缓变异质结,如图2所示,基区内形成的内建电场有效提高了载流子在基区的渡越时间;电流增益随着引入Ge后的带隙变化量∆Eg指数增加,如下式所示:

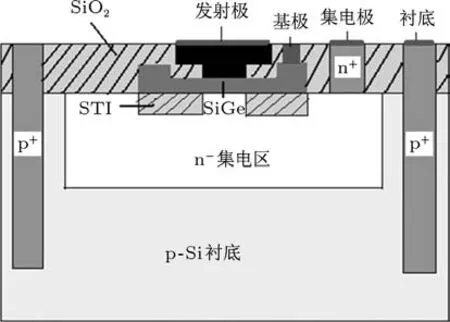
图1 国产SiGe HBT结构示意图

图2 SiGe HBT的能带图
其中,hfe为电流增益,Ne为发射区浓度,Nb基区浓度,Vnb为基区电子速度,Vpe为发射区空穴速度,∆Eg为带隙变化量,k为玻尔兹曼常数,T为温度.器件的基区厚度薄,约为0.08µm,掺杂浓度高,可达1019cm−3,有效减小了基区电阻,使器件同时满足频率高,增益大的要求.在基区外部集电极内采用浅槽隔离(STI)形成有源区,隔离氧化层上采用双多晶硅自对准工艺外延一层多晶硅掺硼掺锗引出基区接触,重掺外延基区可以降低基区电阻和BC结电阻;n+埋层引出集电区接触;发射区使用多晶硅制造,在顶部引出发射区接触.器件的四个发射区和五个基区接触采用叉指工艺.在接近器件边缘处,采用离子注入工艺注入硼离子并推进,形成环状重掺p型隔离墙,引出衬底接触,封装时和发射极连在一起仅留3个可接管脚.
3 三维器件数值模拟仿真
3.1 结构仿真
根据上述器件工艺和布局信息,使用半导体三维器件模拟工具构建器件模型.图3是器件外部结构三维仿真视图,图4是器件内部结构和杂质分布二维仿真剖面图.

图3 器件外部结构三维仿真视图
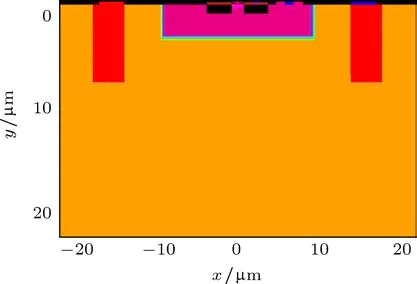
图4 器件内部结构仿真剖面图
仿真模拟的物理模型选择了Philips统一迁移率模型、SRH复合模型、Auger复合模型、速率饱和模型和禁带变窄模型.Philips统一迁移率模型可精确模拟双极器件中多子和少子的迁移率;SRH复合模型和Auger复合模型可以很好模拟高电场下电子和空穴浓度较高的情况.将仿真计算的Gummel特性和输出特性与使用半导体参数测试仪KETHLEY4200测试得到的Gummel特性和输出特性进行对比,结果如图5和图6所示,可以看出,二者符合得较好.

图5 仿真与测试的器件Gummel特性
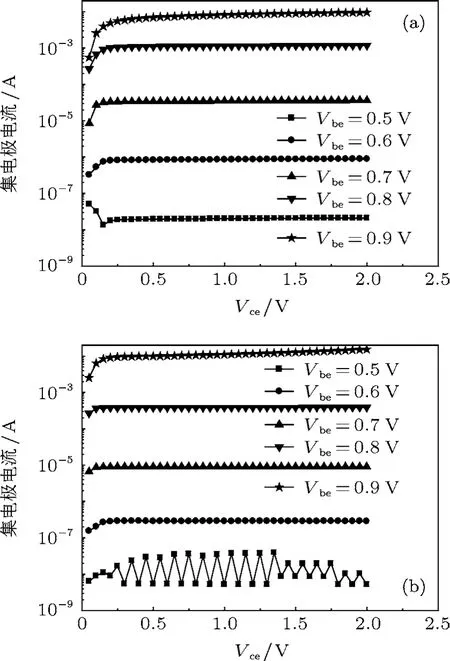
图6 输出特性曲线 (a)仿真计算的输出特性曲线;(b)实验测得的输出特性曲线
3.2 单粒子效应三维数值模拟
仿真模拟重离子入射时选择衬底接−5 V,其他端口接地(即0 V)的偏置,实现SiGe HBT的最劣偏置.假设电荷沉积穿过整个仿真结构,因此选择电荷沉积量为0.1 pC/µm,相当于线性能量传递值为10 MeV·cm2/mg,使用高斯波形,1/e特征时间范围是2 ps,1/e特征半径是0.2µm,高斯峰值是2 ps.图7(a)—(f)分别给出了离子入射器件后不同时刻等势线的变化.离子入射器件后,沿离子径迹产生大量电子空穴对,离子穿过耗尽层时,注入的大量载流子使沿离子径迹的电势发生畸变,其等势线沿着离子径迹向衬底形成漏斗势.漏斗区域内的载流子在漏斗电场的作用下很快漂移到电极而被收集,使瞬间收集的电荷远远多于沉积在耗尽层的电荷.漏斗效应消失后在浓度梯度的作用下电荷还会通过扩散机制进一步被收集.因此,各端口的瞬态电流波形和总的电荷收集量是我们研究SiGe HBT单粒子效应重点关注的两方面.如图7,3 ps时漏斗势开始产生,5 ps时漏斗势最强,40 ps时漏斗势开始衰弱,21 ns时电势恢复到离子入射前的状态.
3.3 不同入射位置单粒子效应敏感性分析
敏感区域可通过分析器件结构和不同位置下离子入射的仿真结果获得,每个端口的电荷收集量与离子入射位置密切相关.本文根据离子在器件中穿过不同区域、不同材料和不同结从器件中心向右选取7个典型的离子入射位置,这个过程中只改变x轴的入射点,z轴入射点位于中心不变,y轴穿过整个器件,如图8所示.具体为:1)离子从x=0µm器件中心处入射,穿过发射区、基区、集电区和衬底;2)离子从x=0.7µm氧化层处入射,穿过氧化层、基区、集电区和衬底;3)离子从x=2.3µm外延基区处入射,穿过外延基区、隔离氧化层、集电区和衬底;4)离子从x=6.3µm集电区电极接触处入射,穿过集电区和衬底;5)离子从x=8.5µm氧化层处入射,穿过氧化层、集电区和衬底;6)离子从x=11.5µm氧化层处入射,只穿过轻掺杂衬底;7)离子从x=15.5µm衬底电极接触处入射,穿过重掺杂衬底、轻掺杂衬底.
图 9—12分别给出离子从 x=0,x=2.3,x=11.5和x=15.5µm处入射器件时各电极的电流和电荷收集随时间的变化关系.可以看出,集电极和发射极以收集电子为主,基极和衬底以收集空穴为主.表1给出不同电极在不同离子入射位置下最终收集的电荷总量.

图7 离子入射器件后不同时刻电势的变化 (a)1 ps;(b)3 ps;(c)5 ps;(d)40 ps;(e)380 ps;(f)21 ns

图8 离子垂直入射器件位置的选择
图9 (a)表明离子从器件中心入射,依次穿过发射区、基区、集电区和衬底,同时穿过B/C结和C/S结.各端口在载流子的漂移作用下产生一个大的电流脉冲,电流峰值达到2 mA以上;扩散机制收集的电荷导致集电极和衬底电流在漂移电流波峰后出现一个较为平缓的波峰.图9(b)说明处于反偏的大面积CS结使集电极和衬底收集了大量电荷.
离子于x=6.3µm和x=8.5µm处入射的电流变化和电荷收集情况与图10离子于x=2.3µm处入射的情况相似.图10(a)说明入射离子没有穿过发射区、基区和BC结,基极和发射极没有电流脉冲发生;离子穿过反偏CS结,集电极和衬底的电流波形包括一个漏斗效应引起的大波峰和一个扩散机制形成的平缓波峰.图10(b)说明在反偏pn结的作用下集电极和衬底收集了约4.5 pC的电荷.
离子从x=11.5µm处和x=15.5µm处入射,没有穿过CS结形成漏斗势,电荷只通过扩散机制被收集,因此集电极和衬底的电流波形只有一个波峰,如图11(a)和图12(a)所示.对比图11(b)和图12(b)发现离子于x=15.5µm衬底接触处入射时收集的电荷少,饱和速度慢,原因是衬底接触引出处掺杂浓度高,载流子复合快,通过扩散机制收集的电荷大量减少.结合上述内容和表1可以得出器件不同端口对电荷收集的敏感区域.
1)发射极收集的电荷比其他端口收集的电荷小几个数量级,可以忽略不计.

图9 离子从x=0µm处入射时仿真结果 (a)各端电流随时间的变化关系;(b)各端总电荷收集量随时间的变化关系

图10 离子从x=2.3µm处入射时仿真结果 (a)各端电流随时间的变化关系;(b)各端总电荷收集量随时间的变化关系

图11 离子从x=11.5µm处入射时仿真结果 (a)各端电流随时间的变化关系;(b)各端总电荷收集量随时间的变化关系

图12 离子从x=15.5µm处入射时仿真结果 (a)各端电流随时间的变化关系;(b)各端总电荷收集量随时间的变化关系

表1 不同电极在不同离子入射位置下最终收集的电荷总量
2)对比表1中基极收集的电荷发现,离子从x=0µm和x=0.7µm处入射时基极收集的电荷量远多于其他位置入射时基极收集的电荷量,说明STI内的区域是基极收集电荷的敏感区域;STI外的区域,受氧化层的限制,电荷难以通过扩散机制被基区收集,对基区的电荷收集不敏感.
3)对比表1中不同位置集电极和衬底收集的电荷发现,这两个端口收集的电荷总量很大,不同位置收集的电荷数几乎相同.原因是CS结形成了一个面积较大的反偏pn+结,衬底−5 V的反向偏置产生一个电场为E的耗尽层.当离子穿过耗尽层时,高浓度的载流子使电场发生畸变,其等势线向着径迹衬底方向延伸形成漏斗形,经受电场作用的离子径迹由此被扩展,在该区域的载流子受到漏斗电场作用很快分离漂移到电极被收集.另一方面沿径迹径向载流子浓度梯度变化,引起漏斗电场以远和漏斗边缘的载流子进行扩散运动,扩散到耗尽层被收集.因此CS结内的区域为集电极和衬底收集电荷的敏感区域.
4)国产SiGe HBT没有国外器件中的深沟隔离结构,不能有效隔离通过扩散收集的电荷.表1表明,离子在x=11.5µm处入射器件时,集电极和衬底收集的电荷略多于其他位置入射时收集的电荷.离子从x=11.5µm处入射只穿过轻掺杂衬底,载流子复合慢,寿命长,电荷通过长时间的扩散被大量收集.离子从x=15.5µm处入射穿过重掺衬底,载流子迅速复合,集电极和衬底收集的电荷量少于其他位置入射的情况.说明CS结附近轻掺杂衬底区域对集电极和衬底的电荷收集也具有敏感性.
综上所述,发射极收集的电荷可以忽略;基极收集电荷的敏感区域是基区下STI内的区域;集电极和衬底在CS结内及其附近的区域对电荷收集较为敏感.
4 结论
仿真结果表明,SiGe HBT对单粒子效应较为敏感,在离子入射下发射区和集电区收集电子电荷,基区和衬底收集空穴电荷.处于反偏的CS结增强了漏斗效应,使集电极和衬底收集了大量电荷;离子在靠近集电区附近入射轻掺杂衬底,载流子复合慢,扩散至CS结内,衬底和集电极在扩散机制下收集大量电荷,因此CS结内及其附近的区域是集电极和衬底收集电荷的敏感区域.基极收集电荷的敏感区域位于STI内.发射极收集的电荷可以忽略.本文为研究国产SiGe HBT单粒子效应敏感性,并进一步提出加固方案打下了基础.
衷心感谢清华大学微电子所在合作中提供的技术帮助.
[1]Cressler JD 1998 IEEE Trans.Microw.Theory Tech.46 572
[2]Cressler J D 2005 Proc.IEEE 93 1559
[3]Yang H D,Yu Q,Wang X Z,Li J C,Ning N,Yang M H 2010 Acta Phys.Sin.59 5743(in Chinese)[杨洪东,于奇,王向展,李竞春,宁宁,杨谟华2010物理学报59 5743]
[4]Diestelhorst R M 2009 M.S.Dissertation(Georgia:Georgia Institute of Technology)
[5]Appaswamy A 2010 Ph.D.Dissertation(Georgia:Georgia Institute of Technology)
[6]Zhao X,Zhang WR,Jin D Y,Fu Q,Chen L,Xie H Y,Zhang Y J2012 Acta Phys.Sin.61 134401(in Chinese)[赵昕,张万荣,金冬月,付强,陈亮,谢红云,张瑜洁2012物理学报61 134401]
[7]Chen T B,Sutton A K,Bellini M,Haugerud B M,Comeau J P,Liang Q Q,Cressler J D,Cai J,Ning T H,Marshall P W,Marshall C J 2005 IEEE Trans.Nucl.Sci.52 2353
[8]Niu Z H,Guo Q,Ren D Y,Liu G,Gao S 2006 Chin.J.Semiconduct.27 1068(in Chinese)[牛振红,郭旗,任迪远,刘刚,高嵩2006半导体学报27 1068]
[9]Yang H 2005 M.S.Dissertation(Alabama:Auburn University)
[10]Varadharajaperumal M 2010 Ph.D.Dissertation(Alabama:Auburn University)
[11]Niu G F,Yang H,Varadharajaperumal M,Shi Y,Cressler J D,Krithivasan R,Marshall P W,Reed R A 2005 IEEE Trans.Nucl.Sci.52 2153
[12]Pellish J A 2008 Ph.D.Dissertation(Tennessee:Vanderbilt University)
[13]Varadharajaperumal M,Niu G F,Krithivasan R,Cressler J D,Reed R A,Marshall P W,Vizkelethy G,Dodd P E,Joseph A J 2003 IEEE Trans.Nucl.Sci.50 2191
[14]Varadharajaperumal M,Niu G F,Wei X Y,Zhang T,Cressler JD,Reed R A,Marshall P W 2007 IEEE Trans.Nucl.Sci.54 2330
[15]Zhang T 2009 M.S.Dissertation(Alabama:Auburn University)
[16]Shi Y 2005 Ph.D.Dissertation(Alabama:Auburn University)
[17]Pratapgarhwala M M 2005 M.S.Dissertation(Georgia:Georgia Institute of Technology)
[18]L¨u Y,Zhang H M,Dai X Y,Hu H Y,Shu B 2004 Acta Phys.Sin.53 3239(in Chinese)[吕懿,张鹤鸣,戴显英,胡辉勇,舒斌2004物理学报53 3239]
[19]Yang H G,Shi Y,L¨u J,Pu L,Zhang R,Zheng Y 2004 Acta Phys.Sin.53 1211(in Chinese)[杨红官,施毅,闾锦,濮林,张荣,郑有2004物理学报53 1211]
[20]Hu H Y,Shu J,Zhang H M,Song JJ,Xuan R X,Qin S S,Qu JT 2011 Acta Phys.Sin.60 017303(in Chinese)[胡辉勇,舒钰,张鹤鸣,宋建军,宣荣喜,秦珊珊,屈江涛2011物理学报60 017303]
[21]Qian W,Jin X J,Zhang J,Lin H W,Chen P Y,Qian P X 1998 Chin.J.Semiconduct.19 261(in Chinese)[钱伟,金晓军,张炯,林惠旺,陈培毅,钱佩信1998半导体学报19 261]
[22]Liu L,Wang Y Q,Xiao B,Kang B W,Wu Y,Wang Z 2005 Chin.J.Semiconduct.26 96(in Chinese)[刘亮,王玉琦,肖波,亢宝位,吴郁,王哲2005半导体学报26 96]

