瞬时大电流下微机电引信硅通孔封装的失效机理与实验研究
刘芳怡,娄文忠,丁旭冉,王辅辅,王瑛
(北京理工大学 机电学院,北京100081)
0 引言
在引信中应用微机电系统(MEMS)技术可以降低成本、减轻质量,实现小型化发展[1-3]。法国创新研制了一种MEMS 安全、解除保险与发火器件,该MEMS 发火件可以提高MEMS 起爆器的性能,在大电流激发下会产生电爆炸作用,实现引信的发火功能[4-6]。利用这种电爆炸过程,Zhao 等[7-8]制备了一种新型MEMS 引信,该引信需要在瞬时大电流的作用下正常作用,所以激发源采用电容放电的形式。为实现引信小型化的要求,该MEMS 引信封装成为关键问题之一。
三维芯片集成具有小型化、多功能化、高可靠性和高性能、低功耗的优点[9-11]。基于三维集成电路和三维封装中的硅通孔(TSV)封装技术可以提供芯片间、晶圆间的垂直导通实现电气互连,TSV 作为MEMS 引信的首选封装方式,可以减小引信的封装体积和能量损耗[12-15]。TSV 在MEMS 引信中结构的简单剖面模型图如图1所示。本文研究的MEMS 引信工作在电容放电条件下,所以TSV抵抗瞬时大电流的能力成为封装中的主要问题,要求TSV 在瞬时大电流冲击下电阻改变量不能超过TSV 及测试系统整体电阻值大小的2%,如果满足上述条件,那么应用TSV 技术对MEMS 引信进行封装是可行的。其中,TSV 芯片的光学图像如图2所示。
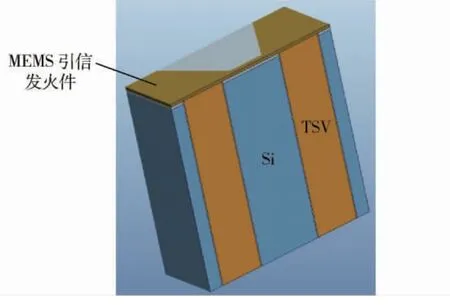
图1 TSV 在MEMS 引信中的结构Fig.1 The structure of TSV in MEMS fuze

图2 三维芯片和TSV 的光学图像Fig.2 Optical images of 3D chips and TSV
基于国内外对此类研究较少的情况,本文针对实验室制备的TSV,研究了TSV 在瞬时大电流冲击下的失效机理,建立理论与有限元模型,并进行实验验证,分析其薄弱区域以及不同参数下引起的击穿程度,进而对TSV 封装技术在MEMS 引信中的应用提供理论指导。
1 模型与相变分析
1.1 模型尺寸
应用深度反应离子刻蚀(DRIE)方法制备TSV,尺寸结构图如图3所示,为对称结构。通孔的深度250 μm,宽度为50 μm,深宽比为5∶1,由Cu 柱、SiO2绝缘层和Ti 扩散阻挡层构成。Cu 柱外侧的SiO2绝缘层厚为1 μm,上下表面的SiO2层厚为3 μm.因为Cu 与SiO2之间的扩散阻挡层小于100 nm,所以本文下述分析中忽略了扩散阻挡层。如果作为绝缘层的SiO2遭到破坏(例如被击穿),就会影响整个TSV 的电学特性,使之不能可靠工作。

图3 TSV 的横截面图Fig.3 The cross section of TSV
1.2 相变分析
当瞬时大电流通过TSV 时,通孔的温度迅速增加并达到材料的熔点。温度首先达到Cu 柱的熔点1 356.15 K,此时Cu 柱开始熔化变为液体。Cu 柱的温度持续增加,通过热传递使温度达到SiO2绝缘层的熔点。因为加热过程是非常迅速的,并且混合界面条件建模不易,所以假设短时间内两种材料(Cu和SiO2)界面间没有发生混合。SiO2绝缘层的沸点2 503.15 K 低于Cu 的沸点2 868.15 K,SiO2绝缘层很容易蒸发变为气态,从而击穿绝缘层,使其遭到破坏。
根据SiO2绝缘层的状态,可以把整个过程分为5 个阶段。第一阶段,SiO2为固体状态;第二阶段,温度达到SiO2熔点后,发生相变,SiO2由固态转化为液态,该过程为固-液混合态;第三阶段,SiO2完全液化后继续升温,该阶段为液态;第四阶段,当温度达到SiO2沸点后,发生相变,SiO2由液态转化为气态,该过程吸收汽化相变潜热,此阶段为液气混合态;第五阶段,SiO2完全汽化,该阶段为气态[6]。
上述5 个阶段的状态方程可以由方程(1)式表示。

式中:H 是绝缘层SiO2材料的热焓;cs是SiO2的固态热容;cl是SiO2的液态热容;Tm为SiO2的熔点;Tl为SiO2完全液化温度;Tv为SiO2沸点;Tg为SiO2完全汽化温度;L1和L2分别为SiO2的固-液相变潜热和液-汽相变潜热。
SiO2绝缘层的热焓H 是显热与潜热的和,通过下式计算:

其中显热h 的表达式为

式中:href是参考焓,可取为0;Tref是参考焓对应的温度,可取为初始温度T0;c 是比热容。
假设两相混合区内潜热释放是逐步线性的,对于单位质量的物质,则混合区的潜热等于体积分数β 乘以潜热L,即

两相混合区的潜热可以从0 变化为L,对应不同的热力学过程,则分别反映了固态到液态和液体到气态的过程。
2 有限元分析
由于本文研究的TSV 具有高度对称性,因而采用典型二维模型研究TSV 在瞬时大电流下的失效机理。结合参考文献[16],在COMSOL Mulitiphysics 中建立TSV 的有限元模型如图4所示,该有限元模型忽略扩散阻挡层。TSV 承受的载荷条件是电容放电产生的瞬时大电流,主要加载到TSV 的铜柱上。

图4 TSV 的有限元模型Fig.4 Finite element analysis models of TSV
为了更明显地暴露TSV 在瞬时大电流下的薄弱区域和潜在的失效模式,选用了3 种能量较高的作用条件,对TSV 施加的3 组仿真条件分别为40 V、330 μF 电容放电,10 V、330 μF 电容放电,4 V、100 μF 电容放电。这3 种电容放电条件均可以使MEMS 引信正常工作。选择SiO2层上的一点如图5所示,可以得到该点在3 种电容放电条件下的温度-时间曲线,如图6所示。
同时也得到TSV 的温度分布图,图7、图8、图9分别为4 V、100 μF 电容放电条件下在不同时刻(1.2 μs、1.7 μs、2.2 μs)对应的TSV 温度分布图,由于结构具有对称性所以只需截取左侧区域的图像。

图5 SiO2 层上一点Fig.5 The point on SiO2 layer

图6 3 种电容放电条件下TSV 的温度分布Fig.6 Temperature-time curves of TSV under three capacitor discharge conditions
从图6~图9可以得到以下结论:在这3 种电容放电条件下,SiO2层该点达到沸点的时间分别为0.645 μs、2.580 μs 和8.800 μs,说明绝缘层SiO2均已发生汽化,TSV 被击穿遭到破坏;随着放电电压、电容值的降低,绝缘层SiO2达到汽化温度的时间变长,即电压、电容值越大TSV 越容易被击穿;在TSV温度分布图中可以看出,随着时间的推移,TSV 上下表面Cu 柱外侧的绝缘层处温度增长最快,此区域的SiO2更容易达到汽化温度从而被击穿破坏,为TSV 的薄弱区域。
上述结论得到了TSV 绝缘层SiO2的薄弱区域,并可以分析出当此处的绝缘层SiO2被击穿后,Cu柱与Si 基底通过击穿区域实现了电连通,即TSV 与Si 基底进行了并联,使整体TSV 的电阻值降低,原理图如图10所示,由于结构具有对称性,此图只描述了TSV 左半部分被击穿的现象。由于仿真的目的是得到TSV 的薄弱区域,所以并未研究引信可靠起爆并传爆的整个放电时间,为了弥补上述研究中的不足,进行了放电实验。
3 实验结果与分析
放电实验的目的是对TSV 施加瞬时大电流,并测量、比较放电前后TSV 的电阻值来判断TSV 抵抗瞬时大电流的能力。

图7 在1.2 μs 时TSV 的温度分布图Fig.7 Temperature distribution of TSV at 1.2 μs
本实验是通过大电流发生器对储能电容充电,然后通过探针台把电容放电产生的瞬时大电流加载到TSV 上,实验装置如图11所示。测试步骤:首先,将TSV 圆片放置于探针测试台上,实现外界与器件的电连通,一根探针扎到TSV 上,另一根探针扎到基板上;其次,测试过程中采用大电流发生器对储能电容充电;然后,储能电容通过探针台再对TSV 放电;最后,测试结果通过高精度万用表采集。简单的实验原理图如图12所示。其中,实验作用时间满足真实引信可靠起爆并传爆的放电接通时间条件。
分别在40 V、330 μF,10 V、330 μF,4 V、100 μF 3 种放电条件下对TSV 进行放电实验得到TSV 的电阻差值如表1所示,得到TSV 在这3 种放电条件下的平均电阻差值分别为0.035 4 Ω、0.004 6 Ω 和0.001 4 Ω.在40 V、330 μF 放电实验过程中,看到了明显的火花现象,说明TSV 受到严重击穿。

图8 在1.7 μs 时TSV 的温度分布图Fig.8 Temperature distribution of TSV at 1.7 μs

表1 实验前后TSV 的电阻差值Tab.1 Resistance differences of TSV caused by discharge Ω
通过实验仪器测得TSV 及测试系统整体的电阻范围为0.7 Ω ~0.9 Ω,设此电阻范围为许用电阻范围。当TSV 电阻改变量不超过许用电阻值大小的2%时,认为TSV 的阻值改变在允许范围内,不会影响使用。选取许用电阻的最低电阻值0.7 Ω,使上述表中的电阻差值均除以0.7 Ω,得到TSV 电阻差值百分比,若超过2% 则认为在此放电条件下TSV 电特性受到严重破坏,若低于2%则认为TSV阻值改变在其正常工作允许范围之内。

图9 在2.2 μs 时TSV 的温度分布图Fig.9 Temperature distribution of TSV at 2.2 μs

图10 TSV 击穿原理图Fig.10 Schematic diagram of TSV breakdown

图11 实验设备Fig.11 Experimental equipment

图12 实验原理图Fig.12 Schematic diagram of experimental equipment
应用Matlab 画出电容放电实验前后TSV 电阻差值百分比曲线图,如图13所示,得到在3 种放电条件下TSV 电阻差值百分比的浮动范围。在40 V、330 μF 放电条件下TSV 的电阻差值百分比大于2%,说明TSV 在40 V、330 μF 放电条件下发生严重的击穿,不能正常使用。并且在40 V、330 μF 放电实验过程中,观察到明显的火花现象,这也说明TSV击穿程度严重。在10 V、330 μF 和4 V、100 μF 放电条件下TSV 的电阻差值百分比低于2%,说明此时TSV 虽然发生击穿,但电阻值改变很小,可以对MEMS 引信进行封装。
4 结论
本文完成了TSV 在不同电容放电条件下的仿真与实验研究,得到以下结论:
1)通过对TSV 在瞬时大电流下的仿真研究,得到薄弱区域为TSV 上下表面Cu 柱外侧的绝缘层,失效模式为SiO2发生汽化。
2)从放电实验中可以看出,在40 V、330 μF,10 V、330 μF 和4 V、100 μF 电容放电情况下TSV 均发生击穿,测量得到的电阻差值越大其击穿程度越大。

图13 TSV 电阻差值折线图Fig.13 Line chart of resistance differences of TSV
3)从仿真结果可以看出,在40 V、330 μF,10 V、330 μF 和4 V、100 μF 放电条件下绝缘层SiO2的温度会超过材料的汽化温度从而被击穿。并且施加电压、电容值越大,TSV 击穿越迅速。
4)实验数据与仿真结果相比,吻合得很好,说明仿真结果是正确可信的。
5)MEMS 引信工作在10 V、330 μF 和4 V、100 μF电容放电条件下应用TSV 技术进行封装是可靠的。在40 V、330 μF 电容放电条件下TSV 电阻特性将会遭到严重破坏,所以此时不能应用TSV 技术对MEMS 引信进行封装。
致谢 本文中放电实验所用的TSV 芯片为北京大学陈兢教授课题组加工并提供,谨致谢意!
References)
[1] 金磊,高世桥,李文杰.MEMS 固态引信硅微结构的力学分析与设计[J].兵工学报,2000,21(增刊1):450 -46.JIN Lei,GAO Shi-qiao,LI Wen-jie.Mechanics analysis and design of silicon microstructure in the MEMS solid fuze[J].Acta Armamentarii,2000,21(S1):45 -46.(in Chinese)
[2] 景华,牛兰杰,宋永强.小口径榴弹引信微机电安全系统设计与仿真方法[J].弹箭与制导学报,2010(4):129 -132.JING Hua,NIU Lan-jie,SONG Yong-qiang.The MEMS design and simulation method of small caliber grenade fuze[J].Journal of Projectiles,Rockets,Missiles and Guidance,2010(4):129 -132.(in Chinese)
[3] 徐伟,陈钱,顾国华,等.小型化激光近炸引信技术研究[J].兵工学报,2011,32(10):1212 -1216.XU Wei,CHEN Qian,GU Guo-hua,et al.Research on miniaturization of laser proximity fuze[J].Acta Armamentarii,2011,32(10):1212 -1216.(in Chinese)
[4] Pezous H,Rossi C,Sanchez M,et al.Integration of a MEMS based safe arm and fire device[J].Sensors and Actuators A:Physical,2010,159(2):157 -167.
[5] Pezous H,Rossi C,Sanchez M,et al.Fabrication,assembly and tests of a MEMS-based safe,arm and fire device[J].Journal of Physics and Chemistry of Solids,2010,71(2):75 -79.
[6] 王莹.电爆炸导体及其应用[J].爆炸与冲击,1986,6(2):184 -192.WANG Ying.Electrical conductor explosion and its application[J].Explosion and Shock,1986,6(2):184 -192.(in Chinese)
[7] Zhao Y,Lou W Z,Li D G.Study of a novel bi-stable and easy integrated MEMS ETBS[C]∥7th Annual IEEE International Conference on Nano/Micro Engineered and Molecular Systems-NEMS.Kyoto,Japan:IEEE,2012:257 -260.
[8] Zhao Y,Lou W Z,Li D G.Research in a novel integrated chip of safe and initiation control[C]∥Nanotechnology 2012:NSTI Nanotechnology Conference and Expo.Santa Clara,US:NSTI,2012:247 -250.
[9] Knickerbocker J U,Andry P S,Dang B,et al.3D silicon integration[C]∥58th Electronic Components and Technology Conference.Orlando,FL:.IEEE,2008:538 -543.
[10] Beyne E.3D system integration technologies[C]∥2006 International Symposium on VLSI Technology,Systems,and Applications.Taiwan,China:IEEE,2006:1 -9.
[11] 杨光育,杨建宁,韩依楠.电子产品3D—立体组装技术[J].电子工艺技术,2008,29(1):33 -34.YANG Guang-yu,YANG Jian-ning,HAN Yi-nan.The 3D electronic products-vertical assembly technology[J].Electronics Process Technology,2008,29(1):33 -34.(in Chinese)
[12] Kong L W,Rudack A C,Krueger P,et al.3D-interconnect:visualization of extrusion and voids induced in copper-filled through-silicon vias (TSVs)at various temperatures using X-ray microscopy[J].Microelectronic Engineering,2012,92(14):24 -28.
[13] Chung H,Tu C M,Lwo B J,et al.A complete resistance extraction methodology and circuit models for typical TSV structures[J].International Journal of Electronics,2013,100(9):1 -14.
[14] Beanato G,Cevrero A,De Micheli G,et al.3D serial TSV link for low-power chip-to-chip communication[C]∥2014 IEEE International Conference on Integrated Circuit Design and Technology (ICICDT).Austin,Texas,US:IEEE,2014:1 -4.
[15] Mirza F,Naware G,Raman T,et al.Effect of TSV joule heating on device performance[C]∥ASME 2013 International Technical Conference and Exhibition on Packaging and Integration of Electronic and Photonic Microsystems.Burlingame,California,US:American Society of Mechanical Engineers,2013:V001T04-A016.
[16] Liu X,Chen Q,Dixit P,et al.Failure mechanisms and optimum design for electroplated copper through-silicon vias(TSV)[C]∥IEEE 59th Electronic Components and Technology Conference.San Diego,California,US:IEEE,2009:624 -629.

