多靶磁控溅射镀膜设备及其特性
佘鹏程,陈庆广,胡 凡,陈特超,彭立波,张 赛,毛朝斌
(中国电子科技集团公司第四十八研究所,湖南长沙410111)
多靶磁控溅射镀膜设备及其特性
佘鹏程,陈庆广,胡 凡,陈特超,彭立波,张 赛,毛朝斌
(中国电子科技集团公司第四十八研究所,湖南长沙410111)
介绍了一种多靶磁控溅射镀膜设备,阐述了镀膜室、工件台、阴极溅射靶、辅助离子源、真空系统等关键部件的设计思想。镀膜工艺结果显示,设备满足工艺要求,膜层均匀性优于±3%。
磁控溅射;溅射靶;离子源
磁控溅射镀膜设备利用溅射方法,实现快速和低温薄膜生长,与热蒸发和电弧镀相比,磁控溅射沉积薄膜过程稳定、控制方便、靶材设计性强,易获得大面积均匀薄膜;同时,磁控溅射成膜的离子能量高于热蒸发、低于电弧镀,易获得附着力强、致密度高、内应力小的薄膜。
随着科技的进步,磁控溅射设备技术愈加成熟,其成本逐渐被民用市场接受,磁控溅射技术不再局限于军工、航空航天等领域关键元器件的制备应用,目前已广泛应用到光学薄膜、薄膜太阳能电池、半导体等领域。
为适用各领域多材料薄膜的制备与研发,中国电子科技集团公司第四十八研究所研制了一种多靶共溅的磁控溅射镀膜设备,具备直流溅射、射频溅射、脉冲溅射功能,兼顾薄膜器件生产和研发的市场需求。
1 设备工作原理
磁控溅射镀膜是在基片和阴极溅射靶之间附加正交电磁场,通入工艺气体在靶材表面进行辉光放电,形成等离子体区。在正交电磁场的作用下,电子以摆线的方式沿靶表面前进,电子的运动被限制在一定空间内,增加了电子与工作气体分子的碰撞几率,提高电子的电离效率。电子经多次碰撞后,丧失能量成为“最终电子”进入弱电场区,到达阳极时已是低能电子,不会使基片过热。氩离子则受电场的作用,轰击靶材表面,靶材表面原子溅射沉积在基片表面形成薄膜。其原理如图1所示。
2 设备结构
磁控溅射镀膜设备是机电一体综合系统,主要由镀膜室、工件台、阴极溅射靶、辅助离子源、真空气路系统、挡板机构、水冷系统以及电器控制系统组成。
设备整体采用框架封闭式结构,四周对开门设计,方便内部零部件的安装盒维护。各主要部件在机架内布局,如图2所示。

图2磁控溅射镀膜设备
2.1关键尺寸设计
磁控靶与工件台的相对位置对溅射沉膜均匀性起决定性作用,其中靶基距、溅射角度最关键。本设备配置3套φ50 mm(2英寸)圆形阴极溅射靶,基片尺寸为100 mm(4英寸),仿真结果显示,阴极溅射靶分布圆周直径220 mm、靶基距70 mm、溅射角度15°沉膜均匀性较佳,100 mm(4英寸)基片沉膜均匀性达0.55%。如图3所示。

图3靶基布局及均匀性仿真结果
2.2镀膜室
薄膜生长在镀膜室进行,需经常清扫;靶材的更换及基片的装载必须打开镀膜腔室。因此在进行镀膜室设计时充分考虑腔室能够方便的打开、关闭以及零部件的拆、装。
镀膜室的操作灵活性与高洁净密封性互相矛盾,需要精心设计及精密加工才能实现。本设备采用金属密封和O型圈密封相结合的方式,在经常开启的密封位置采用O型圈,其他位置采用金属密封,即保证设备的操作方便性,又保证设备的高真空密封要求。
镀膜室采用立式结构,腔体上设计有工件台、阴极溅射靶、辅助离子源、真空系统等部件的接口法兰。阴极溅射靶分布在镀膜室底板上,自下向上溅射,离子源侧置,以一定角度对准基片,各部件在镀膜室内分布如图4所示。
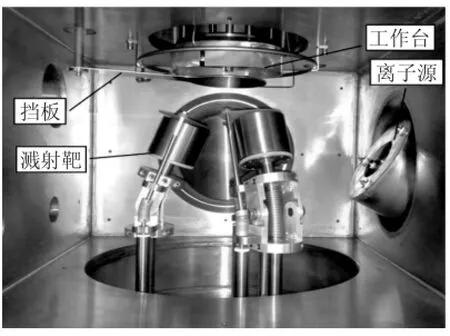
图4镀膜室内部分布图
2.3工件台
工件台可装载100 mm(4英寸)基片,具备旋转、加热功能。基片旋转采用步进电机控制,转速2~12 r/min可调,基片旋转可提高溅射沉膜均匀性。不锈钢真空加热器分布在基片背面,对基片进行辐射加热。溅射工艺前加热,去除基片表面吸附的油分子及微量水汽,提高基片表面洁净度,增强沉膜附着力;工艺过程中加热基片,沉积一定晶向的薄膜。图5为基片台示意图。

图5工件台示意图

图6阴极溅射靶仿真结果
2.4阴极溅射靶
阴极溅射靶是设备最关键部件,溅射靶直接关系着沉膜均匀性和靶材利用率。本设备配置3套阴极溅射靶(两套普通靶、一套强磁靶),兼容金属、介质、半导体,磁材料(Fe、Co、Ni)等各种靶材。靶材采用间接冷却方式,环形磁铁位于冷却室内,无氧铜设计的冷却室提高靶材热量的传导。靶枪设计有角度调节机构,最大调节角度为30°,方便工艺调试。靶枪配置有单独自动挡板机构。
为提高可靠性,运用电磁仿真软件对阴极溅射靶的结构进行模拟仿真分析,从理论上选取最佳结构,配置合适的磁控结构,确保阴极溅射靶表面磁场分布尽可能均匀,平行磁场区域大,溅射域宽,提高靶材利用率。电场分布关系到电子能量大小,影响到碰撞电离度。如图6所示仿真结果,高密度电子区集中在150~290 V电位,该区域磁场约300 GS。50 mm(2英寸)圆靶溅射跑道在φ12~φ36 mm区域。
参考仿真结果及进口溅射靶结构,最终设计的阴极溅射靶如图7所示。

图7阴极溅射靶
2.5辅助离子源
在溅射镀膜前,辅助离子源用于清洗基片、去除基片表面附着物,提高沉膜质量。中国电子科技集团公司第四十八研究所是国内最早从事“电子束、离子束、分子束”设备的研究所,在离子源技术上有深厚的沉淀。本设备配置发散型考夫曼离子源,其原理是加热灯丝产生一次电子,放电磁场与电子运动方向垂直,电子在垂直电磁场中做螺旋运动,与工艺气体Ar碰撞,产生Ar+和二次电子,Ar+被引出向基片运动,二次电子在电磁场作用下继续与工艺气体碰撞增大工艺气体电离率。图8为考夫曼离子源示意图。离子源出口束径φ100 mmm,束流最大能量1 000 eV,发散角30°。

图8辅助离子源示意图
2.6真空气路系统
随着材料性能要求的提高,对镀膜室真空度要求更高。本设备要求极限真空度为6.6E-5 Pa。根据镀膜室腔体容积V,腔体内材料表面积A,极限真空度PJ,进行真空系统设计计算:

式中:V为镀膜室容积;
P为镀膜室真空度;
Se为镀膜室抽气口泵的有效抽速;
Qf为镀膜室内部表面放气量;
Q1为镀膜室密封处漏气量。
不考虑腔体中空间气体负荷对抽气的影响,泵对腔体的极限真空时排气量仅仅与放气和漏气处于动平衡状态,则:

计算得知Se=1050 L/s
真空泵的理论抽速:

式中:KS为主泵与腔体之间的抽速损失系数,一般为1.3~1.4
则:S=1.4×1050=1470 L/s
选取FF-250型分子泵,抽速为1 600 L/s,可满足系统要求。
前级泵选择:

选取15 L/s双级旋片机械泵为前级泵。溅射工艺时通过气路系统送气,采用质量流量计控制,管道采用不锈钢双卡套接管方式。设备真空气路原理见图9所示。

图9真空气路原理图
3 工艺测试
多靶磁控溅射镀膜设备完成装配调试后,完成多种材料的溅射镀膜工艺试验,获得了均匀、致密的优质膜层。SiO2材料在100 mm基片范围内膜层均匀性优于1%,NiCr合金薄膜均匀性优于±3%。图10为功率300 W射频溅射SiO2膜层120 min后所得膜层厚度及均匀性测试结果,平均厚度1.382 μm,均匀性达到0.564%。

图10 SiO2膜层均匀性测试结果
为进一步检测膜层质量,采用原子力显微镜对膜层表面进行分析,结果如图11所示,结构致密,无明显缺陷。
靶材利用率是用户关心的另一个重点,本设备使用的靶材刻蚀跑道与仿真结果相符,靶材利用率约28%。

图11 SiO2膜层表面形态分析结果
4结论
目前,本多靶磁控溅射镀膜设备已在生产线上使用,效果良好,达到了用户工艺要求。本设备溅射沉膜均匀性好,膜层致密,稳定性好,操作方便,深得用户好评,在交付客户后很快获得市场订单,同时向更大尺寸基片和阴极靶进行扩展。
[1] 程建平,杨晓东.真空磁控溅射镀膜设备及工艺技术研究[J].电子工业专用设备,2009,38(11):27-31.
[2] 石永敬,龙思远,王杰,等.直流磁控溅射研究进展[J].[3] 余东海,王成勇,成晓玲,等.磁控溅射镀膜技术的发展[J].真空,2009,46(02):19-25.
材料导报,2008,22(01):65-69.
[4] 马建平,刘艳涛.圆形平面非平衡磁控溅射靶的优化设计[J].人工晶体学报,2008,37(03):759-762.
[5] 赵华玉,牟宗信,贾莉,等.平面磁控溅射靶磁场的计算[J].真空科学与技术学报,2008,28(03):271-274.
[6] 刘翔宇,赵来,许生,等.磁控溅射镀膜设备中靶的优化设计[J].真空,2003,(4):16-22
[7] 达道安.真空设计手册[M].北京:国防工业出版社,2004.769-782.
Multi-target Magnetron Sputtering Coating Equipment and its Characteristics
SHE Pengcheng,CHEN Qingguang,HU Fan,CHEN Techao,PENG Libo,ZHANG Sai,MAO Chaobin
(The 48thResearch Institute of CETC,Changsha 410111,China)
The design of a multi-target magnetron sputtering coating equipment was introduced. Sputtering targets,workpiece table,vacuum system,assistant ion source were particularly described. Thickness uniformity of film is better than±3%.
Magnetron sputtering;Sputtering target;Ion source
TN305
B
1004-4507(2016)06-0032-06
2016-04-14

