CMP设备中几种下压力施加结构简介
周国安,詹 阳,李 伟,胡兴臣,陈 威
(中国电子科技集团公司第四十五研究所,北京100176)
CMP设备中几种下压力施加结构简介
周国安,詹 阳,李 伟,胡兴臣,陈 威
(中国电子科技集团公司第四十五研究所,北京100176)
分析了旋转臂式结构的下压力特点,指出其采用最直接的杠杆原理,是第一代CMP机型IPEC372M的典型结构,适用于0.8 μm的技术节点,并指出其局限性;后分析了桥式下压力结构,加了垂直于抛光台的主轴套及铰链结构,这种改善性的杠杆原理保证气缸施加下压力的有效性;研究了中国电子科技集团公司第四十五研究所特有专利技术的转塔式结构采用的浮动悬挂模块,能够实现完全下压力的垂直性,同时具备维持压力的恒定性和微压力的灵敏性;然后分析应用材料的旋转木马形式结构,并研究了其结构的特色能够实现抛光头的垂直下降,而且薄膜的压力完全替代下压力和背压的作用,具备更好的晶圆平坦化性能。最后指出今后CMP压力结构应该具备高响应特性、少的移动部件。
化学机械平坦化;下压力;旋转臂;桥;转塔;旋转木马;薄膜
化学机械平坦化(CMP)是集成电路(IC)制程中的核心重大装备之一,而下压力的机械结构和施加方式是CMP工艺参数中重要一项,其不仅直接影响晶圆的平坦化效果,且关系着设备的可靠性和维护性。因此研究下压力的施加结构对于CMP(化学机械平坦化)设备的设计及工艺都具有重要意义。
1 CMP设备工作原理
CMP设备是采用把一个抛光垫粘在抛光台的表面上进行平坦化,平坦化之前承载器采用真空方式吸附晶圆;在平坦化的时候,承载器对晶圆施加下压力、区域背压和保持环压力,与此同时按照菜单设定好的转速与抛光台同向旋转且摆动,抛光液持续流入抛光垫上,并被带入到抛光区域,实现对晶圆的化学和机械的综合去除作用。修整器可以采用在线和离线修整方式,以维持抛光垫稳定的形态形貌[1]。如图1所示。
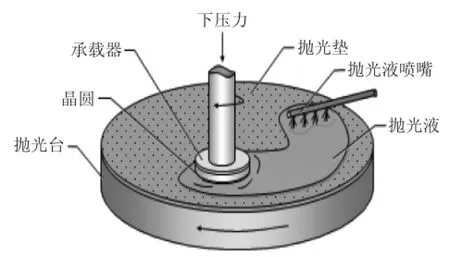
图1 CMP设备平坦化示意图
其中机械作用的主要方式是由晶圆和抛光垫有效接触面之间的摩擦力来决定,主要体现于抛光头和抛光台之间的线性速度差及施加于晶圆表面下压力、背压及维持环的压力。下压力的施加结构有多种形式,但最重要也是最基本的要求是垂直于抛光台表面。
2旋转臂(OVERARM)式下压力施加结构
20世纪80年代后期,IBM开发采用了CMP技术,此时出现了第一代CMP典型设备为IPEC372M及IPEC472,该设备就是典型的旋转臂结构的下压力施加方式,如图2所示。

图2 IPEC372M
从图2中可以看出,该结构形成一种杠杠,利用气缸直接推动抛光头整体结构上升或者下降。该结构的下压力施加原理简单直接,对于当时0.8 μm技术节点的氧化物抛光,已经满足其工艺要求。其施加下压力采用以支点为圆心,抛光头为半径形式画弧施加下压力,在这个过程中,承载器是否垂直于抛光台的表面需要经常精细校正其主轴;IPEC372M的承载器具备万向功能,可轻微的自适应调整以最大程度的贴合抛光垫,但如果主轴垂直于抛光台的偏向过大,则承载器也无法有效弥补,抛光后的晶圆将会呈现楔形形状,直接导致芯片失效。IPEC372M的施加力的结构简单,且力的作用是刚性,这对于控制表面形态形貌并不理想,但该设备是单抛光头双抛光台,具备粗和精抛光性能,在抛光过程中是单抛光头对应单抛光台,因此工艺过程便于控制,片与片之间的非均匀性(WTWNU)较好;这种下压力结构较之其他种类的CMP设备大,因此目前一些厂商会选择做厚SOI(绝缘层上硅)的抛光,能够基本满足要求。在150 mm与200 mm的初始晶圆抛光(Prime Wafer)方面,美国Strasbaugh公司的6DZ也采用该种结构,这种结构具备极大的下压力,在施加大的下压力的情况下边旋转变摆动,满足较大衬底材料大去除量及严苛的全局厚度变化 (TTV)及局部平整度(STIR)的要求。由于这种结构较为简单,因此Strasbaugh打造了实验室专用设备6EC和6EG,这些设备在芯片设计初期开发工艺及芯片制造中进行失效分析具备极强的性价比和灵活性。
3桥式(BRIDGE)下压力施加结构
旋转臂式下压力施加结构是简单的杠杠原理,抛光头的下压力不能够有效保证垂直于抛光台的表面,这对晶圆抛光极其不利;而桥式下压力的施加结构可以有效改善这种状况。这种结构在美国Strasbaugh的量产设备6DS-SP上得以体现,如图3所示。

图3美国Strasbaugh的抛光头结构图
从图3可以看出,整个结构也是一种杠杠原理,但不同的是其主轴位于固定的套筒形式的结构中,从机械结构上保证其垂直于抛光台平面;另外是增加了铰链,这可以保证即使支杆倾斜于支点,但施加于主轴上的作用力依然是垂直向下的。Strasbaugh的这种下压力结构配合其特有的VIPRR(可变气动维持环)型抛光头广泛用于0.35 及0.25 μm技术节点的芯片生产中。6ds-sp采用的双抛光头结构,这在0.25 μm以上技术节点中能够在满足工艺条件情况下,节省抛光液和抛光垫,但是在90 nm技术节点以下,其工艺的可控性及片间非均匀性却面临是严峻的挑战,同时受制于其集成后清洗技术的短板,在后续上基本被美国应用材料(AMAT)及荏原(EBARA)所取代。
4 转塔式下压力施加结构
随着CMP技术的重要性日益凸显,中国加大了CMP技术的重视,中国电子科技集团公司第四十五研究所经过多年的研究积累,形成了一系列自主的核心技术[2],并取得多项发明专利。采用浮动悬挂装置的转塔结构就是其自主研发的成果之一,如图4所示。

图4 PG1201的CMP的转塔结构
该技术的施加力单元不再是传统的气缸,而变成橡胶气囊式气缸,其不仅在微压作用下保持良好的下压力特性,而且随着抛光过程在抛光头旋转且同时摆动过程中动态调整姿态,具有很高的抛光力适应柔韧性。主轴在压簧和气囊式气缸上保持平衡,通过气压的变化,实现主轴的垂直升降,有效保证主轴垂直于抛光台表面,其下压力在抛光过程中能够自适应的按照设定值保持稳定。该种结构已经应用于实际晶圆生产中,平坦化后的晶圆具备良好的表面形态形貌。
5 旋转木马形结构
应用材料基本上所有机型CMP均采用此种结构形式,并且申请了专利技术(US005738574A)[3],这种呈现对称结构确保整个系统的稳定性。其中Mirra-Mesa及Reflexion LK均采用了4抛光头和3抛光台结构,在抛光过程中实现了单抛光头对应单抛光台,对单片的平坦化效果如片间非均匀性极好,同时满足了严格的片间非均匀性。这种结构在实现三个抛光台同时抛光,装载及卸载也同时在此时间段内完成,最大限度满足量产的需要,是当今的主流CMP设备,如图5所示。
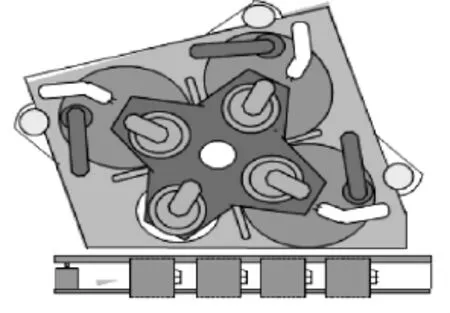
图5 Mirra-Mesa的示意图
应用材料的CMP设备在抛光主轴整体组件上都没有采用气缸结构,因此抛光头主轴任何时候都是维持不动状态,这也在整体上保证了设备的稳定性和可靠性。以经典的TITAN抛光头为例,其抓取晶圆、卸载晶圆及抛光过程按下晶圆都靠保持环(retaining ring)的正负压来实现此功能,而施加于晶圆上的力主要是薄膜的力,其结构和受力如图6,图7所示。

图6 Titan机械结构图
从图6、图7中可以看出,在Mirra-Mesa抛光过程中,实现设置的力的参数为保持环力、薄膜力及内管力。保持环通过正负压直接带动整个下部模块上下运动取代了前叙依靠气缸来推动抛光头模块上下的功能,并且更为迅速快捷。其主轴一旦原厂校正完毕,后续维护基本无需考虑,对晶圆表面施加的力也必定是垂直的。薄膜力实际上是一种气囊性质的力,以取代上叙几种结构设备的背压(Insert/Backfilm)和下压力,不同的是由于采用表面可以膨胀收缩的柔软的薄膜材料,这种力更为柔性,适合晶圆贴合抛光垫的动态调整,获取更好的平坦化效果。因为施加正压力的过程中,薄膜形成了一种封闭空间,因此保持力的恒定性更好,且作用于晶圆表面是面接触,避免了点接触的局部压强过大[4]。
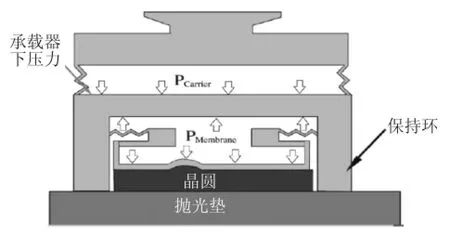
图7 Titan抛光头受力分析简图
6结论
随着集成电路技术节点越来越严苛,对设备的要求也越来越高,对下压力的实现在结构上一方面要充分考虑且可靠性,如尽可能少的移动部件;另一方面要达到其高响应特性和微压力实现特性,达到更高精度的平坦化效果。
[1] Michael Quirk,Julian Serda.半导体制造技术[M].韩郑生,译.北京:电子工业出版社,2009.7.
[2] 陈威,廖传鑫,王东辉,等.化学机械抛光心轴装置[P].中国,ZL201010249877.6.2013-01-09.
[3]Robert D.Tolles,Santa Clara,NormShendon,etc.Continuous Process System For Chemical Mechanical Polishing [p].US,US005738574A,1998-4-14.
[4] 李伟,周国安,徐存良,等.CMP承载器背压发展历程[J].电子工业专用设备,2015,44(3):23-25.
个人简介:
周国安(1981-),河南信阳人,硕士,毕业于西南交通大学,高级工程师,现主要从事半导体专用设备研究。
The introduction about several down pressure structures of CMP tools
Zhou Guoan,Zhan Yang,Li Wei,HuXingchen,Chen Wei
(The 45thResearch Institute of CETC,Beijing,100176,China)
First,the paper analyze the feature of down pressure in the overarm style structure,and figuring out it adoptsthe simple lever principle,which is used in the first generation CMP tool IPEC372M,and suit for 0.8 μm technology node in the IC field..Meanwhile the author indicates its disadvantage.Second,to introduce the bridge structure,adding the shaft sleeve and lever's chains which can make sure the spindle vertically to the platen.The kind of improved lever is very useful for the down pressure;Third,to study the tower structure,the patent belong to CETC 45,and it adopts the floated hanging flame,can achieve the real vertical down pressure to the platen.The tower structure has the pressure stably and very small force sensitively.Then,to analyze the carrousel structure of the AMAT's tool,and giving the structure's feature,it can apply the Membrane pressure instead of down pressureand back pressure,which realize the very excellent uniformity of the wafer.At last,pointing out the down pressure structure should has high reactive sensitively and less movement's parts.
CMP(chemical mechanical planarization);Down pressure;Overarm;Bridge;Tower;Carrousel;Membrane
TN305.2
A
1004-4507(2016)06-0045-04
2016-03-29

