Cu互连中V、V-N和V/V-N薄膜的扩散阻挡性能
王翠萍,戴 拖,卢 勇,施 展,张锦彬,刘兴军
(厦门大学材料学院,福建厦门361005)
Cu互连中V、V-N和V/V-N薄膜的扩散阻挡性能
王翠萍,戴 拖,卢 勇,施 展,张锦彬,刘兴军*
(厦门大学材料学院,福建厦门361005)
采用磁控溅射法在Si(100)基板上沉积厚度为50 nm的V、V-N和V/V-N扩散阻挡层,并在扩散阻挡层上制备了厚度为300 nm的Cu薄膜,最终获得了Cu/V/Si、Cu/V-N/Si和Cu/V/V-N/Si 3种多层薄膜.薄膜样品在300~750℃真空热处理1 h后,通过X射线衍射(XRD)仪、扫描电子显微镜(SEM)和四探针电阻测试(FPP)仪对薄膜样品的晶体结构、微观组织形貌和方块电阻进行测试表征,对比分析了V、V-N和V/V-N 3种扩散阻挡层的扩散阻挡性能.实验结果表明:V、V-N和V/V-N扩散阻挡层均能够有效阻挡Cu原子向Si基板的扩散;Cu/V/Si和Cu/V-N/Si薄膜样品分别在600和650℃时能够保持良好的热稳定性;Cu/V/V-N/Si多层薄膜中由于堆栈结构的存在,样品在700℃还具有良好的热稳定性,表明堆栈结构的V/V-N是一种较理想的扩散阻挡层.
扩散阻挡层;阻挡性能;堆栈结构;磁控溅射
随着集成电路(integrated circuit,IC)的集成度越来越高,电路特征尺寸不断减小,传统Al互连材料由于抗电迁移能力较差已不能满足互连材料性能的要求.Cu比Al具有更低的电阻率、更好的抗电迁移能力和更高的热传导系数,因此,Cu取代Al成为新一代互连材料[1-4].一方面Cu的低电阻率能够极大地减少阻容延迟,提高电路的运算速度;另一方面Cu具有良好的抗电迁移能力,能够延长互连材料的寿命,提高元器件的稳定性和可靠性.然而,许多研究报道表明,在200℃时Cu薄膜与Si基板发生互扩散形成Cu-Si化合物,引起Cu薄膜方块电阻急剧上升,最终导致Cu互连材料的失效[5-7].
为了解决Cu互连材料快速扩散的问题,需要在Cu和Si器件之间引入合适的扩散阻挡层来阻挡Cu原子的扩散.由于Ta[8-9]、Mo[10-11]、Ti[12-13]、Zr[14-15]等难熔金属及其氮化物或碳化物具有较高的热稳定性且与Cu有较低的固溶度,因此被广泛应用于Cu互连中的扩散阻挡层,其优点是既具有较好的扩散阻挡性能,同时还能够有效增强Cu与Si基板的结合力.Chuang等[16]在Si基板上制备50 nm的Cr和Cr-N扩散阻挡层,研究发现Cu/Cr/Si薄膜在550℃热处理后生成Cu-Si化合物,Cr扩散阻挡层失效;而Cu/Cr-N/Si薄膜能够在700℃热处理后依然具有良好的稳定性且保持较低的方块电阻,实验结果表明Cr-N薄膜具有更好的扩散阻挡性能.Song等[10]制备堆栈结构(多层复合薄膜)的Mo/Mo-N扩散阻挡层,发现实验结果中堆栈结构的Mo/Mo-N扩散阻挡层具有最优的扩散阻挡性能,Cu/Mo/Mo-N/Si多层薄膜在700℃依然没有观察到Cu-Si化合物的生成.
金属V具有较高的熔点、良好的导电导热性并且与Cu的固溶度较低,因此,本研究选用V基薄膜充当扩散阻挡层.通过磁控溅射制备Cu/V/Si、Cu/V-N/Si和Cu/V/V-N/Si多层薄膜,薄膜样品在300~750℃真空热处理1 h后,通过X射线衍射(XRD)仪、扫描电子显微镜(SEM)和四探针电阻测试(FPP)仪对薄膜样品的晶体结构、微观组织形貌和方块电阻进行测试表征,对比分析V、V-N和V/V-N的扩散阻挡性能.
1 实验方法
本实验采用直流磁控溅射制备了Cu(300 nm)/V(50 nm)/Si、Cu(300 nm)/V-N(50 nm)/Si和Cu(300 nm)/V(30 nm)/V-N(20 nm)/Si 3种多层薄膜,溅射用的靶材为V靶(纯度为99.99%)和Cu靶(纯度为99.99%).溅射前分别用乙醇和丙酮对Si(100)基板进行超声清洗,然后放到稀释的HF溶液中3 min,以除去Si表面的SiO2本征层,最后用高纯N2吹干基板后放入溅射室内.溅射时的本底真空度为5.0×10-4Pa,工作压强保持在0.5 Pa,V的溅射功率是100 W,Cu的溅射功率是80 W,在沉积V-N薄膜过程中,溅射气体为Ar和N2的混合气体,Ar气流量为30 m L/min,N2气流量为2 m L/min.将制备好的薄膜样品放置于系统自带的热处理炉中进行1 h保温处理,并随炉冷却至室温.
利用Alpha-Step IQ台阶仪测量薄膜层的厚度,测量精度为0.1 nm,测量范围0.01~60μm;利用Rigaku UltimaⅣXRD仪表征薄膜样品的晶体结构,检测时采用Cu靶的Kα特征射线,波长为0.154 18 nm,入射角固定在1.5°,扫描速度为5(°)/ min;利用日立SU-70场发射SEM观察薄膜的表面和横截面的微观组织形貌;利用SEM的能谱(EDS)仪检测薄膜样品的成分;采用RTS-8型FPP仪测定薄膜样品热处理前后的方块电阻.方块电阻表示正方形薄膜材料边到边之间的电阻,其大小与薄膜面积无关.
2 结果与讨论
2.1薄膜的晶体结构

图1 Cu/V/Si(a)、Cu/V-N/Si(b)和Cu/V/V-N/Si(c)多层薄膜在不同温度热处理1 h时的XRD谱图Fig.1 XRD spectra of the Cu/V/Si(a),Cu/V-N/Si(b)and Cu/V/V-N/Si(c)multilayer films annealed at different temperatures for 1 h
图1是Cu/V/Si、Cu/V-N/Si和Cu/V/V-N/Si多层薄膜在不同温度热处理1 h时的XRD谱图.如图1(a)所示:Cu/V/Si多层薄膜在沉积态下出现较宽的Cu(111)衍射峰,表明沉积态的Cu薄膜结晶性较差;在400,500和600℃热处理1 h后,Cu薄膜的结晶性良好,检测到Cu(111)、Cu(200)和V(110)衍射峰,且Cu(111)晶面衍射强度远高于Cu(200)晶面,表明Cu薄膜具有(111)择优取向生长;当热处理温度升高至650℃时,除Cu和V衍射峰外,在44.6°和45.2°附近出现Cu3Si衍射峰,表明Cu通过V扩散阻挡层扩散到Si基板中生成Cu3Si化合物相,此时V扩散阻挡层已失效.如图1(b)和(c)所示:Cu/V-N/Si多层薄膜样品在700℃以下热处理1 h时,只检测到Cu(111)、Cu(200)和V-N(110)衍射峰;当温度达到700℃后,检测到Cu3Si衍射峰;而Cu/V/V-N/Si多层薄膜直到750℃才检测到Cu3Si衍射峰,同时,Cu衍射峰也完全消失,表明薄膜样品表面的Cu几乎全部扩散进入Si基板中形成Cu3Si化合物相,此时V/V-N扩散阻挡层已完全失效.XRD实验结果表明:Cu/V/Si和Cu/V-N/Si薄膜样品分别在600和650℃时能够保持良好的热稳定性;堆栈结构的Cu/V/V-N/Si多层薄膜在700℃时依然具有良好的热稳定性,表明V/ V-N具有更好的扩散阻挡性能.
2.2薄膜的表面及横截面的微观组织形貌
图2是Cu/V/V-N/Si多层薄膜在不同温度热处理1 h后的表面微观组织形貌图.从图2(a)~(c)可以看出,在沉积态以及500和600℃热处理1 h后,Cu/ V/V-N/Si多层薄膜表面比较平整,没有出现明显的缺陷,薄膜保持良好的致密性.如图2(d)所示,当热处理温度升至700℃时,多层薄膜表面出现许多弥散分布的山丘和孔洞,薄膜表面变得粗糙不平.从XRD实验结果(图1(c))可知,多层薄膜中并未形成Cu-Si化合物,表明此时的V/V-N扩散阻挡层并没有失效.薄膜表面的不连续可能是因为Cu薄膜表面的热应力释放引起Cu原子的团聚而形成山丘与孔洞[8].然而,当温度达到750℃时(图2(e)),多层薄膜表面微观组织形貌发生明显变化,出现较大尺寸且弥散分布的矩形析出相,同时Cu薄膜层几乎被完全消耗掉.通过SEM-EDS检测图2(e)中A、B和C 3个局部区域的成分,结果如表1所示:A区域中Cu与Si的原子比接近3∶1,结合XRD结果(图1(c))可知,该矩形相就是Cu3Si化合物,表明Cu薄膜层的消耗主要是因为Cu通过扩散阻挡层扩散至Si基板形成Cu3Si化合物所致;B区域中几乎全部成分为Si,表明Cu3Si化合物周围区域的V/V-N扩散阻挡层已被破坏;C区域成分除了Si之外还含有V和N,表明该位置的薄膜层为V/V-N扩散阻挡层.
图3是Cu/V/V-N/Si多层薄膜在700和750℃热处理1 h后横截面的微观组织形貌图.从图3(a)可以看出:在700℃热处理1 h后,Cu薄膜与Si基板之间的V/V-N扩散阻挡层保持连续结构,各薄膜层没有存在明显的裂纹、孔洞等缺陷,薄膜与基板界面结构清晰,没有Cu-Si化合物生成;此外,在Cu薄膜与树脂界面处出现断层现象,这主要是由于薄膜样品在抛光时产生的应力所致.如图3(b)所示:当温度升高至750℃时,Cu/V/V-N/Si多层薄膜的截面微观组织形貌发生较大变化,在薄膜中生成较大尺寸的Cu3Si化合物,由于Cu3Si化合物的形成使得周围区域的Cu薄膜被消耗掉;同时,靠近Cu3Si周围区域的V/V-N扩散阻挡层也已被破坏.

图2 Cu/V/V-N/Si多层薄膜在沉积态和不同温度热处理1 h后的表面微观组织形貌图Fig.2 The surface morphology images of the Cu/V/V-N/Si multilayer films at as-deposited and annealed at different temperatures for 1 h

表1 图2(e)中A,B和C 3个区域的成分Tab.1 The compositions of the region A,B and C shown in figure 2(e)
2.3薄膜的方块电阻
图4为Cu/V/Si、Cu/V-N/Si和Cu/V/V-N/Si多层薄膜的方块电阻随热处理温度的变化曲线.在本研究的多层薄膜体系中,由于Cu薄膜的方块电阻远低于各扩散阻挡层,而Cu薄膜的厚度远大于扩散阻挡层厚度,可认为多层薄膜的方块电阻基本由Cu薄膜决定.从图4可知,Cu/V/Si、Cu/V-N/Si和Cu/V/ V-N/Si 3种多层薄膜的方块电阻具有相同的变化趋势,即薄膜样品经热处理后先降低后升高.方块电阻降低的原因主要是由于热处理后薄膜的缺陷较少,Cu晶粒长大,从而导致薄膜方块电阻减小.对Cu/V/Si多层薄膜,在650℃热处理后,薄膜样品的方块电阻急剧升高,结合XRD结果(图1(a))可知,此时多层薄膜中生成Cu3Si化合物,因此可认为方块电阻的急剧增加是由于Cu扩散进入Si基板形成Cu3Si所致,此时V扩散阻挡层已失效.对Cu/V-N/Si多层薄膜,在700℃热处理后方块电阻急剧升高,表明此时V-N扩散阻挡层已失效.然而,Cu/V/V-N/Si多层薄膜在700℃热处理后,方块电阻依然保持较低的值,从XRD和SEM结果(图1(c)和图2(d))可知,此时薄膜中没有Cu3Si化合物生成.当温度升至750℃时,由于薄膜中生成Cu3Si化合物,薄膜样品的方块电阻急剧升高,此时V/V-N扩散阻挡层已失效.
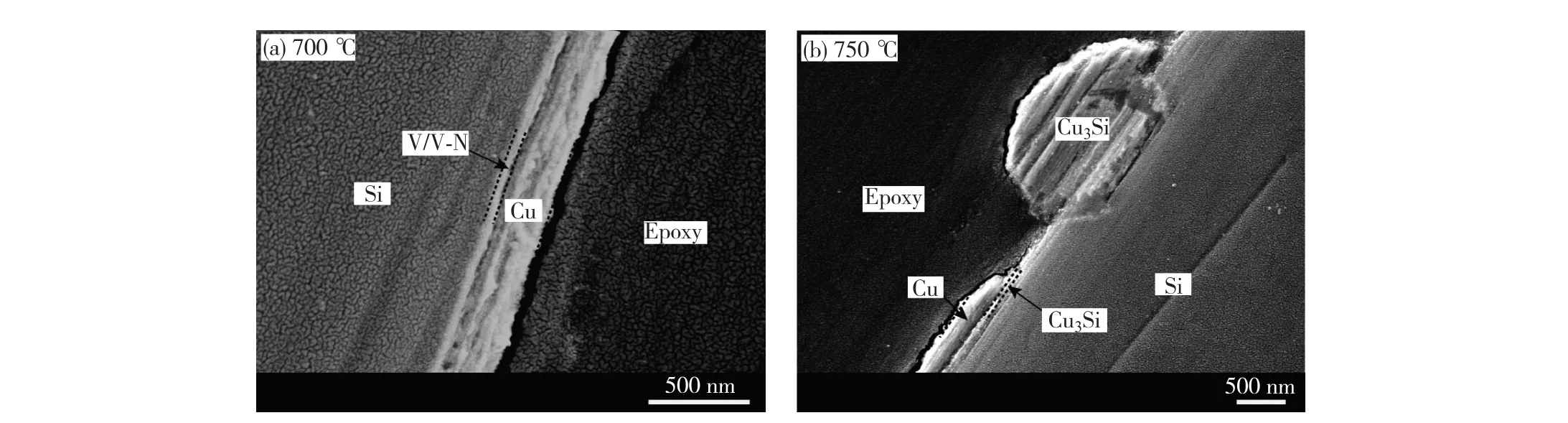
图3 Cu/V/V-N/Si多层薄膜在700℃(a)和750℃(b)热处理1 h后的横截面微观组织形貌图Fig.3 The cross-sectional images of the Cu/V/V-N/Si multilayer films annealed at 700℃(a)and 750℃(b)for 1 h

图4 Cu/V/Si,Cu/V-N/Si和Cu/V/V-N/Si多层薄膜的方块电阻与热处理温度的关系曲线Fig.4 Square resistance of the Cu/V/Si,Cu/V-N/Si and Cu/V/V-N/Si multilayer films as the function of annealing temperature
3 结 论
本研究通过磁控溅射沉积制备了Cu/V/Si,Cu/ V-N/Si和Cu/V/V-N/Si多层薄膜,通过XRD、SEM和FPP分别对薄膜样品的晶体结构、微观组织形貌和方块电阻进行测试表征.实验结果表明:在Cu薄膜与Si基板间引入V、V-N和V/V-N扩散阻挡层后,均能有效抑制Cu向Si基板中的扩散.Cu/V/Si和Cu/VN/Si薄膜样品分别在600和650℃时能够保持良好的热稳定性,没有Cu3Si化合物生成,表明此时V和V-N扩散阻挡层能有效抑制Cu向Si基板中的扩散;而当温度分别升高至650和700℃时,在Cu/V/Si和Cu/V-N/Si薄膜样品中生成Cu3Si化合物,同时引起方块电阻急剧上升,表明V和V-N扩散阻挡层已经失效.堆栈结构的Cu/V/V-N/Si多层薄膜在700℃热处理后依然具有良好的热稳定性和较低的方块电阻,直到温度升至750℃时,V/V-N扩散阻挡层才失效,对比实验结果表明堆栈结构的V/V-N具有更好的扩散阻挡性能.
[1] LI J,LU H S,WANG Y W,et al.Sputtered Ru-Ti,Ru-N and Ru-Ti-N films as Cu diffusion barrier[J].Microelectronic Engineering,2011,88(5):635-640.
[2] 陈剑辉,刘保亭,赵冬月,等.硅基集成电路中Cu互连阻挡层的研究[J].材料导报,2010,24(11):58-63.
[3] LEE C,KUO Y L.The evolution of diffusion barriers in copper metallization[J].JOM,2007,59(1):44-49.
[4] CHAN R,ARUNAGIRI T,ZHANG Y,et al.Diffusion studies of copper on ruthenium thin film a plateable copper diffusion barrier[J].Electrochemical and Solid-State Letters,2004,7(8):G154-G157.
[5] CHU J,LIN C,HSIEH Y.Thermal performance of sputtered insoluble Cu(W)films for advanced barrierless metallization[J].Journal of Electronic Materials,2006,35 (1):76-80.
[6] CHU J,LIN C.Thermal stability of Cu(W)and Cu (Mo)films for advanced barrierless Cu metallization:effects of annealing time[J].Journal of Electronic Materials,2006,35(11):1933-1936.
[7] CHU J,HSIEH Y,LIN C,et al.Thermal stability enhancement in nanostructured Cu films containing insoluble tungsten carbides for metallization[J].Journal of Materials Research,2005,20(6):1379-1384.
[8] 何明智,谢中,周艳明,等.Cu互连中Ta/Ta-N和Ti/Ta-N双层膜的扩散阻挡性能比较[J].材料导报,2014,28 (16):27-31.
[9] TSAI M,SUN S,TSAI C,et al.Comparison of the diffusion barrier properties of chemical vapor deposited TaN and sputtered TaN between Cu and Si[J].Journal of Applied Physics,1996,79(9):6932-6938.
[10] SONG S,LIU Y,MAO D,et al.Diffusion barrier performances of thin Mo,Mo-N and Mo/Mo-N films between Cu and Si[J].Thin Solid Films,2005,476(1): 142-147.
[11] KATTELUS H,YLÖNEN M,BLOMBERG M.Amorphous Mo-N and Mo-Si-N films in microelectromechanical systems[J].Fatigue&Fracture of Engineering Materials&Structures,2005,28(8):743-749.
[12] ROSSNAGEL S,SHERMAN A,TURNER F.Plasmaenhanced atomic layer deposition of Ta and Ti for interconnect diffusion barriers[J].Journal of Vacuum Science &Technology B,2000,18(4):2016-2020.
[13] KIM D J,JUNG Y B,LEE M B,et al.Applicability of ALE TiN films as Cu/Si diffusion barriers[J].Thin Solid Films,2000,372(1):276-283.
[14] TAKEYAMA M B,ITOI T,AOYAGI E,et al.High performance of thin nano-crystalline Zr N diffusion barriers in Cu/Si contact systems[J].Applied Surface Science,2002,190(1):450-454.
[15] TAKEYAMA M B,NOYA A,SAKANISHI K. Diffusion barrier properties of Zr N films in the Cu/Si contact systems[J].Journal of Vacuum Science&Technology B,2000,18(3):1333-1337.
[16] CHUANG J C,TU S L,CHEN M C.Sputtered Cr and reactively sputtered CrNxserving as barrier layers against copper diffusion[J].Journal of the Electrochemical Society,1998,145(12):4290-4296.
Diffusion Barrier Performances of V,V-N and V/V-N Films in Cu Interconnection
WANG Cuiping,DAI Tuo,LU Yong,SHI Zhan,ZHANG Jinbin,LIU Xingjun*
(College of Materials,Xiamen University,Xiamen 361005,China)
The V,V-N and V/V-N diffusion barrier layers with 50 nm thickness were deposited on Si(100)substrates by magnetron sputtering,and then the 300 nm thickness of the Cu films were prepared on diffusion barrier layers to obtain Cu/V/Si,Cu/V-N/Si and Cu/V/V-N/Si multilayer films.The multilayer film samples were subsequently annealed at 300-750℃for 1 h in vacuum atmosphere.The crystal structures,microstructure morphologies and square resistances were characterized by X-ray diffraction(XRD), scanning electron microscope(SEM)and the four-point probe(FPP)methods to investigate the diffusion barrier performances of the V,V-N and V/V-N films.The results show as follows:diffusion barrier layers of V,V-N and V/V-N effectively blocked the diffusion of Cu into the Si substrate.The Cu/V/Si and Cu/V-N/Si multilayer films still kept good thermal stability at the annealing temperature of 600℃and 650℃,respectively.However,for the Cu/V/V-N/Si multilayer film,due to the existence of stacking structure,the samples maintained favorable thermal stability when being annealed at 700℃.Therefore,the stacking structure of the V/V-N film was an ideal diffusion barrier layer.
diffusion barrier layer;barrier performance;stacking structure;magnetron sputtering
O 644
A
0438-0479(2016)06-0810-05
10.6043/j.issn.0438-0479.201604011
2016-04-11 录用日期:2016-04-28
国家自然科学基金(51571168);国家自然科学基金青年基金(51301146);科技部国际科技合作专项(2014DFA53040)
lxj@xmu.edu.cn
王翠萍,戴拖,卢勇,等.Cu互连中V、V-N和V/V-N薄膜的扩散阻挡性能[J].厦门大学学报(自然科学版),2016,55 (6):810-814.
WANG C P,DAI T,LU Y,et al.Diffusion barrier performances of V,V-N and V/V-N films in Cu interconnection[J]. Journal of Xiamen University(Natural Science),2016,55(6):810-814.(in Chinese)

