一种简化衬底模型的SOI MOS变容管模型*
李文钧,陈小川,刘 军
(杭州电子科技大学CAD研究所,杭州310027)
一种简化衬底模型的SOI MOS变容管模型*
李文钧*,陈小川,刘 军
(杭州电子科技大学CAD研究所,杭州310027)
提出一种适用于反型层RF SOI MOS变容管行为表征模型。在BSIMSOI的基础上,模型采用简化的衬底模型和外围射频寄生模型来表征变容管的射频寄生效应,同时采用T、π互转的方式提出参数提取算法。模型最终应用到华虹宏力SOI工艺提供的不同栅指,每栅指长度为1.6μm、宽度为5μm的MOS变容管器件,并且在15 GHz以下,模型与测量数据的CV、QV以及S参数有较好的拟合。在高频情况下,模型既保证了精度又解决了参数提取困难等问题。
SOI MOS变容管;简化衬底模型;数据拟合;参数提取算法
随着4G时代的到来,VCO电路的性能在通信系统中起着至关重要的作用,尤其是在频率捷变雷达、扫频干扰、精确测速、测距等设备中[1]。由于变容管器件的CV和QV特性对VCO电路有重要的影响,因此国内外对变容管的要求越来越高,尤其是在当今RF应用频率持续提高的条件下。近年来,国内外不断研发出新的变容二极管如超突变结变容管[2]和RFMEMS变容管[3]。在众多变容管器件中,MOS变容管因其相比反偏p-n结型变容管可提供更高的品质因数、更低的功耗、更低的相位噪声以及更大的可调范围等优点[4-7],已成为GHz以上VCO设计中最常用的变容管器件。其中SOI工艺下的MOS变容管在太空领域发挥着极其重要的作用[8]。因此研究SOI MOS变容管模型有着重要的研究意义。
在已调研的文献中,MOS变容管的射频模型大致可分为考虑衬底效应和不考虑衬底效应。文献[9]是在基于器件物理的特性上提出了无衬底效应的MOS变容管,其中CV特性采用多项式表达式。文献[10-11]在BSIM模型的基础上提出了MOS变容管射频寄生模型,其模型均考虑了衬底寄生效应。文献[12]在PSP的基础上提出了MOS变容管射频寄生模型,其模型也考虑了衬底效应。虽然SOI工艺和体硅CMOS工艺接近,但是SOI器件存在氧埋层,因此直接沿用体硅CMOS工艺变容管建模方法无法准确描述SOI工艺衬底行为,并引起模型在表征变容管输出端口S-参数精度时产生大的误差,该问题在见于调研的文献中少有工作开展和结果报道,但仍有一些文献提出了SOI变容管的模型,如文献[13-14]都提出了SOI变容管的模型。文献[13]提出了SOI变容管的模型并对提取算法进行了研究,但是文献中并没有考虑到SOI变容管衬底效应。文献[14]虽然在提出的SOI变容管模型中考虑了衬底效应,但是由于衬底的复杂性,文章并没有给出有关衬底参数提取的算法。
由于文献[14]提出的衬底模型较为复杂,因此需要复杂的提取算法才能提取衬底寄生参数,虽然文献[14]提取衬底寄生参数较为困难,但是随着频率的增加必须考虑衬底寄生效应。有鉴于此,本文借鉴了文献[11]的衬底模型并结合SOI特有的结构和文献[10]的SOI MOS变容管模型,提出一种适用于该RF SOI MOS变容管衬底建模的模型。
1 器件和模型描述
由于SOI器件相对于普通的MOS管多了一层掩埋层,因此文章给出了图1所示的SOI工艺制造的体接触MOS变容管器件结构以及模型。图1是在文献[14]的基础上给出了改进的SOI MOS变容管器件的物理结构,以及高频应用下的寄生网络。
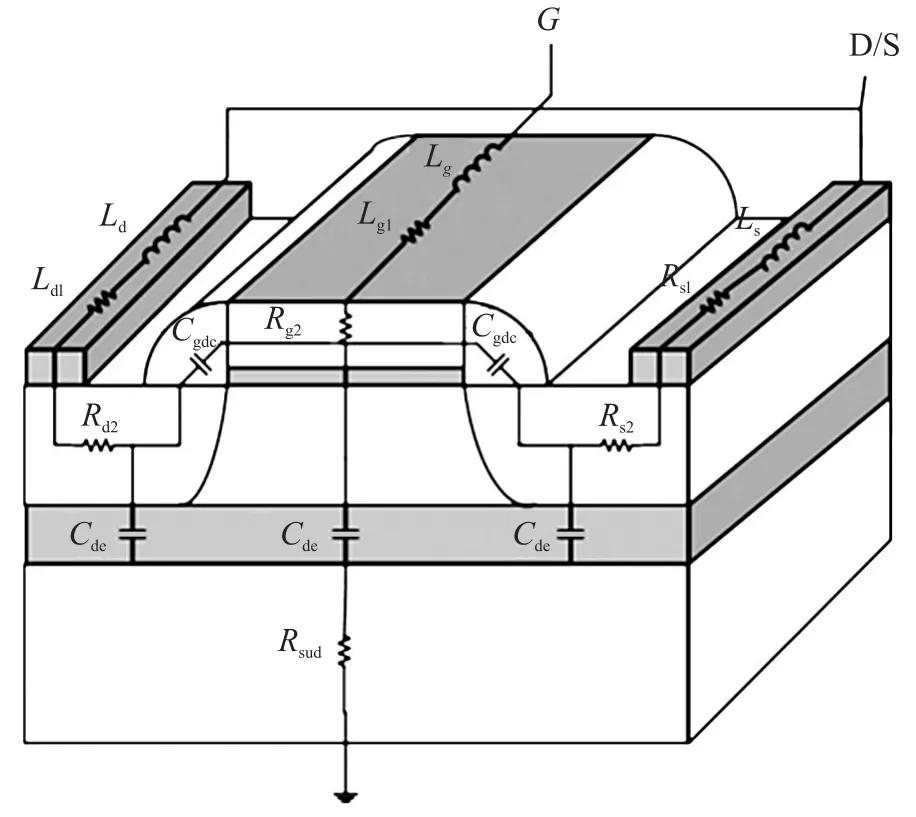
图1 体接触SOI MOS varactor结构及提出的寄生网络模
在图1中,Cgdo和Cgeo分别为栅-漏、栅-源之间的寄生电容以及多指之间的寄生电容。Lg,Ld和Ls别为栅、漏、源端接引线寄生电感。Rg1/d1/s1,Rg2/d2/s2分别为栅、漏、源端接引线高频分布电阻和引线多晶硅接触电阻。Cde,Cbe和Cse分别表征漏、栅、源区对应和衬底隔离层形成的寄生电容。模型引入Rsub表征硅衬底损耗。考虑漏、源短接,图1给出的模型拓扑结构,可简化为如图2(a)所示拓扑结构。由于MOS变容管漏源短接且其具有对称型,因此图2(b)中的Rds表示为(Rs1+Rs2)与(Rd1+Rd2)的并联而图2(b)中的边缘电容Cfr表示为Cgso与Cgdo的值的相加。漏源耦合电容Cdse表示为漏与衬底的耦合电容Cde和源于衬底耦合电容Cse的之和。图2(a)所示的电路拓扑结构图从表面上看类似一个T型的网络结构,但是由于大虚框内的栅到衬底之间的耦合电容与漏源到衬底之间的耦合电容相互短接并通过电阻Rsub连接到地,因此图2(a)所示的电路结构又不能简单的看成是一个T型网络结构。由于图2电路的复杂性,文章将在下面章节通过n-T互转的算法将模型简化为图2(b)所示。
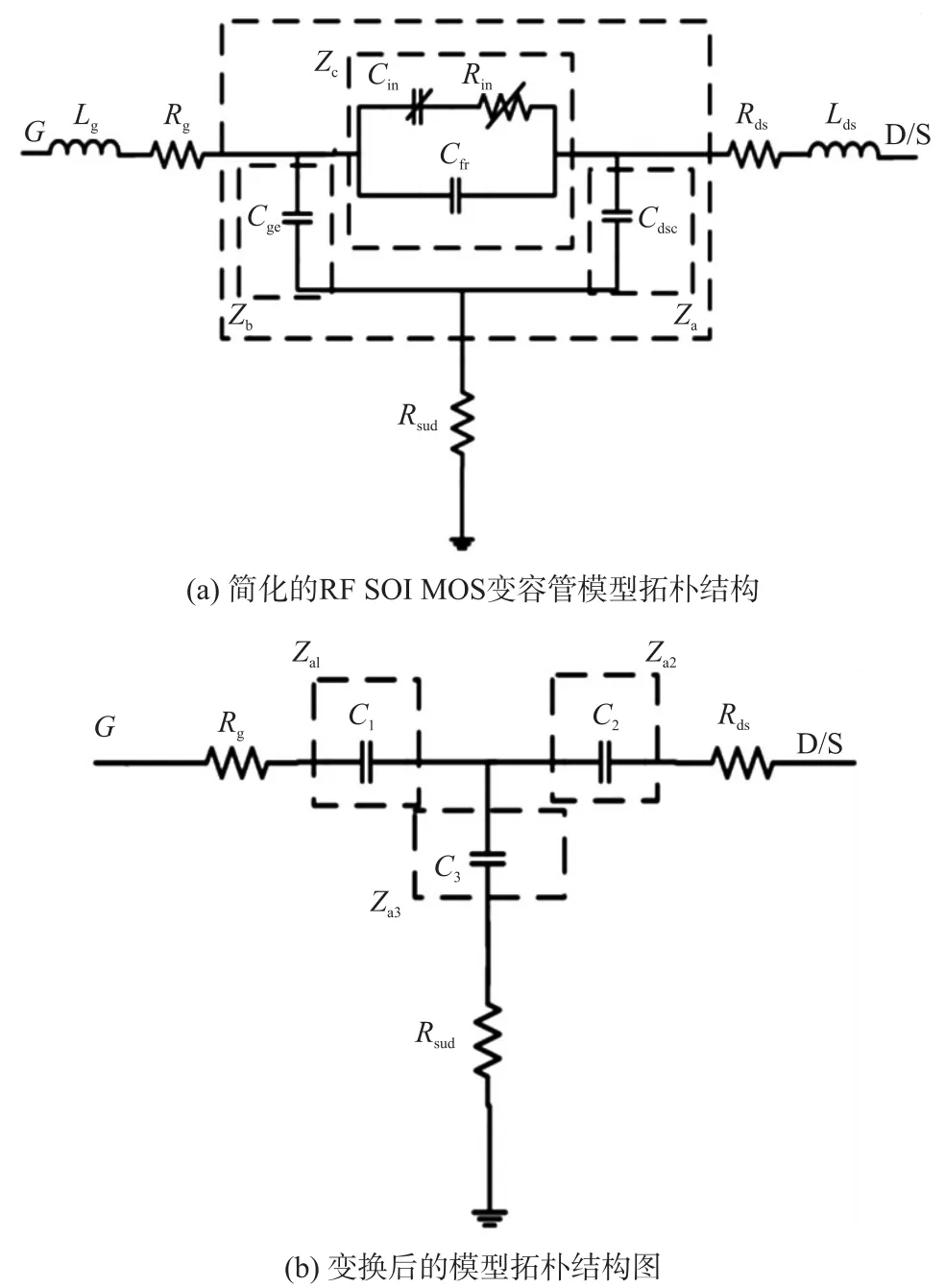
图2 图1的拓扑电路
2 模型分析及参数提取
文章采用华虹宏力SOI工艺提供的16栅指,每栅指长度为1.6μm、宽度为5μm的MOS变容管的抽取过程证明算法的可行性。执行S-参数测试时,合理设计去嵌结构可有效去除引线寄生电感效应。文章研究的变容管模型主要在15 GHz以下,在该频率下可采用两步去嵌法作为文章的去嵌方式。两步去嵌法也就是open+short的去嵌方式,该去嵌方式是目前最常用的去嵌方式。去嵌结构以及去嵌的公式可参照文献[15]。文章考虑到长远的分析,文章通过以下π型转Y型的公式将图2(a)的拓扑结构转换成图2(b)的拓扑结构[15]。


以上公式中Zc的主要表达式如下:

文章在SOI MOS管强反型状态下做参数提取。对依最高值为1 pF左右设计的MOS变容管,Cin随偏压通常在几百fF到1 pF之间变换,Cfr通常为几十fF,Rin在强反型状态下通常在几Ω左右,则在低频下可满足:RinCfrCin<<Cin+Cfr并且Rin2Cin2Cfr2≪Cin+Cfr,又因为Rin足够小,所以可将式(4)做如下简化:

为了抽取Cge和Cdse,文章将结合式(1)、式(2)、式(3)、式(5)和图2的拓扑结构图得到式(6)、式(7)式(8),并对式(6)、式(7)、式(8)做等效变换得到式(9)、式(10):
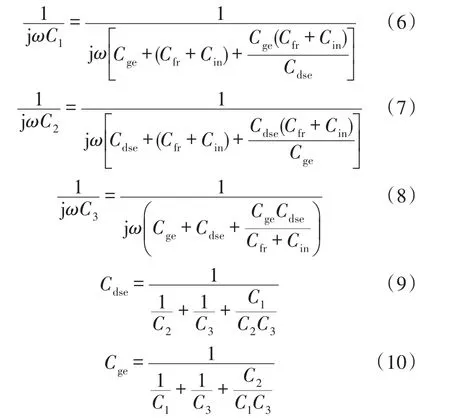
考虑到长远的分析,将去嵌后的S参数转换成Z参数,并通过Z参数结合图2(b)推导如下表达式:

文章通过Z1的实部[Real(Z1)]提取Rg的值并且通过Z1的虚部[Imag(Z1)]提取C1的值。同理可以提取到Rsub,Rds以及C2和C3的值。考虑通过式(11)、式(12)、式(13)已经将C1,C2和C3的值提取出来,Cge和Cdse可以通过式(9)、式(10)提取得到。
3 模型和抽取方法验证
为验证提出模型和模型参数提取算法的可行性,文章采用华虹宏力RF SOI工艺,不同栅指,每栅指长Lf=1.6μm、宽Wf=5μm SOI MOS变容管作为验证器件。采用Agilent E8363B矢量网络分析仪和4156C高精度半导体参数分析仪,对器件S-参数进行了测试,测试使用的探针台为Cacade summit 1101微波探针台。测试结构引入的高频寄生采用OPEN+SHORT去嵌方法进行去嵌,去嵌参考面选择在变容管的引线和栅、漏/源接触面,以此去除短接引线寄生电感效应。去嵌后S-参数转换为Z-参数进行模型参数提取。本文采用的模型参数提取工具为Keysight的IC-CAP软件。
图3和图4同时给出了栅压Vg为1.6 V(强反型)且频率为100 MHz到15.1 GHz,步进值100 MHz条件下测量所得S参数中提取出的曲线。
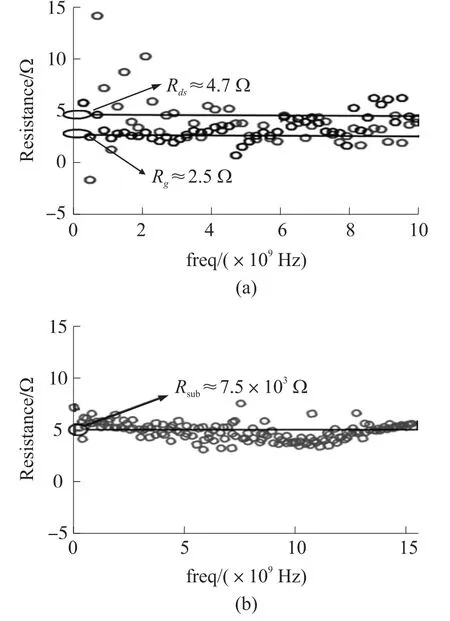
图3 通过Z1,Z2,Z3的实部与Y轴的截点提取Rds,Rg和Rsub[Vg=1.6 V(强反型)]
图3(a)和图3(b)给出了通过公式:Rg=real(Z1),Rds=real(Z2),Rsub=real(Z3)提取得到低频情况下的关于Rg,Rds,Rsub的曲线,通过该曲线与Y轴的截距可提取出参数的值,该值分别为2.5 Ω和4.7 Ω,7.5×103Ω。图4给出了通过式(9)、式(10)求解电容Cdse和Cge的过程,值分别为9.8×10-15F和11×10-15F。图5给出了通过式(C=Im(Y11)/2πf)提取得到的频率为1 GHz,电压为-2 V到2 V步进值0.2 V的曲线,通过该曲线与Y轴的截距可提取到Cfr的值,该值为238×10-15F。
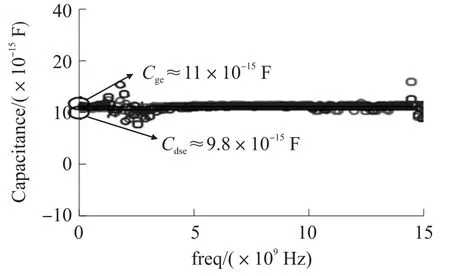
图4 通过Z1,Z2,Z3的虚部(imag(Z)-1)与Y轴的截点提取Cge,Cdse[Vg=1.6 V(强反型)]
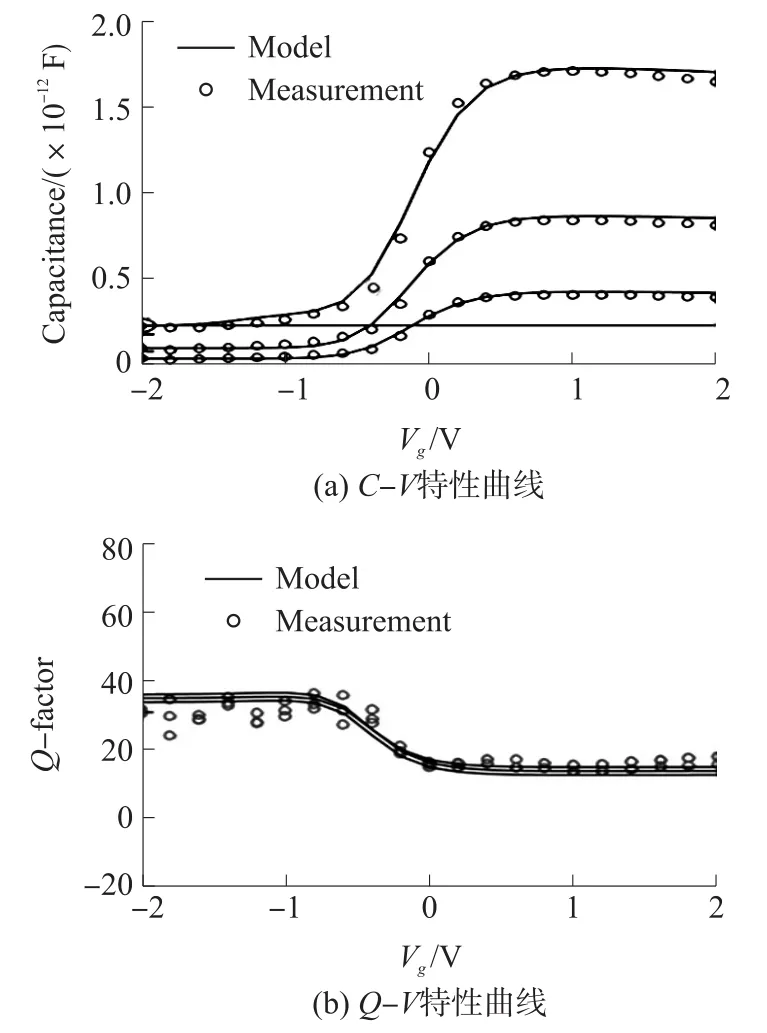
图5 1GHz频率下的C-V特性曲线(a)和Q-V特性曲线(b)
表1给出了解析提取所得模型参数初值。表1同时给出了在提取所得初值基础上,采用IC-CAP工具自带随机优化方法进行最优化得到的模型参数值。采用相对误差(error=|extract-optimize|/optimize)对模型参数初值和最优值进行对比,误差均小于8%,其值在可接受的范围内。表明本文提出解析提取方法有良好精度。

表1 提取Vg=1.6 V(强反型)条件下所得模型参数初值和优化后模型参数值对比
为验证模型精度,基于表1给出模型最优值和图2给出的模型拓扑结构,对模型进行了仿真,仿真器采用Keysight Advanced Design System。图5(a)、5(b)给出了在1 GHz频率下从偏压相关S-参数中计算得到的C-V和Q-V特性曲线对比[C=Im(-Y11)-1/2πf,Q=Im(Y11)/Re(Y11)],模型仿真和测试数据分析结果有良好吻合。图6则给出了Vgs和Vds均为0 V条件下测试和模型仿真所得S-参数对比,在0.1 GHz~15.1 GHz频率范围内,两者有良好吻合,表明模型在15.1 GHz频率范围内,有良好表征精度。
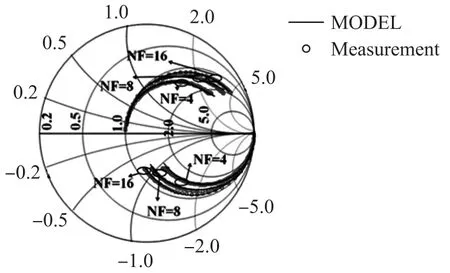
图6 零偏条件下的S11和S12参数曲线
4 结论
文章在研究了MOS变容管模型的发展以及SOI MOS变容管模型的国内外研究状况之后,总结出部分文献的模型引入衬底之后导致衬底参数以及模型其他参数提取较为困难。虽然模型引入衬底结构导致参数提取更加困难,但是随着频率的升高模型必须考虑衬底损耗,因此文章在前人的基础上采用电阻表征衬底寄生效应以此来简化衬底模型和参数提取算法。简化后的模型不仅简化了参数提取算法而且还能精确表征SOI MOS变容管射频特性。简化后的模型以及参数提取算法均采用华虹宏力提供的RF SOI工艺制造MOS变容管进行建模验证。在0.1 GHz~15.1 GHz频率范围内,该模型精确预见了器件C-V、Q-V,以及散射参数特性。
[1]韩钧,马建军.变容管压控振荡器[J].电子器件,2001,24(3):199-202.
[2]钱刚,郝达兵,顾卿.超突变结变容管的设计模型[J].半导体技术,2010,12:1158-1161.
[3]李丽,张志国,赵正平,等.RF MEMS压控振荡器的研制及相位噪声特性研究[J].传感技术学报,2006,19(5):1907-1910.
[4]宁彦卿,王志华,陈弘毅.伪工作点与超宽带CMOS LC VCO设计[J].电子器件,2007,30(2):349-352.
[5]Itano Y,Itoh N,Yoshitomi S.High-Q MOS-Varactor Modeling for mm-Wave VCOs[C]//Microwave Conference Proceedings,2012:202-204.
[6]Hu Jiawei,Li Zhiqun,Li Qin,et al.Accumulation-Model MOS Varactor Modeling for RF Applications Valid Up to 40 GHz[C]//Microwave and Millimeter Wave Technology,2010:885-888.
[7]Debroucke R,Gloria D,Ducatteau D,et al.AttoF MOS VaractorRF Measurement VNA Coupled with Interferometer[C]//Micro⁃wave Measurement Conference(ARFTG),2011 77th ARFTG. IEEE,2011:1-2.
[8]Li Y,Porter W M,Kshirsagar C,et al.Fully-Depleted Silicon-on-Insulator Devices for Radiation Dosimetry in Cancer Therapy[J]. IEEE Transactions on Nuclear Science,2014,61(6):3443-3450.
[9]Maget J,Kraus R,Tiebout M.A Physical Model of a CMOS Varac⁃tor with High Capacitance Tuning Range and Its Application to Simulate a Voltage Controlled Oscillator[C]//Semiconductor De⁃vice Research Symposium,2001:609-612.
[10]Molnar K,Rappitsch G,Huszka Z,et al.MOS Varactor Modeling with a Subcircuit Utilizing the BSIM3v3 Model[J].IEEE Transac⁃tions on Electron Devices,2002,49(7):1206-1211.
[11]Su C Y,Chen L P,Chang S J,et al.BSl M3v3-Based Varactor Model[J].Electronics Letters,2001,37(8):525-527.
[12]Porret A S,Melly T,Enz C C,et al.Design of High-Q Varactors for Low Power Wireless Applications Using a Standard CMOS Process[J].IEEE Journal of Solid State Circuits,2000,35(3):337-345.
[13]Wang J,Roland J,Popp J,et al.High Performance RF SOI MOS⁃FET Varactor Modeling and Design[C]//IEEE Reg 5 Conf,2006:83-86.
[14]Chen K M,Huang G W,Wang S C,et al.Characterization and Modeling of SOI Varactors at Various Temperatures[J].IEEE Transactions on Electron Devices,2004,51(3):252-255.
[15]Hirano T,Okada K,Hirokawa J,et al.Accuracy Investigation of the De-Embedding Technique Using Open and Short Patterns for on-Wafer RF Characterization[C]//Microwave Conference Pro⁃ceedings(APMC),2010:1436-1439.
李文钧(1972-),男,浙江杭州人,杭州电子科技大学CAD研究所副教授,博士,研究方向为RF SOI器件建模和射频/微波SOC技术,liwenjun@hdu.edu.cn;

陈小川(1991-),男,浙江温州人,杭州电子科技大学CAD研究所研究生,硕士,研究方向为RF SOI器件建模,131040014@hdu.edu.cn。
A Simplified Substrate Model for SOI MOS Varactor Model*
LI Wenjun*,CHEN Xiaochuan,LIU Jun
(Key Laboratory for RF Circuits and Systems(Hangzhou Dianzi University),Hangzhou 310027,China)
A compact model for RF SOI MOS varactor characterization is presented.The model adopts the simpli⁃fied loss of SOI substrate and peripheral parasitic RF model to reflect the characterization of varactor RF parasitic effects based on the BSIMSOI.At the meantime,using T π convertion to propose a method to analytically extract the substrate network model parameters.The model has been applied to the devices that have a fixed unit finger width of 5μm and fixed unit finger length of 1.6μm with diverse number of fingers were fabricated by Huahong Grace,and under the 15 GHz,the data of model and measurement about CV,QV and S parameters have better fit⁃ting.In the high frequency,the model can not only ensure the accuracy but also solve the problem of parameter ex⁃traction and so on.
RF SOI Varactor;simplified loss of SOI substate;fitting data;Parameter extraction algorithm

TN386.1
A
1005-9490(2016)06-1297-05
2570F
10.3969/j.issn.1005-9490.2016.06.004
项目来源:国家自然科学基金项目(61372021)
2015-11-27 修改日期:2016-01-13

