不同磁控溅射方式制备的C掺杂h-BN薄膜微观结构与导电性研究
姜思宇,熊 芬,吴 隽,祝柏林,郭才胜,姚亚刚,甘章华,刘 静
(1.武汉科技大学,省部共建耐火材料与冶金国家重点实验室,武汉 430081;2.中国科学院苏州纳米技术与纳米仿生研究所,苏州 215123)
1 引 言
作为一种物理化学性质优良的宽禁带(5.97 eV)[1]Ⅲ-Ⅴ族半导体材料,六方氮化硼(h-BN)具有介电常数低、导热性和电绝缘性能优良等性质[2]。通过掺入C[3]、Si[4]或Be[5]、Mg[6]等元素更可实现n型或p型掺杂,在深紫外光探测器件以及栅极绝缘材料等领域具有广阔应用前景[7]。其中,由于石墨与h-BN在结构上极为相似,碳原子可以被掺杂进h-BN晶格替代部分硼或者氮原子而成为优良的半导体材料[8]。理论计算与实验研究均表明:掺杂C的h-BN(h-BN∶C)薄膜可结合石墨与氮化硼的特性,具有耐磨、耐高温、化学稳定性好等一系列优良点。此外,由于带隙可调的特性,h-BN∶C薄膜在电学、光学等领域也有着十分广泛的应用前景[9]。
化学气相沉积(CVD)是目前制备BN薄膜的最常见方法之一。早在1993年,Smeets等即采用CVD法利用B2H6与N2制备出表面粗糙呈花椰菜状的BN薄膜[10]。近年来,许多学者采用CVD及其衍生方法在1000 ℃左右生长出了h-BN[11]和BCN[12]等薄膜。由于CVD方法存在制备温度高、生长时间长等工艺上的不足,且通常用作硼源前驱体的硼烷具有较大毒性。因此物理气相沉积(PVD)方法,如脉冲激光沉积[13]、离子束辅助沉积[14]、直流(DC)与射频(RF)磁控溅射[15]等,成为一种安全而便捷的制备BN薄膜的优选方法之一。中频双极脉冲(IFBP)磁控溅射是一种较新颖的PVD沉积方法,相比其它磁控溅射方法,IFBP可以消除因靶中毒产生的电弧问题,且具有较快的沉积速率[16-17]。学者采用IFBP方法成功制备了具有层状结构的TiO薄膜[18]和低应力的Cu薄膜[19],Tsai等采用脉冲直流磁控溅射法制备出了含量达82%的立方氮化硼(c-BN)[20]。因此,IFBP磁控溅射在薄膜制备领域中存在较广泛的应用前景和潜力。
鉴于IFBP磁控溅射以及作为最典型PVD之一的RF磁控溅射的一系列优点,本文分别使用IFBP和RF磁控溅射法沉积制备 h-BN∶C薄膜,然后在95%Ar+5%H2混合气氛中于700 ℃进行退火处理。对比研究不同溅射沉积方法制备的h-BN∶C薄膜的显微结构、表面形貌、化学组成以及各元素的化学态,同时研究退火处理的影响。在此基础上采用典型两探针法对其导电性进行表征,并对有关结果进行解析和讨论。
2 实 验
2.1 h-BN∶C薄膜的制备

图1 IFBP电源波形示意图 Fig.1 Schematic diagram of the waveform of IFBP power source
采用FJL500型高真空多功能磁控溅射仪溅射沉积薄膜。RF电源为中国科学院电子研究所产,最大功率和频率分别为500 W和13.56 MHz;IFBP电源为北京精益达明电子科技公司产,最大输出功率、频率及占空比分别为1000 W、40 kHz和50%,其工作时的波形图如图1所示。靶材为直径60 mm的掺杂单质石墨的h-BN热压靶(厂家直购,h-BN与石墨质量比约为2∶1)。基底为单面抛光硅(Si)片。沉积前,将Si基片依次置于清洗液、无水乙醇、HPM(VHCl∶VH2O2∶VH2O=1∶2∶4)溶液以及丙酮中分别用超声波清洗15 min以去除基底表面氧化和污染。将清洗干净并吹干的Si基底放入溅射室后,调节靶材与Si基底间距离至48 cm并固定,抽真空使本底真空度达到8.0×10-4Pa。溅射气氛为高纯(99.999%)氩气、氮气和氢气的混合气氛,流量分别控制在42sccm、12sccm和6sccm,总溅射气压维持在1.0 Pa左右;溅射沉积时,根据相关文献及之前的实验研究[21],确立本实验中制备h-BN最佳的溅射功率、沉积时间和基底温度分别为200 W、90 min和室温。沉积后,将部分样品放入管式炉中于700 ℃进行退火处理,升降温速度均为10 ℃/min,保温时间为45 min,退火气氛为95%高纯(99.999%) Ar+5%高纯(99.999%)H2的混合气氛。
2.2 h-BN∶C薄膜的表征
采用日本Horiba公司所产的LABRAM HR型显微拉曼光谱仪对薄膜结构进行分析,以波长532 nm的激光作为激发光源,激光功率为10 mW左右;采用X’pert PRO MPD型X射线衍射仪进行结晶度与相结构分析;利用日本岛津(Kratos)公司产Axis Ultra DLD-600W型X射线光电子能谱仪(XPS)对h-BN薄膜样品元素成分进行XPS分析,其中X射线源为Al Kα(1486.6 eV);采用美国Agilent Technologies产5500型原子力显微镜(AFM)对h-BN∶C薄膜表面形貌进行表征并对薄膜表面粗糙度进行测量;采用典型两探针法对薄膜的导电性进行表征。
3 结果与讨论
3.1 h-BN∶C薄膜结构分析
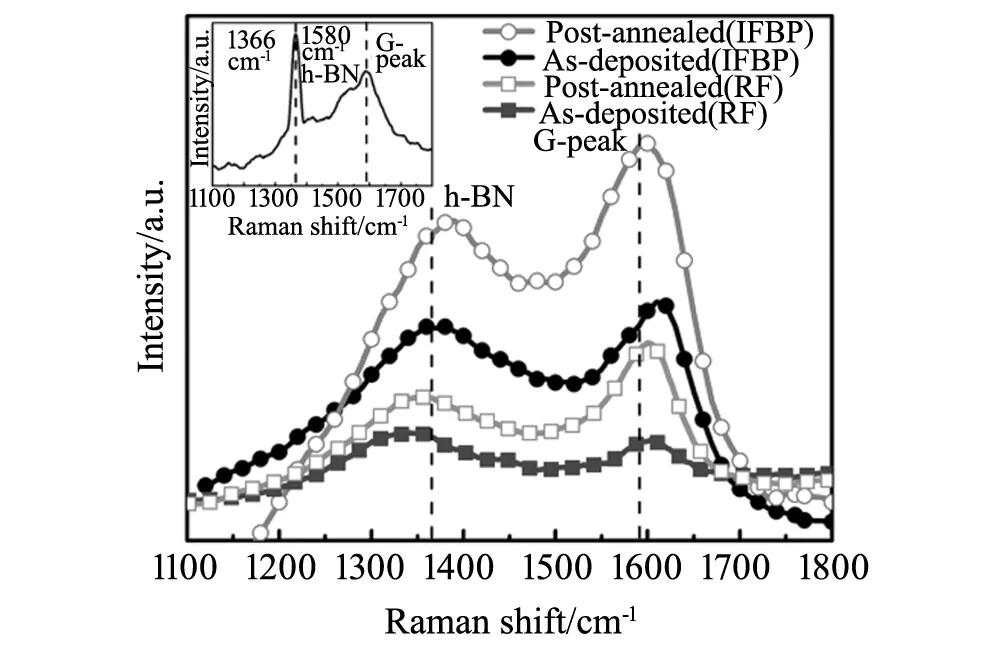
图2 掺杂石墨C的h-BN靶和不同溅射方法制备沉积态与退火态h-BN∶C薄膜的拉曼光谱 Fig.2 Raman spectra of the C doped h-BN target and the as-deposited and post-annealed h-BN∶C films prepared by different sputtering methods
两种溅射方法制备的沉积态和经45 min退火后的退火态h-BN∶C薄膜的拉曼谱如图2所示,插图为掺杂单质石墨C的h-BN靶的拉曼谱。由靶的拉曼谱可知掺杂单质石墨C的h-BN靶在1366 cm-1和1585 cm-1附近出现了两个拉曼峰。其中位于1366 cm-1左右的拉曼峰为h-BN的E2g特征峰[22],该峰强度高且尖锐,说明h-BN结晶性好;位于1585 cm-1附近的拉曼峰则对应sp2杂化碳的石墨(G)峰[23],该峰强度较弱而且半高宽较大,表明碳可能呈无定形态。与靶相似,所有薄膜的拉曼谱中也均存在两个分别位于1366 cm-1左右与h-BN的E2g特征峰对应以及位于1585 cm-1附近与石墨C的G峰对应的拉曼峰,表明h-BN∶C薄膜中存在h-BN和sp2杂化碳的石墨结构。根据相关报道得知[24],B、N和C之间要形成理想共价键需要克服较高势垒,因而采用PVD尤其低温下沉积的h-BN薄膜中存在大量悬挂键等缺陷,在空气中极不稳定,在潮湿的环境下极易与空气中的氧、水蒸气等反应而水解。为改善沉积态h-BN薄膜的稳定性,在溅射气体介质中掺入一定量(5%)氢气,使H原子与沉积B、N原子的悬挂键结合,可显著提高沉积态的h-BN的稳定性。在后续退火处理中,H原子脱离溢出,B、N、C原子间最终形成稳定的共价键。此外,拉曼谱显示所有样品的G峰都向高波数方向发生了偏移,这可能是由于h-BN薄膜中的掺杂C元素促进了(B-)C-N成键,而抑制了C芳环簇的形成[25]。对比两种不同溅射方法沉积的h-BN∶C薄膜的拉曼峰,可明显观察到采用IFBP制备的样品的拉曼峰较RF磁控溅射的强,其中IFBP制备沉积态与退火态薄膜h-BN拉曼峰半高宽分别为129 cm-1与92 cm-1,RF制备的薄膜对应半高宽为132 cm-1与143 cm-1,表明前者制备的h-BN∶C薄膜样品的结晶性更好。同时,对于相同溅射方法制备的h-BN∶C薄膜,退火处理后其结晶性也明显得到了改善。IFBP与RF制备薄膜的XRD衍射图分别如图3(a)、(b)所示。对比h-BN与SiO2的标准PDF卡片(JCPDDS 85-1068、JCPDDS 74-0201)可观察到,在RF制备沉积态薄膜中出现了SiO2(103)、SiO2(123)与SiO2(213)的衍射峰,其中SiO2来自Si衬底的干扰,说明在沉积态h-BN∶C薄膜中结晶性较弱,多为无定型态,而经过退火处理后,薄膜中出现了明显的h-BN(002)强衍射峰,同时其他衍射峰强度峰减弱,结晶性得到了显著提升;在IFBP制备的薄膜中可观察到h-BN(101)与SiO2(103)的衍射峰,且经过退火处理后,对应衍射峰强度得到增强,薄膜结晶性同样得到改善。这两种方法制备得到的h-BN由于晶粒取向不同,固在形貌上存在较大差异,这与文中AFM表面形貌结果相一致,其中IFBP制备样品主要为颗粒状生长,而RF制备样品则为明显层状结构。
为进一步分析h-BN∶C薄膜的化学成分、各元素的化学价态以及化学键合情况,对上述薄膜进行了高分辨XPS分析。图4(a)~(d)为各样品的B 1s峰,通过高斯函数拟合,所有样品的B 1s均可分解为两个位于190.6~191.5 eV和189.9~190.6 eV的子峰。文献报道:位于190.6~191.5 eV的子峰对应于BN中的B 1s[26-27];Pan和Gómez等研究发现BCN中的B 1s处于~191.0 eV[28-29],而Dinescu和Perrone等则发现BCN中的B 1s位于~188.0 eV[30-31];Abdul等更研究指出由于BCN薄膜中B原子生长环境和成分的差异,BCN中B 1s的结合能可在较宽范围(188.0~191.0 eV)变化。综上可知本研究中位于189.9~190.6 eV的子峰应对应于B-C-N中的B 1s。更进一步地,由于h-BN薄膜中B-N键结构的特殊性,在高于B 1s主峰6.8~7.4 eV的位置会出现一个峰形较宽的π键伴峰[32]。在本实验中,使用IFBP制备的h-BN∶C薄膜的B 1s谱中均存在明显的π键伴峰,而在RF制备的h-BN∶C薄膜中则没有发现,这表明IFBP方法沉积的薄膜主要为h-BN结构,具体如图3(a)和(b)所示。

图3 不同溅射方法制备沉积态与退火态h-BN∶C薄膜的XRD图谱 Fig.3 XRD patterns of the as-deposited and post-annealed h-BN∶C films prepared by different sputtering methods

图4 不同方法制备的沉积态和退火态h-BN∶C薄膜的B 1s、N 1s和C 1sXPS谱。B 1s:(a)IFBP制备沉积态,(b)IFBP制备退火态,(c)RF制备沉积态,(d)RF制备退火态;N 1s:(e)IFBP制备沉积态,(f)IFBP制备退火态,(g)RF制备沉积态,(h)RF制备退火态;C 1s:(i)IFBP制备沉积态,(j)IFBP制备退火态,(k)RF制备沉积态,(l)RF制备退火态 Fig.4 XPS of as-deposited and post-annealed h-BN∶C films prepared by different Sputtering method. B 1s:(a)as-deposited by IFBP, (b)post-annealed by IFBP, (c)as-deposited by RF, (d)post-annealed by RF; N 1s:(e)as-deposited by IFBP, (f)post-annealed by IFBP, (g)as-deposited by RF, (h)post-annealed by RF; C 1s:(i)as-deposited by IFBP, (j)post-annealed by IFBP, (k)as-deposited by RF, (l)post-annealed by RF
上述样品的N 1s峰通过高斯函数拟合可分解为三个分别于~398.0 eV、398.6~399.5 eV和399.7~400.7 eV的子峰,具体如图4(e)~(h)所示。根据文献,BN中的N 1s一般位于397.3~398.7 eV[33-34]。因此,本实验中位于398.0 eV附近的子峰对应BN中的N 1s。Prakash和Zhou等研究认为N=C双键和N-C单键的N 1s一般处于~400 eV和398~399 eV[35]。据此可以认为所有h-BN∶C薄膜中同时存在N=C双键和N-C单键,说明C已掺入h-BN晶格并与N形成了化学键合。此外,通过对比还可发现,无论是RF还是IFBP制备的h-BN∶C薄膜,退火处理后,其N=C双键所占比例均高于沉积态的。
图4(i)~(l)为各样品的C 1s峰及其高斯函数拟合。结果显示:所有样品的C 1s峰均可拟合为五个子峰,分别位于~285 eV、284.5~284.7 eV、285.4~286.6 eV、286.6~287.1 eV和288.8~289.2 eV。尽管样品在进行XPS分析前均进行了约10秒的Ar溅射清洗以去除表面杂质,但XPS分析时仍均以处于285 eV的C 1s为内标确定各峰峰位。因此,位于285 eV的C 1s也可能来自沾污C。根据文献报道,BC3或B4C的C 1s结合能约为284.5 eV[36-37]。尽管在B 1s分析时发现了存在B-C-N而没有发现B和C原子直接键合的证据,但位于284.5~284.7 eV的子峰仍可归于C-B键。而位于285.4~286.6 eV和286.6~287.1 eV的子峰则可分别对应于(sp2)C-N[33]与(sp3)C-N[38]。位于289~288 eV较高结合能的子峰主要来自污染的CO2[39]。对比发现IFBP法制备的沉积态h-BN∶C薄膜中的C以(sp2)C-N键合为主,退火后与B和N原子的键合增强,但沾污CO2较多,即便在95%Ar+5%H2混合气氛中经700 ℃退火处理45 min后仍有CO2存在;相比之下,RF制备的沉积态h-BN∶C薄膜中的沾污CO2较少,退火后基本被清除。而且退火后C也以(sp2)C-N键合为主,与B和N原子的键合也明显增强。综上分析可知:采用IFBP和RF两种溅射沉积方法结合700 ℃低温退火处理均制备出了h-BN∶C薄膜,而且C元素已经掺入h-BN晶格中并与B和N形成了较好的化学键合,其中IFBP结合低温退火处理制备的h-BN∶C薄膜中的C分布更加均匀。

图5 h-BN∶C 的原子结构模型图 Fig.5 Model diagram of atomic structure of C doped h-BN films
综合拉曼和XPS分析结果可以认为两种溅射方法制备的退火态h-BN∶C薄膜主要保持了h-BN和石墨C的蜂窝状六元环结构,C原子取代部分B和/或N原子,形成B-C、N=C与N-C、B-C-N等化学键。由于拉曼谱显示有石墨特征峰,而且XPS分析显示有C,尽管这些C有可能部分来自沾污C但仍说明掺杂的C原子很可能发生了一定聚集,由于h-BN和石墨C均为六元环结构,因而表现出了石墨C结构。综上分析可绘出h-BN∶C薄膜的单层原子结构模型,具体如图5所示。两种溅射方法制备的沉积态h-BN∶C薄膜的结构与退火态一样,只是结晶性更差,悬挂键更多。沉积过程中,这些悬挂键与溅射气氛中活泼的H原子结合,从而使h-BN∶C薄膜稳定性得到显著提高。
3.2 h-BN∶C薄膜表面形貌分析
图6为上述各样品表面的AFM图像。从图中可以明显看出在Si基底上已经成功生长出了连续的h-BN∶C薄膜。其中图6(a)、(c)分别为IFBP与RF磁控溅射方法制备的沉积态h-BN∶C薄膜,可以观察到这两种方法制备的沉积态h-BN∶C薄膜表面均由分布均匀且致密细小的颗粒组成,表面较平整,均方根(RMS)表面粗糙度为0.715 nm。图6(b)、(d)分别为经700 ℃退火处理的退火态h-BN∶C薄膜,相对于沉积态而言, IFBP制备的退火态h-BN∶C薄膜仍保持了颗粒状,但颗粒已明显长大,同时表面粗糙度也明显增加,RMS达到约8.08 nm。与之相比,RF制备的h-BN∶C薄膜退火后形貌发生了显著变化,由之前极为细小的颗粒状转变成了片层状。前面的拉曼谱与XRD衍射图也显示RF制备的沉积态h-BN∶C薄膜的E2g峰极弱且宽,表明其结晶性较差,多呈无序态;而IFBP制备的沉积态h-BN∶C薄膜的E2g峰相对较强,表明结晶性相对较好。一般而言,PVD法制备的薄膜的结晶性、形貌和形态与沉积原子的能量和可动性密切相关。在本实验中,所有溅射沉积温度均保持在室温左右,沉积在Si基底上的B、N和C原子能量较低、可动性较差,难以长距离迁移,而且B、N、C之间要形成理想共价键需要克服较高势垒。因此,沉积态的h-BN∶C薄膜的结晶性较差,存在较多悬挂键。其中,在溅射功率相同的情况下,RF溅射沉积的B、N和C原子能量更低,成键状况和结晶性更差,悬挂键更多。在退火过程中,随着温度的升高,原子的能量升高,可动性增强,B、N和C原子通过迁移形成了稳定共价键。这说明退火处理提高了h-BN∶C薄膜的结晶性。而且,正由于不同溅射方式下制备的沉积态h-BN∶C薄膜在晶粒取向、成键状况、结晶性以及悬挂键多少方面存在明显差异,导致退火后h-BN∶C薄膜的形貌出现了显著不同。能量高、结晶性和成键状况较好的IFBP制备的h-BN∶C薄膜在退火处理后仍保持了颗粒状,但颗粒已明显长大;而RF制备的结晶性和成键状况均较差的h-BN∶C薄膜经退火处理后则由极为细小的颗粒状转变成了片层状。图6(e),(f)为IFBP制备h-BN∶C薄膜表面与基底之间台阶区域及其选取横断面轮廓变化图。从图中可以进一步证实得到薄膜的厚度约为160 nm左右。

图6 不同溅射方法制备沉积态与退火态h-BN∶C薄膜的表面形貌图像 (a)IFBP-DC制备沉积态;(b)IFBP制备退火态;(c)RF制备沉积态;(d)RF制备退火态;(e)表面与基底台阶面;(f)台阶区域选取横断面轮廓图 Fig.6 AFM images of the as-deposited and post-annealed h-BN∶C films prepared by different sputtering methods (a)as-deposited by IFBP;(b)post-annealed by IFBP;(d)as-deposited by RF;(e)step between films and substrate;(f)cross-sectional profile for selected area
3.3 h-BN∶C薄膜导电性分析
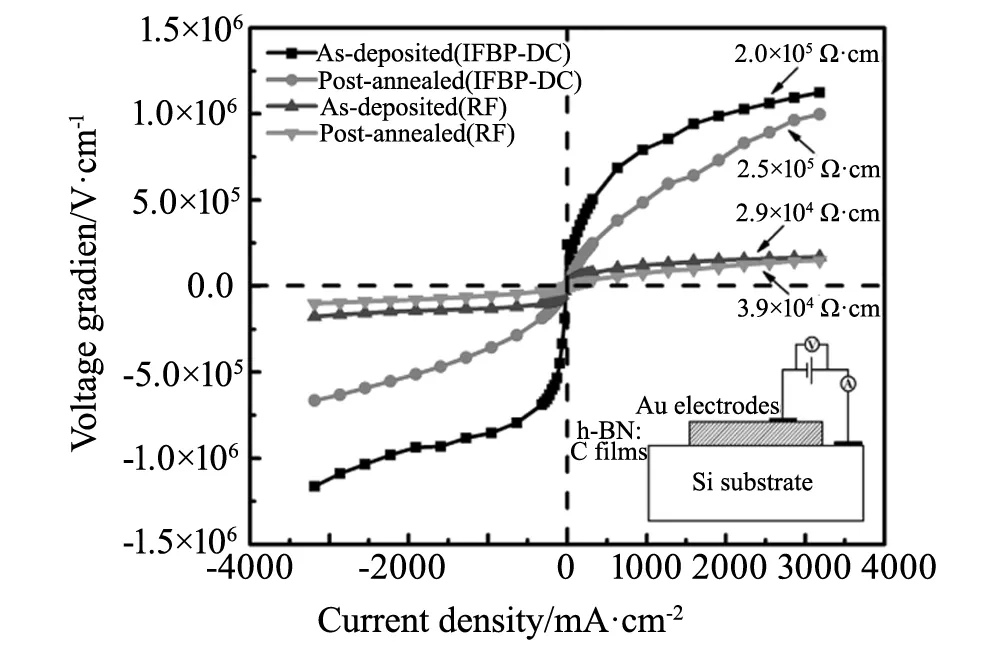
图7 不同溅射方法制备沉积态与退火态h-BN∶C薄膜的电流密度-电压梯度(J-E)曲线 Fig.7 J-E curves of as-deposited and posy-annealed h-BN∶C films prepared by different sputtering method
为了研究掺杂对h-BN薄膜导电性的影响,首先查阅了相关文献报道得知纯h-BN在室温下电阻率较大,约为1010~1016Ω·cm[2],而单质石墨室温下导电性较好,电阻率约为(5~10)×10-5Ω·cm。且对掺杂单质石墨氮化硼靶材的电阻率进行了测量,其电阻率约为6.37×10-3Ω·cm,表明掺碳氮化硼靶具有优良导电性,但与单质石墨碳的电阻率相比有明显升高。h-BN∶C薄膜的导电性是按照图7插图中的电路示意图测得的J-E曲线计算得出。在图7中可观察到所有样品的J-E曲线均具有好的对称性,并由线性与非线性两部分组成。根据相关报道,可知J-E曲线中线性部分与非线性部分分别对应于欧姆与空间电流限制(SCLC)特性,其中SCLC特性的出现表示样品中存在势垒,这是由于在晶界中或者薄膜沉积过程中产生的缺陷所导致。这种SCLC特性也曾在其他学者的研究结果中出现,Shishonok等[40]对出现在n型掺杂h-BN中的SCLC特性进行了理论分析,发现其受势垒强度的影响。此外,在何斌等[41]通过离子注入法将Be掺杂至BN薄膜的报道中,同样也发现了SCLC特性。当输入电流加大到一定程度后,势垒将被克服,J-E曲线呈线性规律,根据拟合线性部分可计算出使用IFBP与RF制备的样品电阻率分别约为2.0×105Ω·cm和2.5×105Ω·cm,这与郭宁等通过CVD法制备的BCN薄膜中垂直电阻率(55 kΩ·cm)相接近[42]。薄膜电阻率相比靶材而言也显著升高,更比单质C的电阻率高,同时远低于纯BN的电阻率,说明本文中C掺杂BN薄膜电阻率降低主要是因为掺杂C所致,且C与其它元素形成了化学键。经过700 ℃退火处理后,相应的样品电阻率分别为2.9×104Ω·cm与3.9×104Ω·cm。表明退火处理在保持结构稳定的同时对薄膜导电性尚未有显著影响。此外,对比两种制备方法可知RF制备的样品的导电性要优于IFBP制备的,根据AFM表面形貌结果推测出这可能是由于RF所制备薄膜表面层状面积更完整,薄膜连续性更好,同时IFBP制备薄膜颗粒细小,对电子波散射强,从而导电性较差。
4 结 论
(1)采用RF与IFBP磁控溅射结合700 ℃低温退火均制备出了连续、稳定而致密的h-BN∶C薄膜,实现了大面积h-BN∶C薄膜的低温制备。
(2)溅射气体中掺入的少量氢气有助于提高沉积态h-BN∶C薄膜的稳定性。此外,沉积后的退火处理更能显著提高h-BN∶C薄膜稳定性、结晶性以及键合情况。但由于不同溅射方式下制备的沉积态h-BN∶C薄膜在成键状况、结晶性以及悬挂键数量方面存在明显差异,退火后h-BN∶C薄膜的形貌也出现了显著差异。其中IFBP制备的h-BN∶C薄膜能量高、结晶性和成键状况较好,退火处理后颗粒明显长大,分布致密且结晶度高;而RF磁控溅射制备h-BN∶C薄膜经退火处理后则由极为细小的颗粒状转变成了片层状。
(3)上述两种工艺路线均实现了h-BN薄膜的C元素掺杂,掺杂后h-BN∶C薄膜的电阻率降低至2.9×104~2.5×105Ω·cm,导电性显著提高。

