垒层温度对InGaN量子点/量子阱复合结构内量子效率的影响
平 晨,贾志刚,董海亮,张爱琴,许并社,3
(1.太原理工大学,新材料界面科学与工程教育部重点实验室,太原 030024;2.太原理工大学轻纺工程学院, 太原 030024;3.陕西科技大学,材料原子·分子科学研究所,西安 710021)
0 引 言
GaN基蓝光LED技术已极为成熟,并实现商业化,已在照明、显示等领域得到广泛应用[1-3]。蓝光LED能够实现80%高外量子效率(external quantum efficiency, EQE)[4]。然而,当发射波长红移至绿光波段时,其EQE随波长的增加而急剧下降[5],这就是所谓的“Green Gap”问题[5-7]。导致“Green GaP”问题的主要原因有两个:(1)InGaN和GaN之间的晶格失配以及铟相分离导致晶体质量下降[8]; (2)InGaN/GaN多量子阱中的强极化效应,也被称为应变诱导压电极化场引起的量子限制斯塔克效应(quantum confined Stark effect, QCSE)[9]。QCSE减小了电子和空穴波函数之间的重叠积分,导致辐射复合效率下降[10],降低了内量子效率。研究人员已经提出了许多解决该问题的方法。例如,使用量子点[11]等纳米结构[12]代替传统的量子阱结构,或者使用交错型量子阱结构[13]。2015年,Jiang等[6]采用了复合量子阱结构,在绿光范围内,随着In组分的增加,内量子效率得到提升。该复合结构中缺陷密度降低,晶体质量得到提高,并且具有更强的载流子局域化效应,可以进一步防止载流子被非辐射复合中心俘获,从而提高了内量子效率。在之前的研究中发现,由于高密度V型坑的形成,样品表面形成了明显的三维岛状形貌,成为一种量子点/量子阱(QD/QW)复合结构,有效提高了内量子效率[14-16]。
在本文中,通过更改势垒层的生长温度(S1: 830 ℃;S2: 840 ℃;S3: 850 ℃),对量子点/量子阱复合结构进行优化,提高了其内量子效率。可以注意到,随着垒层生长温度的降低,虽然载流子局域化效应有所减弱,但缺陷密度也同时降低,量子限制斯塔克效应的影响下降,内量子效率明显提升。
1 实 验
1.1 InGaN量子点/量子阱结构制备
采用金属有机化学气相沉积技术(metal-organic chemical vapor deposition, MOCVD)在c面(0001)蓝宝石衬底上制备了三个不同垒层温度的样品。外延工艺中使用的三族源是三甲基镓(TMGa)、三乙基镓(TEGa)和三甲基铟(TMIn),五族源是NH3、N2和H2作为载气。首先将衬底置于1 120 ℃的氢(H2)气氛中6 min,以清除衬底表面杂质。然后通入TMGa,在530 ℃下生长25 nm厚的GaN成核层。升温至1 070 ℃对成核层进行退火后,通入TEGa,生长3 μm未故意掺杂的GaN。最后,载气从H2转换为N2,并通入TEGa和TMIn生长六周期的InGaN/GaN多量子阱。InGaN阱层的生长温度为700 ℃。为了防止铟组分在升温过程中从阱层脱附,在每个InGaN阱层之后,生长温度不变,立即沉积1 nm厚的GaN层(u-GaN),用于在升温过程中保护InGaN量子阱。共制备了3个样品S1、S2、S3,垒层生长温度分别为830 ℃、840 ℃和850 ℃,其他的生长参数保持不变。
1.2 样品结构与性能表征
在样品的测试表征中,采用了轻敲模式原子力显微镜(atomic force microscopy, AFM)观察样品的表面形貌;采用扫描透射电子显微镜(scanning transmission electron microscopy, STEM)观察样品截面元素分布、微观结构、缺陷等结构性质。分别采用变功率光致发光谱和变温光致发光谱研究了样品的QCSE和载流子局域化效应。用266 nm连续波激光,分别记录了激发功率密度为1.3 W/cm2、4.9 W/cm2、15.4 W/cm2及43.2 W/cm2时三个样品的光致发光谱;用325 nm的连续波激光器,在2.65 W/cm2的激发功率下,记录了10~300 K范围内的变温光致发光谱。
2 结果与讨论
2.1 形貌分析
用AFM对这三个样品表面形貌进行观察。图1(a)、(b) 和(c)展示了样品S1、S2和S3的三维(3D)AFM照片。所有样品的表面形貌呈现出明显的三维岛状形貌,并且表面形貌随垒层温度(S1: 830 ℃;S2: 840 ℃;S3: 850 ℃)的变化而变化。利用SPIWIN-AFM软件分别对样品S1,S2,S3的AFM照片进行了处理,得到了这三个样品的表面岛的最大高度(maximum height),均方根粗糙度(root mean squareroughness, RMS),并将这些数据整理在表1中。从表1中可以得知,样品S1、S2、S3的岛的最大高度分别为28.41 nm、25.53 nm和16.67 nm。岛的最大高度和样品表面均方根粗糙度都随着垒层温度的升高而降低,这些变化规律将在下文进一步分析。
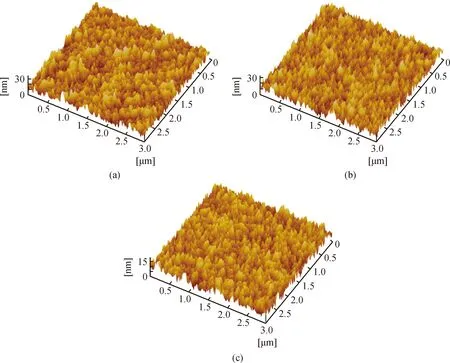
图1 样品S1 (a)、S2 (b)、S3 (c)的3D AFM照片Fig.1 3D AFM images of sample S1 (a), S2 (b) and S3 (c)

表1 AFM照片数据分析结果Table 1 AFM images data analysis results
2.2 岛状形貌形成机制分析
为了进一步分析这些岛的形成机制,图2(a)和(b)分别为S2样品横截面的高角环形暗场像(high-angle annular dark-field imaging, HAADF)和能量色散谱(energy dispersive spectrometer, EDS)。在图2(a)中可以清晰地看到所有凹坑都是V型坑,因为这些凹坑的{10-11}侧壁与c平面形成62°角,这与之前的报道一致[17-18]。通过大量的研究表明,V 型坑的形成可能来源于穿透位错、堆垛层错、反相畴或富铟团簇等[19]。图2(a)中的V型坑大多是由穿透位错形成的,可以清楚地观察到几乎每个V型坑底部都连着一条穿透位错。正是由于大量深浅不一的V型坑存在,在坑与坑之间形成了参差不齐的岛状结构。这也很好地解释了2.1小节中岛的最大深度和RMS的变化规律。随着垒层温度的升高,镓原子表面迁移率增加,更多的镓原子进入到V型坑中形成GaN层,使V型坑的深度变浅,表面粗糙度也随之减小[20]。从图2(a)中还可以明显地可以分辨出InGaN量子阱和GaN垒层。此外,InGaN 量子阱中存在明暗对比度很高的区域,这是由铟聚集和相分离引起的。这些白色和明亮区域是In富集区,可被认为富In量子点,其提供了深的势阱,可以抑制载流子向各种非辐射缺陷扩散[21]。为了更清楚地观察量子点,通过EDS方法分析了In成分分布,如图2(b)所示。红色区域为含In区域,红色区域越亮表示In含量越高。可以将InGaN层的EDS图像中的红点区域视为富In量子点。这里形成QD的方法有两种:一是相分离形成的富In量子点,另一种是这些V型坑破坏了InGaN量子阱的完整性,从而形成了小尺寸、块状的量子团簇,也属于量子点的范畴。基于这两种机制,最终形成了QD/QW复合结构。
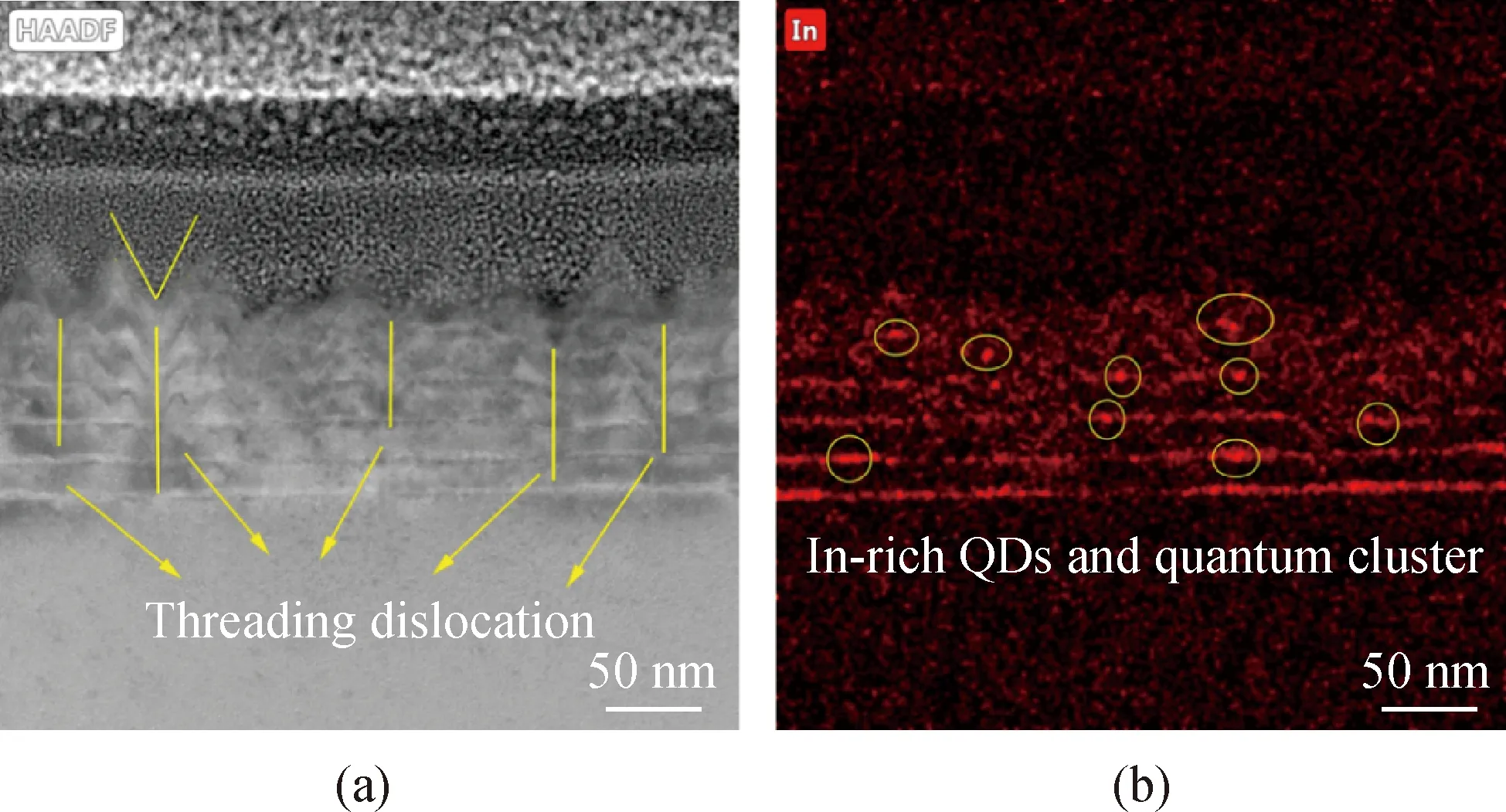
图2 样品S2的HAADF图像(a)和EDS图像(b)Fig.2 HAADF image (a) and EDS image (b) of sample S2
2.3 光致发光分析
为了分析样品的量子限制斯塔克效应、非辐射复合中心密度和局域化效应的变化,分别采用了变功率光致发光谱和变温光致发光谱对样品进行分析。如图3(a)所示,在室温条件下,分别在1.3 W/cm2、4.9 W/cm2、15.4 W/cm2和43.2 W/cm2激发功率下测量了S1、S2和S3样品的激发功率密度与峰值能量的关系。对于垒层温度为850 ℃的S3样品,峰值能量值始终最高;对于垒层温度为830 ℃的S1样品,峰值能量值始终最低;对于垒层温度为840 ℃的S2样品,峰值能量值始终在S1和S3样品之间。该现象可解释为当垒层温度升高时,InGaN量子阱中In原子脱附更多,禁带宽度也随之增加。这三个样品均随着激发功率密度从1.3 W/cm2到43.2 W/cm2的增加而呈现蓝移现象,在以往文献报道中有两种可能的解释:一个是光生载流子对极化场的屏蔽[19,21],使QCSE减弱,而另一种是能带填充效应[18,22-23]。为了证明哪种机制引起的蓝移,绘制了半高宽(full width at half maximum, FWHM)与激发功率密度的关系曲线,如图3(b)所示。随着激发功率密度的升高,三个样品的FWHM单调下降。能带填充效应会使光致发光光谱展宽[23],而QCSE减弱会使FWHM缩窄[23]。根据FWHM的变化,可以确定仅极化场屏蔽效应主导蓝移,没有出现能带填充效应。这是由于量子点的能带是不连续的,态密度很低,在最低的光激发功率下(1.3 W/cm2)就可以将大部分能态填满,因此在样品中均未表现出能带填充效应是合理的。另外,S1,S2和S3的峰值能量蓝移量分别为53.7 meV、70.2 meV、122.2 meV,这表明QCSE随着垒层生长温度的降低而减弱,这是由于垒层生长温度越低,V型坑的深度越深(从上述AFM数据分析即可得知),应力释放越明显,残余应变越低[24]。
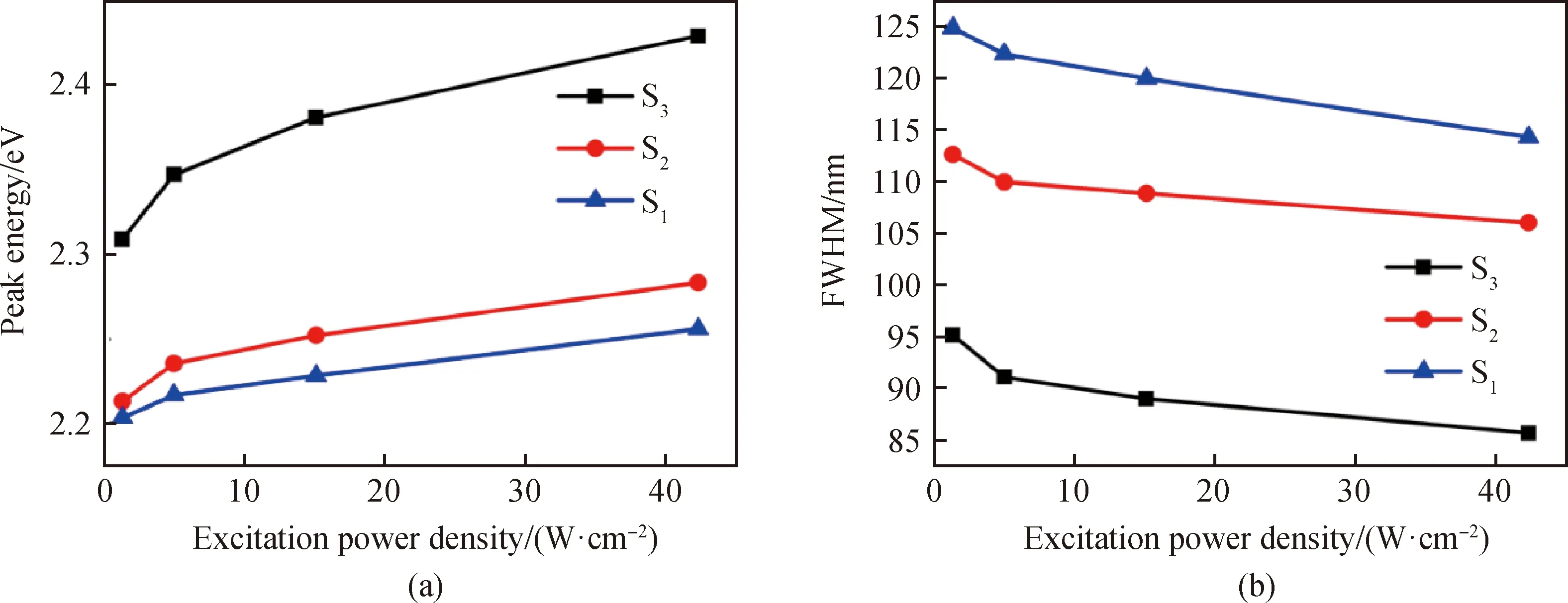
图3 变功率光致发光光谱的峰值能量(a)和半高宽(b)Fig.3 Dependence of the excitation power density dependence on the peak energy (a) and FWHM (b)
使用325 nm的连续波激光在10~300 K范围内进行了变温PL测量(TD-PL),以研究这三个样品中的载流子局域化效应。相应的发射光谱峰值能量如图4所示。

图4 变温光致发光光谱的峰值能量Fig.4 Peak energies of the TD-PL spectra
三个样品的峰值能量在整个温度范围内都呈现出不断的蓝移。在这三个样品中未观察到InGaN/GaN多量子阱中常见的温度引起的带隙收缩效应,这可归因于强的载流子局域化效应。变温PL变化规律与常规观察结果不同。常规的InGaN多量子阱结构发射波长随温度升高呈“S形”曲线(红移-蓝移-红移)[25-26],这归因于潜在的不均匀性和局域化效应。在InGaN层存在不同的局域态,当温度稍微升高时,处于浅局域态的载流子被热激活,载流子通过隧穿进入到较深的局域态中,能量降低,出现红移,这一过程被称为载流子的弛豫;温度继续升高到某一临界值时,载流子的弛豫现象被抑制,引发峰值能量的蓝移;但超过一定温度时,带隙收缩和非辐射复合载流子主导载流子的复合过程,从而又出现红移现象。而S1、S2和S3在整个温度范围内,始终保持蓝移。这可能是InGaN量子点/量子阱复合结构具有更强的载流子局域化效应,在升温过程中载流子始终被限制在深局域态中,随着温度的升高,载流子只是跃迁到深局域态中能级较高的位置而已。下文将通过阿伦尼乌斯拟合对载流子局域化效应做定量分析。
2.4 阿伦尼乌斯拟合分析
图5(a)、(b)、(c)显示了归一化积分PL强度从30~300 K的变化,以便进一步比较这三个样品的载流子局域化效应和缺陷引起的非辐射复合中心密度。随着温度升高,所有积分PL强度均持续降低,这可归因于温度升高时非辐射复合中心的激活。此外,S1、S2和S3的PL强度在40 K以上迅速下降。使用阿伦尼乌斯(Arrhenius)方程(公式(1))可以很好地拟合实验数据[27-29]:

图5 样品S1(a)、S2(b)、S3(c)的阿伦尼乌斯方程拟合曲线Fig.5 Arrhenius equation fitting curves of samples S1 (a), S2 (b) and S3 (c)
(1)
式中:I(T)为温度T下的归一化积分PL强度;C1和C2是与样品中两种非辐射复合中心密度相对应的两个系数[29];E1和E2是与非辐射复合过程有关的激活能[30];KB是玻尔兹曼常数。
拟合结果列于表2。很明显,三个样品中的激活能E1小于E2。据报道,较小的E1值可归因于激子结合能[31]。在低温下,电子和空穴形成激子,而随着温度的升高,激子可能会分离成自由电子-空穴对,然后被非辐射复合中心(例如缺陷)捕获;S1、S2和S3三个样品的C2值分别是30.64、37.09和70.15。S3样品的C2值大约是另外两个样品的2倍。C2与样品的缺陷密度密切相关,C2值越大表示缺陷密度越高。所以,S3的缺陷密度最高,非辐射复合中心最多。说明随着垒层温度的升高,非辐射复合中心密度逐渐增大。在InGaN/GaN多量子阱结构中,E2是载流子从量子阱限制态逃逸到垒层连续态所需的能量[30]。在本工作中,由于形成了量子点/量子阱复合结构,E2可能是从局域态逃逸所需的能量,代表局域化效应的程度。E2的值越大表示载流子局域化效应越强。三个样品的E2值分别是S1: 49.53 meV,S2: 54.89 meV,S3: 60.48 meV。随着垒层温度的升高,E2值增加,且远大于传统的多量子阱结构,说明三个样品的载流子局域化效应均较强。

表2 样品S1、S2和S3的阿伦尼乌斯方程拟合结果Table 2 Arrhenius fitting results of sample S1, S2 and S3
假设非辐射复合中心在10 K时完全冻结,IQE可通过I300 K/I10 K比值来计算[32]。S3的IQE仅为9.9%,但是S2和S1的IQE分别提高到14.5%和14.3%,这是因为在较低的温度下,缺陷减少,从而降低了由缺陷引起的非辐射复合中心密度[33]。S3样品IQE最低的原因是, 相比于S1和S2,具有最强的QCSE和最高的非辐射复合中心密度,从而导致载流子复合概率降低。对比样品S1与S2可以看出,其C2、E2值均比较接近。样品S2的C2值略高,表明其非辐射复合中心密度略高,不利于IQE的提高;但其略大的E2值表明其局域化程度也更强,有利于IQE的提高。两种机理相互制约,使两者的IQE几乎相等。
3 结 论
使用MOCVD生长了三个具有不同垒层温度的InGaN/GaN量子阱结构:S1(830 ℃)、S2(840 ℃)和S3(850 ℃)。通过对AFM照片的分析,发现三个样品的表面都呈现3D岛状形貌。为了进一步分析岛状形貌形成的原因,又分析了S2样品截面的HAADF和EDS图像,发现样品表面存在高密度的V型坑,这些V型坑破坏了量子阱的完整性,将量子阱结构变成了量子点/量子阱复合结构。采用变功率光致发光谱和变温光致发光谱分别对量子限制斯塔克效应、载流子局域化效应以及非辐射复合中心密度进行了分析。量子限制斯塔克效应随着垒层温度的升高而增强,这是因为随着温度的升高,V型坑的深度变浅,应力越难以释放,残余应变变多,压变极化场增强,QCSE随之增强。通过对阿伦尼乌斯拟合数据的分析,缺陷密度也随着温度的升高而增多,形成更多的非辐射复合中心。而内量子效率随着垒层温度的升高呈下降趋势。通过对QCSE、载流子局域化效应以及非辐射复合中心密度的分析,结果表明QCSE和非辐射复合中心密度提高是导致IQE下降的主要因素。

