不同退火条件对PEALD制备的Ga2O3薄膜特性的影响
马海鑫,丁广玉,邢艳辉,韩 军,张 尧,崔博垚,林文魁,尹浩田,黄兴杰
(1.北京工业大学微电子学院,光电技术教育部重点实验室,北京 100124;2.中国科学院苏州纳米技术与纳米仿生研究所,纳米器件与应用重点实验室,苏州 215123)
0 引 言
Ga2O3是一种新型超宽禁带透明半导体材料,具有5种同分异构体(α、β、γ、η 和 ε-Ga2O3)[1-2],其中单斜晶系β-Ga2O3在室温下最稳定[3],属于C2/m点群,其晶格常数为a=1.223 nm,b=0.304 nm,c=0.580 nm,β=103.7°,密度为5.95 g/cm3(单斜晶系,PDF#41-1103)[4-5]。室温下β-Ga2O3带隙约为4.9 eV(对应本征吸收边为253 nm),超过SiC(Eg约3.02 eV)和GaN(Eg约3.4 eV)等现有的宽带隙半导体材料,使得β-Ga2O3在日盲紫外光电器件和高频大功率器件[6]方面的应用更为广泛。并且含有氧空位的多晶β-Ga2O3薄膜被认为是气体传感器的良好材料,其中气体包括H2、CH4、CO、和O2等[7-10]。此外,β-Ga2O3良好的机械性能和物理化学性能,也被应用于太阳能电池[11]、光催化剂[12]和光电化学电池的光电极中[13]。Ga2O3作为氮化镓半导体的外延衬底制作垂直结构光电器件也非常具有吸引力[14-15]。尽管同质外延Ga2O3薄膜获得了高导通电压和低漏电流的金属-半导体场效应晶体管[16],但由于体材料衬底昂贵,目前制备Ga2O3薄膜多采用异质外延生长方法,制备方法主要有:金属有机物化学气相沉积(MOCVD)[17-18]、分子束外延技术(MBE)[19]、脉冲激光沉积技术(PLD)[20]、原子层沉积技术(ALD)[21]和溅射[22]等。在这些沉积技术中,ALD技术自身的原子水平控制允许它不仅对单一材料甚至对复合材料的厚度和成分的精确控制也占有优势,被认为是微米甚至纳米尺度图形厚度精确控制的首选方法[23],并且等离子体的引入扩大了反应温度窗口,目前等离子增强原子层沉积技术(PEALD)被广泛用于沉积电介质和其他外延薄膜。
2018年,Roberts等[24]利用PEALD沉积法在蓝宝石衬底上外延生长Ga2O3薄膜,研究发现外延生长的Ga2O3薄膜易出现混相,退火后可转化为单相结构。2017年,O’donoghue等[25]利用PEALD技术外延生长出高纯度无定形的Ga2O3薄膜,在1 000 ℃温度下退火后可向β-Ga2O3转变。2019年,Jiao等[26]研究了非晶Ga2O3和单斜结构β-Ga2O3晶体结构和光电性质,发现不同退火气氛对薄膜结晶度和光电响应影响不同。此外,Halit等[27]利用PEALD技术在P型Si晶片上外延生长了7.5 nm厚的Ga2O3薄膜,研究发现在N2气氛下退火30 min后的Ga2O3薄膜制作的MOS晶体管获得的反向击穿场强最高。本课题组报道了在O2气氛下不同退火时间对Ga2O3薄膜晶体结构的影响。本文采用PEALD法在c面蓝宝石衬底上成功外延生长了高质量Ga2O3薄膜,并分别研究退火气氛(1 000 ℃的v(N2)∶v(O2)=1∶1、空气和N2)以及退火时间(1 000 ℃的N2气氛下退火15 min、30 min、60 min和120 min)对薄膜性质的影响。
1 实 验
1.1 样品制备
利用PEALD技术在c面Al2O3衬底上外延生长Ga2O3薄膜,三甲基镓(TMGa)和氧气分别作为镓源和氧源,氮气作为载气。在薄膜沉积过程中,衬底温度保持在250 ℃,射频等离子体功率为2 000 W,TMGa、O2和N2流速分别为60 mL/min、200 mL/min和60 mL/min。生长方式采用交替脉冲沉积,一个沉积周期主要由四个过程组成,依次为通入TMGa镓源,时间0.1 s;N2吹扫,时间5 s;通入O2,时间20 s;最后N2吹扫5 s。薄膜沉积的全过程为400个周期,平均生长速率约为0.077 nm/周期。生长完成后,将样品置于LPCVD管式退火炉下退火,退火条件分别采用不同的退火气氛(1 000 ℃的N2∶O2=1∶1、空气和 N2)以及不同的退火时间(1 000 ℃的N2气氛下退火15 min、30 min、60 min和120 min)。
1.2 样品表征
利用X射线光电子能谱(X-ray photoelectron spectroscopy,XPS,PHI VersaProbe)测定了Ga2O3薄膜的化学元素组成和键合状态。使用X射线衍射仪(X-ray difraction,XRD,K’Pert PW3040-60)对Ga2O3薄膜晶体结构和晶体质量进行了表征。薄膜的表面形貌特征由原子力显微镜(atomic force microscope,AFM, Bruker Multimode 8)观察与分析。使用紫外-可见光分光光度计(UV-Vis spectrophotometer,PerkinElmer LAMBDA 750)对样品进行透射光谱的测量。
2 结果与讨论
2.1 X射线光电子能谱分析
镓、氧化合物有多种化学式,如GaO、Ga2O和Ga2O3等,利用X射线光电子能谱对薄膜组分以及成分进行分析。图1显示了沉积后的Ga2O3薄膜的XPS谱图。从图1可以看出,XPS谱主要是由镓(Ga 3d,Ga 3p,Ga 3s,Ga 2p3/2,Ga 2p1/2)、氧(O 1s,O 2s)和碳(C 1s,由于表面污染引入)的相关光电子峰,以及镓(Ga LMM)和氧(OKVL,OKVV)相应的俄歇峰组成,这表明在沉积薄膜的表面和近表面区域主要是Ga和O元素。采用元素灵敏度因子定量分析法对薄膜进行定量成分分析,由Ga和O的能量峰拟合获得薄膜的Ga 3d和O 1s的高分辨率XPS光谱显示于图1(a)插图中。从Ga 3d的XPS光谱可以看出,在结合能为20.5 eV处存在峰值,表明了Ga-O键的存在,在23.5 eV处的峰值与O 2s的核心能级有关。右侧插图为O 1s的高分辨率XPS光谱,O 1s光谱在531 eV处的峰值对应着Ga2O3,在532.9 eV处的峰与C吸附氧的有机羰基化合物(533.2 eV)有关。通过该拟合的Ga和O的光电子能谱,计算薄膜中Ga/O的原子比约为0.65,接近Ga2O3的标准化学计量比[28-29]。由于自旋轨道角动量的相互作用,Ga 2p能级分裂成具有能量分离的二重态,如图1(b)所示。Ga 2p的分裂能量光谱峰值分别为结合能为1 118 eV的 Ga 2p3/2和结合能为1 145 eV的Ga 2p1/2,这表明所制备的氧化镓为Ga2O3[30-31]。

图1 Ga2O3薄膜X射线光电子能谱Fig.1 Ga2O3 thin film X-ray photoelectron spectrum
2.2 X 射线衍射谱分析
为研究比较,将沉积后未退火Ga2O3样品设为样品1,经30 min, 1 000 ℃分别在N2∶O2=1∶1、空气以及N2气氛下退火样品设为样品2、3、4。图2(a)显示了四个样品的XRD的2θ-ω扫描曲线,插图为断线处衬底的衍射峰。由图2(a)所示,未退火的样品1仅在38.4°和44.5°存在微弱的衍射峰,分别对应亚稳态γ-Ga2O3的(311)、(400)。与样品1相比,经N2和O2等体积比气氛退火后的样品2衍射峰的位置没有明显变化,说明此时氧化镓仍处于亚稳态;而随着退火气氛中N2比例的增加(对应样品3和样品4),分别对应于19.2°、38.9°和59.2°的β-Ga2O3的(-201)、(-402)和(-603)衍射峰出现,且在N2气氛下退火的样品4衍射峰强度最强,半高宽最低,尤其是在(-603)面。这说明退火气氛中N2增加促进了晶体的择优取向。因此本文进一步进行了在N2气氛下不同退火时间研究。
将实验样品在N2气氛下分别进行15 min、30 min、60 min和120 min的退火处理, XRD测试结果由下到上依次显示于图2(b)中,插图为断线处蓝宝石衬底(0006)面衍射峰。从图中可以看出,未退火的样品仅在38.4°和44.5°有衍射峰,退火15 min后的氧化镓还在19.2°、38.9°和59.2°处出现衍射峰位,增加退火时间到30 min后,仅观察到β-Ga2O3(-201)、(-402)和(-603)分别位于19.2°、38.9°和59.2°的衍射峰,这表明此时薄膜已经转化为单一取向性较好的β-Ga2O3。继续增加退火时间发现,经60 min或120 min,β-Ga2O3相应的衍射峰强度略有减弱,这说明在1 000 ℃,N2气氛、30 min退火条件可以获得较好质量的β-Ga2O3。与之前的研究报道相比,Ga2O3在1 000 ℃的O2气氛下退火时至少需要60 min或者120 min才能起到较好的退火效果[32],而在N2气氛下退火明显缩短了退火时间。退火时间的减少可能与GaN薄膜生长类似,N2在退火气氛中起到载气的作用[33],有利于原子在薄膜表面迁移,并促使Ga原子和O原子获得足够能量迁移到合适的晶格位置,促使Ga2O3由亚稳态向稳态转变。

图2 沉积样品和退火样品2θ-ω的XRD扫描曲线Fig.2 XRD 2θ-ω scan curves of the as-deposited and annealed samples
2.3 AFM表面形貌分析
图3为沉积后和在N2气氛下不同退火时间下退火后Ga2O3薄膜的AFM三维形貌图及表面晶粒分析结果。从图中可以看出,表面形貌明显依赖于退火时间。未退火的Ga2O3薄膜在表面存在一些较大的晶粒,退火后表面晶粒尺寸发生了明显的变化,这说明热退火处理使得晶体结构发生变化,这和前文XRD的结果是一致的。与未退火的Ga2O3样品相比,退火15 min时样品的晶粒密度明显增加,高度降低,随着退火时间的增加,退火30 min后样品的晶粒密度不再增加,但晶粒的高度持续降低。在退火30 min或60 min后,晶粒密度参数变化表明Ga2O3的表面形貌开始趋于稳定,如图3(f)所示,这说明退火处理到达30 min薄膜中的原子能够获得了足够能量,促使了Ga2O3的择优重结晶。此外,沉积态和退火15 min、30 min、60 min和120 min后的Ga2O3样品,均方根粗糙度分别为0.389 nm,0.384 nm,0.417 nm,0.402 nm和0.357 nm,表面形貌和粗糙度的变化主要是与热退火处理引起表面晶粒再结晶过程有关。

图3 Ga2O3样品AFM表面形貌图Fig.3 AFM surface topography of Ga2O3 samples
2.4 透射光谱结果分析

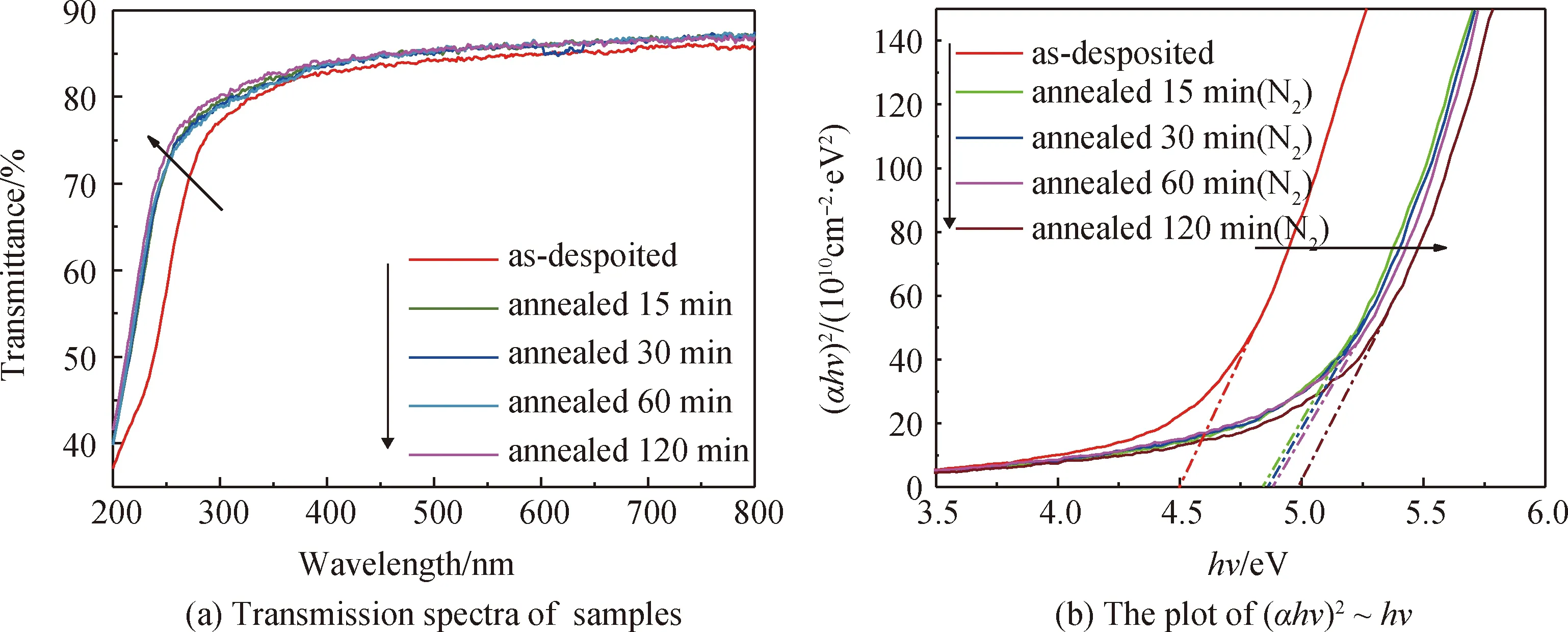
图4 未退火和退火后样品的透射光谱及带隙关系曲线(沿箭头方向退火时间增大)Fig.4 Transmission spectra of unannealed and annealed samples and band-gap relationship curves
3 结 论
本文采用PEALD技术在c面蓝宝石衬底上沉积了Ga2O3薄膜,分别研究了退火气氛以及退火时间对薄膜特性的影响。XPS表征结果表明薄膜中的Ga原子和O原子之比约为0.65,接近Ga2O3的化学计量比。XRD分析结果表明沉积的Ga2O3薄膜为亚稳态,研究发现增加退火气氛中N2比例,有利于β-Ga2O3重结晶。因此进一步在N2气氛下研究退火时间的影响规律,XRD结果表明在N2气氛下仅退火30 min后Ga2O3薄膜即可由亚稳态转变为择优取向的β-Ga2O3。样品的表面形貌特征和表面晶粒变化分析结果表明,退火达到30 min或60 min样品表面晶粒密度变化开始趋于稳定。沉积和退火后的薄膜在可见光范围内的平均透射率几乎100%,光吸收边陡峭,退火30 min样品的光学带隙为4.86 eV。因此,退火条件的改善可以优化Ga2O3薄膜的晶体结构和晶体质量,有效改善薄膜的表面形貌和光学特性,本文为高质量Ga2O3薄膜的制备提供了参考。

