微波氮化镓肖特基二极管及其应用*
李秋璇,李杨,王霄,陈治伟,敖金平
(江南大学物联网工程学院,江苏 无锡 214122)
1 引言
肖特基势垒二极管(SBD)凭借其功耗低、速度快、截止频率高和易集成等优势,广泛应用于微波、毫米波及太赫兹领域,以实现整流、频率变换(如倍频)等功能。常见的SBD主要基于硅(Si)和砷化镓(GaAs)材料。其中,Si作为较早投入使用的第一代半导体材料,技术成熟且成本较低,应用最为广泛。然而,Si材料击穿电场较小,禁带宽度和电子迁移率较低,使得Si基器件的频率和功率难以提高。与Si相比,第二代半导体材料GaAs具有更高的电子迁移率,但其较低的禁带宽度也使其应用受到限制,难以满足微波、毫米波频率器件对功率的要求。以GaN为代表的第三代宽禁带半导体材料,因其更高的禁带宽度、击穿电场和迁移率,被认为是制造微波、毫米波甚至太赫兹频率器件的最佳材料。
基于GaN的SBD可以同时实现高击穿电压、高开关频率、大电流和低导通电阻,进而大幅降低微波、毫米波频率下的器件损耗,是实现微波、毫米波系统低功耗、高功率、高可靠性的关键[1]。工作在微波、毫米波频率的GaN SBD主要采用2种结构,基于二维电子气(2DEG)的横向AlGaN/GaN异质结结构和基于GaN体材料的准垂直/垂直结构。前者利用2DEG的高导电性、高电子浓度和高迁移率,实现高开关速度、小结电容、高截止频率和低导通电阻。然而,横向GaN SBD的动态电阻难以控制,可靠性较差。后者基于同质或异质外延衬底,理论上拥有更好的外延质量,使SBD具有更强的电流处理能力、更高的击穿电压和更高的芯片面积利用率[2],但是存在反向漏电较高等问题。
本文主要探讨了近年来提升微波GaN SBD性能的关键技术和实现方法,并结合整流器和倍频器等应用电路,对GaN SBD未来的发展进行了展望。
2 GaN SBD的设计与制造
不同于工作频率较低的功率GaN SBD,较高的工作频率往往需要器件同时满足低开启电压VON、高击穿电压VBR和低导通电阻RON等指标。为此,国内外学者提出了多种方法以改善器件相关指标,进而提升器件的综合性能。
2.1 开启电压
导通状态下,由于GaN材料的宽禁带特性,GaN SBD会表现出不符合预期的高开启电压,较高的VON会导致过大的导通损耗,影响电路的工作效率。为改善这一问题,当前主要在GaN SBD中引入结构性设计,如凹槽阳极、混合阳极等,搭配功函数合适的金属,在不过多牺牲击穿电压的情况下降低VON。
2.1.1 凹槽阳极
通过刻蚀阳极下方的AlGaN势垒层形成凹槽结构,实现阳极金属侧壁与2DEG的直接接触[3],在此基础上,选择低功函数金属(如W、Mo等)作为阳极金属,可以显著降低GaN SBD的VON。
台湾清华大学TSOU等[4]在Si衬底上采用干法刻蚀技术制备了带有凹槽阳极结构的AlGaN/GaN SBD,其结构如图1(a)所示。当凹槽深度为50 nm时,VON低至0.73 V。相比干法刻蚀,湿法刻蚀能够减少GaN表面的刻蚀损伤,台湾万能科技大学HSUEH等[5]采用微波等离子体氧化和湿法刻蚀技术制备的凹槽阳极AlGaN/GaN SBD如图1(b)所示,其将VON降低至0.40 V,改善了器件的开启特性。
在凹槽阳极的基础上,采用低功函数金属作为金属阳极,进一步改善开启电压。西安电子科技大学ZHANG等[6]提出了一种以W为阳极金属、采用凹槽阳极结构制备的横向GaN SBD,其结构如图1(c)所示,LAC为阴极-阳极的距离。W的功函数约为4.6 eV,比常用阳极金属镍(Ni)约低0.5 eV。组合凹槽阳极与W阳极,实现了低至0.35 V的高均匀VON。
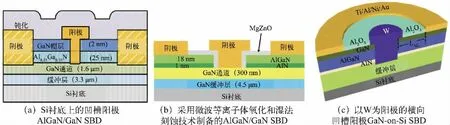
图1 具有凹槽阳极结构的GaN SBD
尽管采用凹槽阳极结构可以有效降低GaN SBD的VON,但是控制凹槽的刻蚀深度仍是技术难点[3]。研究表明,凹槽深度的增加会导致漏电流的增大和击穿电压的降低[7],因此,精确控制凹槽的刻蚀深度尤为重要,否则可能严重影响器件的性能。
2.1.2 混合阳极
混合阳极由肖特基接触与欧姆接触或低功函数金属与高功函数金属组合而成,该组合结构可以有效降低二极管的等效势垒厚度,从而优化开启电压。
韩国弘益大学LEE等[8]组合凹槽肖特基栅与混合阳极制备了一种新型AlGaN/GaN SBD,其结构如图2(a)所示,该阳极由欧姆接触与肖特基接触组合而成。正偏时,得益于欧姆接触,其VON非常小,在LAC为18μm时,VON低至0.37 V。反偏时,利用肖特基接触和凹槽刻蚀技术将阳极部分的AlGaN势垒层厚度降低至4.89 nm,导致2DEG通道夹断,从而在降低VON的同时保持了较高的VBR,凹槽区域图像如图2(b)所示。
对于低功函数金属与高功函数金属组合而成的混合阳极结构,其势垒高度通常大于肖特基接触与欧姆接触组合而成的混合阳极。台湾清华大学CHANG等[9]采用低功函数金属Ti和高功函数金属Ni组合成混合阳极结构,在Si衬底上制备了AlGaN/GaN SBD。与单金属阳极Ni SBD和Ti SBD相比,该双金属混合阳极SBD具有更优异的性能,不仅实现了低至0.57 V的VON,而且降低了反向漏电流,有效平衡了该器件的正反向特性。相比Ti和Ni,氮化钛(TiN)和氮化镍(NiN)具有更好的热稳定性,适合作为GaN SBD的阳极材料。西安电子科技大学WANG等[10]组合低功函数的TiN和高功函数的NiN,提出了一种具有凹槽双金属氮化物阳极的AlGaN/GaN SBD,其结构如图2(c)所示。凹槽TiN阳极与2DEG直接接触,降低了肖特基势垒厚度,实现了低至0.30 V的VON。

图2 具有混合阳极结构的GaN SBD
2.1.3 低功函数阳极
采用低功函数金属或低功函数金属氮化物作为阳极材料,能够降低肖特基势垒高度,有效改善VON。西安电子科技大学LI等[11]以低功函数TiN为阳极,制备了一种多指型准垂直GaN SBD。沉积TiN/Ni/Au(30 nm/70 nm/30 nm)层作为阳极,降低SBD的肖特基势垒高度至0.54 eV,实现了0.51 V的低内建电势。此外,比利时微电子研究中心(IMEC)LENCI等[12]沉积了无Au的TiN/Ti/Al/Ti/TiN(20 nm/20 nm/250 nm/20 nm/60 nm)层作为AlGaN/GaN SBD的阳极,实现了0.41 V的低VON。
2.2 击穿电压
GaN SBD的结边电场拥挤和肖特基势垒高度较低会导致器件的过早击穿。目前,单独讨论射频GaN SBD击穿特性的研究较少,相关研究人员主要针对功率GaN SBD提出了一系列改善器件击穿特性的方案,例如使用边缘终端技术和p-GaN/p-AlGaN层等,这些方案对于提高射频器件的击穿电压也有相当的参考价值。
2.2.1 终端技术
场板(FP)技术是终端技术的一种,可以调节边缘电场分布,防止电场集中在电极边缘引起的过早击穿问题,显著提高了器件的耐压能力。日本住友电气工业株式会社SAITOH等[13]在低位错密度的独立GaN衬底上制备了垂直GaN SBD,带SiNx层场板结构的垂直GaN SBD如图3(a)所示。通过优化n-GaN漂移层的生长条件以及制作SiNx层场板结构,VBR超过1100 V。
为了进一步提高击穿电压,圣母大学ZHU等[14]分别以SiNx和SiO2为第一、二场板的介质,提出了一种具有双场板结构和凹槽阳极的AlGaN/GaN SBD,其结构如图3(b)所示。双场板结构能够显著减小峰值电场,实现比单场板结构SBD更大的VBR。当LAC为25μm时,VBR大于1.9 kV。
随着对器件结构的不断改进,2017年,MA和MATIOLI在三阳极AlGaN/GaN SBD上集成了三栅晶体管[15],其结构如图3(c)所示。三栅极结构改善了器件的反向阻断能力,在反向偏置为500 V和700 V时分别实现低于10 nA/mm和100 nA/mm的反向漏电流IR,并在IR=1μA/mm时得到高达1325 V的VBR。

图3 具有场板结构的GaN SBD
降低场板结构中的介质等效厚度到一定程度,即得到栅控边缘终端结构。该结构不仅能够改善器件的击穿特性,而且能有效抑制漏电流,显著提高器件的反向阻断能力。IMEC的HU等[16]研究了外边缘终端肖特基二极管(EET-SBD)和栅控边缘终端肖特基二极管(GET-SBD)以及有、无凹槽阳极对器件的影响,边缘终端AlGaN/GaN/GaN-on-Si SBD如图4所示。结果表明,凹槽GET-SBD具有超过600 V的VBR和最低的IR,在反向偏置电压为600 V时,IR为1μA/mm。2016年,该团队以TiN作为阳极金属,采用原子层刻蚀(ALE)工艺对该器件的凹槽阳极进行研究[17]。研究表明,GET区域能够实现更好的静电控制以夹断沟道,强烈抑制反向漏电流,经6次ALE循环后,GET-SBD的中位漏电流低至1 nA/mm。

图4 边缘终端AlGaN/GaN-on-Si SBD
除了以上2种结构,离子注入终端技术在提高击穿电压方面也发挥着重要作用。浙江大学HAN等[18]采用平面氮化终端(NT)技术制备了垂直GaN-on-GaN SBD。NT技术可以改善GaN的表面状态,击穿电压从335 V提高至995 V,反向漏电流减少至原来的1/104。
但需要注意的是,终端结构的加入会导致二极管的寄生电容增加,从而影响其微波、毫米波特性。设计人员需要根据不同的使用环境对终端结构的形貌和材料进行调整,以同时兼顾器件的频率和击穿特性。2.2.2 p-GaN/p-AlGaN层
在AlGaN/GaN异质结构上生长p-GaN或p-AlGaN层,调整沿2DEG通道从阳极到阴极的电场分布,使得电场分布均匀,峰值电场得到抑制,进而显著提高击穿电压。
台湾万能科技大学HSUEH等[19]结合双阳极金属和p-GaN层制备了一种高性能的AlGaN/GaN SBD,其结构如图5(a)所示,与标准器件相比,该SBD具有更低的VON和更高的VBR。当p-GaN层的长度LG=3μm时,VON为0.1 V,VBR为606 V。当LG分别为5μm和8μm时,VBR分别为679 V和713 V。由此可见,LG的增加可以有效改善击穿电压。
西安电子科技大学WANG等[20]提出了一种提高横向GaN SBD性能的新设计思路。该团队基于p-GaN/AlGaN/GaN异质结设计了一种阵列p-GaN岛终端横向肖特基二极管(API-SBD)。与常规的凹槽阳极肖特基二极管相比,API-SBD的反向漏电流更低,在100 V的反向偏置下,IR为10 nA/mm。p-GaN层的引入提高了API-SBD的击穿电压,当IR=1μA/mm时,VBR为1070 V。西安电子科技大学ZHENG等[21]提出了一种具有部分p-AlGaN帽层(PPCL)和凹槽双金属阳极(RDA)的AlGaN/GaN SBD(PC-RDA-SBD),其结构如图5(b)所示。PPCL的空穴浓度为5×1017cm-3时,该p帽层引起2DEG通道中载流子的损耗,大大降低了反向漏电流。在此基础上,由于电场分布均匀,反向偏置在器件中水平分配,VBR显著提高,最高达2461 V。

图5 具有p-GaN或p-AlGaN层的GaN SBD
2.3 导通电阻
降低导通电阻可以提高GaN SBD的截止频率,对提高整流器的射频/直流转换效率尤为重要。当前主要采用优化阳极结构和优化欧姆接触等方案,实现较小的导通电阻。
2.3.1 优化阳极结构
在设计阳极结构时,需要考虑边缘效应,即电流密度在阳极边缘处最大,在中心处相对较低,因此,优化阳极形状可以改善GaN SBD的导通电阻。AN等[22]在阳极面积恒定的前提下,对比矩形阳极和圆形阳极,发现矩形阳极GaN SBD具有更小的导通电阻和更高的截止频率。当阳极面积为40 m2时,该SBD的RON为42.5Ω。日本德岛大学FUKUI等[23]制备了一种具有T型阳极结构的GaN SBD,其结构如图6(a)所示。采用T型阳极结构和改进外延层设计,降低了导通电阻RON和关断电容COFF,使得时间常数(RON×COFF)从2.72 ps降至0.79 ps。但是,该SBD的反向阻断特性恶化,VBR从108 V降至50 V。
EBLABLA等[24]在低电阻率Si衬底上设计了一种多沟道射频横向AlGaN/GaN SBD,该结构如图6(b)(c)所示,组合多台面和T型结构作为阳极,使得肖特基阳极与多台面侧壁处的2DEG直接接触,降低了肖特基势垒高度和阳极电阻率,与传统的SBD相比,显著改善了开启特性和截止频率,VON从1.34 V降至0.84 V,RON从1.52Ω·mm降至0.97Ω·mm,截止频率高达0.6 THz。
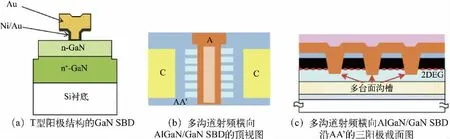
图6 阳极结构得到优化的GaN SBD
此外,增加阳极面积可以有效降低RON,减小通态损耗,但会相应地增加耗尽电容,导致更高的关态损耗。因此,需要找到一个使得总损耗最小的最佳阳极面积。为此,OHNO等[25]在T型阳极的基础上设计了一种直径为4 m的点状阳极结构,阳极通过空气桥连接到焊盘上,避免寄生电容的影响,该单点状阳极GaNSBD的RON为30Ω,耗尽电容为0.03 pF。
2.3.2 优化欧姆接触
优化欧姆接触有利于获得较低的导通电阻。2017年,AN等[26]以Ti/Al/Ni/Au(20 nm/130 nm/50 nm/150 nm)作为GaN SBD欧姆接触的金属叠层,实现了0.15Ω·mm的欧姆接触电阻,与采用Ti/Al/Ti/Au(20 nm/60 nm/50 nm/70 nm)的金属叠层相比,欧姆接触电阻降低了约40%。同时,采用HCI+HF溶液代替BOE溶液对n+-GaN表面进行化学处理,可以实现更好的欧姆接触。优化欧姆接触的GaN SBD如图7所示,当阳极直径为7μm时,导通电阻为70.5Ω,截止频率为627 GHz。同年,SHEIKHI等[27]在N极性GaN上制作欧姆接触,在Ga极性GaN上制作肖特基接触,设计了一种横向极性结构GaN SBD。由于N极性区具有高载流子浓度和高导电性,实现了低电阻的欧姆接触,获得了低至77 mΩ·cm2的导通电阻,然而,该结构的反向漏电流相对较高。

图7 优化欧姆接触的GaN SBD
3 GaN SBD在微波、毫米波领域的应用
GaN SBD广泛应用于微波、毫米波领域,可以实现整流和倍频等功能。研究人员利用GaN SBD的优异特性,采用以上优化开启电压、击穿电压和导通电阻的设计方案,实现了多种具有较高转换效率的微波整流器和毫米波倍频器。
3.1 基于GaN SBD的微波整流器
无线电力传输(WPT)系统分为3个部分:直流/射频转换、微波传输和射频/直流转换。其中,射频/直流转换由整流电路完成,整流电路中的肖特基二极管是决定WPT系统效率的关键因素。UENO等[28]对GaN SBD整流器和SiC SBD整流器进行了对比研究,在高质量低位错密度的独立GaN衬底上制备了垂直GaN SBD,其结构如图8(a)所示,该SBD具有优越的反向恢复特性,在30 MHz的整流操作中,损耗值为3.8%,比SiC SBD 5.5%~9.0%的损耗值降低了30%。
2010年,德岛大学AO等[29]在半绝缘SiC衬底上制备了一种用于微波整流的GaN SBD,其结构如图8(b)所示,使用的SiC衬底使得该SBD具有良好的导热性和较小的寄生电容,在零偏压下,VBR为90 V,RON为8.2Ω,耗尽电容为0.36 pF;采用10指二极管的整流电路,在输入功率为5 W、频率为2.45 GHz时,射频/直流转换效率达74.4%。
此外,LI等[30]研究发现,在氩气和氮气的混合气体环境中,通过某些金属的反应溅射可以在GaN上获得良好的整流特性。依据此原理,该团队在2014年制备了一种以反应溅射TiN为肖特基电极的微波整流GaN SBD,其结构如图8(c)所示,在保持较为理想的导通电阻、反向漏电流和击穿电压的前提下,使得开启电压从1.0 V降至0.5 V,相应地,基于该SBD的2.45 GHz整流电路的整流效率从84%提高至89%。
2019年,KISHIKAWA等[31]结合GaN SBD和Si匹配电路的优点,提出了一种应用于全无线传感器网络系统、基于混合半导体集成电路(HySIC)的整流器,其结构如图8(d)所示,其在频率为5.8 GHz、负载为150Ω时,射频/直流转换效率为10.3%。该团队利用此HySIC整流器在距离为0.2 m、频率为5.8 GHz的条件下进行了微波无线电力传输实验,然而,受到发射天线、接收天线、电缆和空间等因素的影响,系统转换效率仅为0.014%。
2020年,JOSEPH等[32]提出了一种用于大功率无线电力传输的基于横向GaN SBD的微波整流器,其结构如图8(e)所示。采用板上芯片技术和低损耗阻抗匹配的方法,该整流器可承受高达39 dBm的输入功率,在此高输入功率下,最高效率达到61.2%,结果如图8(f)所示。
西安电子科技大学DANG等[33]设计了一种LPCVD SiN钝化的横向GaN SBD,该SBD以低功函数金属为阳极,同时增强阳极表面的钝化,实现了0.38 V的低开启电压,4.5Ω的低导通电阻,164 V的高击穿电压和0.32 pF的低结电容。将该高性能GaN SBD集成到设计良好的5.8 GHz整流电路中,其结构及转换效率如图8(g)(h)所示,在单二极管输入功率为2.5 W和6.4 W时,射频/直流的转换效率分别为71%±4.5%和50%±4.5%,实现了高效率与高功率的结合。
西安电子科技大学LI等[11]设计了一种基于GaN SBD的2.45 GHz微波整流器,该GaN SBD采用场板结构和多指式阳极布局,显著降低了串联电阻和开启电压,实现了准恒定的结电容。基于此SBD的整流器如图8(i)所示,其最大功率为1.91 W,效率为78.5%。在不使用任何带宽扩展电路的情况下,该整流器的高效率输入功率范围(效率不小于70%和不小于75%)扩展到14 dB和10.8 dB,有望加快GaN SBD在微波整流领域的市场化进程。该团队在2021年专门设计了一种低成本的商用级准垂直GaN SBD,在928 MHz下实现高效微波整流[34],最大整流效率高于85%,功率容量超过31 dBm。
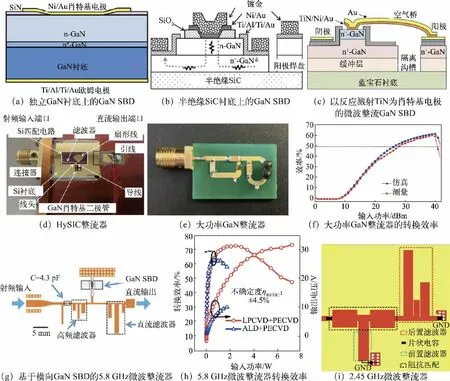
图8 基于GaN SBD的微波整流器
3.2 基于GaNSBD的毫米波倍频器
倍频器能够完成输入信号频率的倍增,提高调频调制的灵敏度和电路工作的稳定性,产生更稳定、相位噪声更低和频段更宽的信号。肖特基势垒二极管是构成毫米波和太赫兹域倍频器的关键器件。目前的倍频器多采用GaAs SBD,但是其损耗大、功率处理能力低、最大输入功率低,难以满足大功率电子器件实际应用的要求。GaN具有更宽的带隙和更高的击穿电压,在毫米波和太赫兹域应用中表现出优异的大功率特性。GaN SBD的功率处理能力远高于GaAs SBD,但是,GaN材料的载流子迁移率较低且大功率工作时散热较差,导致GaN SBD倍频器的转换效率较低,限制了GaN SBD倍频器更进一步的发展。研究表明,采用降低二极管的串联电阻、提高腔体加工精度和减少装配误差等方法,可以提高倍频器的转换效率[35]。
2019年,电子科技大学ZHANG等[35]基于一对反向并联GaN SBD链设计了太赫兹三倍频器。该SBD采用空气桥结构,有效降低了寄生电容,在零偏置、频率为220 GHz时,GaN SBD的总电容为8.3 fF,串联电阻为27Ω。通过控制GaN SBD链在金属膜片上的位置,可以实现该三倍频器的最高输出功率。实验表明,该器件可以在瓦特级输入功率下工作,最大输入功率达1.1 W。在输入功率为900 mW、频率为219.5 GHz时,其输出功率为17.5 mW,最佳效率为1.93%,基于平面GaN SBD的太赫兹三倍频器如图9所示,该器件在太赫兹频率转换领域具有广阔的应用前景。

图9 基于平面GaN SBD的太赫兹三倍频器
2020年,河北半导体研究所LIANG等[36]设计了一种基于GaN SBD的平衡结构倍频器。为获得尽可能高的器件截止频率,在该SBD的制作过程中省略了钝化处理,避免产生额外的寄生电容,实现了0.63 V的开启电压、15.4 V的击穿电压和零偏置下459 GHz的截止频率。基于此SBD的倍频器在177~183 GHz时的输出功率高于同类GaAs电路。当输入功率为2 W时,输出功率为200~244 mW,输出效率为9.5%~11.8%。卡迪夫大学ALATHBAH等[37]以多通道横向AlGaN/GaN SBD为电路中的非线性元件,设计了一种用于5G收发器的单端倍频器,能够产生输入信号基频倍数的谐波。该倍频器在整个频段(5~25 GHz)的转换损耗约为15 dB,转换效率保持在15%以上,在最优输入功率20 dBm下,转换效率约为21%。然而,多通道结构导致该倍频器具有较高的结电容和串联电阻,限制了其转换效率的进一步提升。
为了更进一步提高GaN基倍频器的最大输出功率和效率,SONG等[38]采取了以下措施:提高GaN SBD的击穿电压;增加阳极数量,优化阳极尺寸,提高功率处理能力;改进二极管仿真模型,提升仿真和测试的一致性。在此基础上,采用平衡结构设计和倒装结构组装,提出了一种基于GaN SBD的高脉冲输出功率倍频器,如图10所示,当输入功率为7 W、频率为216 GHz时,峰值输出功率为1006 mW,效率为15%。当输入功率为2 W、频率为215 GHz时,输出功率为382 mW,峰值效率提高到20%。

图10 基于GaN SBD的高脉冲输出功率倍频器
中国工程物理研究院AN等[39]设计制作了一种具有高功率处理能力的高效率D波段(110~170 GHz)单片集成GaN SBD倍频器,其结构如图11(a)所示。采用8阳极GaN单片集成电路技术,显著提高了倍频器的转换效率,解决了混合集成电路寄生元件的问题。该倍频器的最大连续波输入功率为0.5 W,在109~121 GHz频段内,其表现出了超过4.7%的宽带高效特性;在115.6 GHz连续波驱动下,该GaN SBD倍频器峰值转换效率高达17%,实现了连续波驱动下的较高转换效率,如图11(b)(c)所示,该设计在高效大功率太赫兹倍频应用中具有实际优势。

图11 具有高功率处理能力的高效率D波段(110~170 GHz)单片集成GaN SBD倍频器
4 结束语
GaN SBD是实现微波、毫米波系统低功耗、高功率和高可靠性的关键。国内外学者针对GaN SBD的开启电压、击穿电压和导通电阻等指标提出了多种优化方案,实现了多种具有较好正反向特性的GaN SBD,将其应用于整流器和倍频器等电路,能够获得较高的转换效率,显著提升系统的综合性能。然而,当前仍存在一些有待突破的问题:一是制造GaN SBD的相关工艺有待改进,例如,提高刻蚀凹槽的工艺精度、改善肖特基金属材料的制作工艺等;二是当前技术较难获得无缺陷的GaN晶体,导致垂直GaN SBD无法实现理想的高频性能,限制了倍频器电路的发展;三是受到天线、电缆和空间等因素的限制,基于GaN SBD微波整流器的WPT系统的转换效率难以提升。未来,业界有望通过创新性结构设计、优化溅射条件等方法改善上述问题,实现GaN SBD在相关领域的进一步应用。

